高K介質 (High-k Dielectric)和替代金屬柵 (RMG)工藝
2007年,Intel 公司宣布在 45nm CMOS 工藝節點上成功地使用高k氧化鉿基(Hf-oxide Based)介質和金屬柵工藝,可以顯著減少柵介質泄漏電流和增加柵導電能力。
但高k氧化鉿基柵介質較易被源漏退火步驟的熱過程引起結晶化,導致較大的泄漏電流,因此高k介質金屬柵模塊工藝需要在源漏之后再形成,這被稱為后柵(Gate Last)工藝或替代金屬柵 ( Replacement Metal Gate, RMG)工藝,如圖所示。
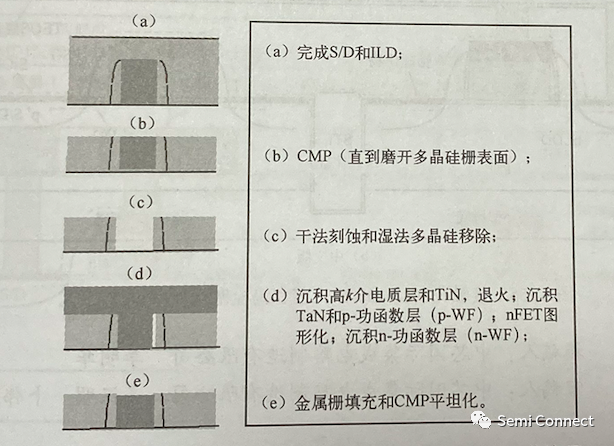
因此,高k介質(如 HfO2、HfSiOx、HfSiON)和金屬柵(如TiN、TiAl、Al 或W等)模塊便成為 32nm/28nmn 和更先進節點上的標準配備;后柵工藝或替代金屬柵工藝也成為產業界先進 CMOS 工藝節點(28nm 節點之后)采用的主流工藝方案。
審核編輯:劉清
-
CMOS
+關注
關注
58文章
5996瀏覽量
238219 -
AMOL
+關注
關注
0文章
2瀏覽量
8672 -
RMGI
+關注
關注
0文章
2瀏覽量
5438
原文標題:中段集成工藝(MOL Integration Flow)- 2
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
高k金屬柵(HKMG)工藝詳解

什么是本體偏壓/次臨界漏電 (ISUBTH)/High-k
高介電常數柵電介質/金屬柵極的FA CMP技術

IMEC發布后柵極HKMG制式細節,英特爾、三星受益

現代集成電路芯片14nm節點FinFET的制造工藝流程詳細資料說明

一文讀懂HfTiO高柵介質GeMOS電容
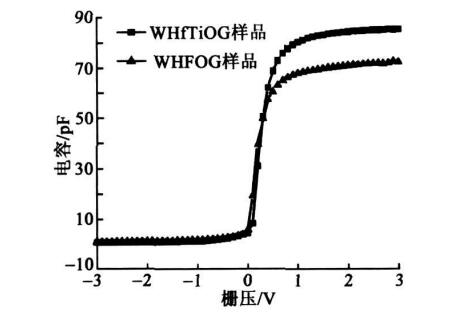
集成電路制造工藝的演進
高K金屬柵工藝(HKMG)
高k柵介質NMOSFET遠程聲子散射對溝道遷移率的影響

High-k柵極堆疊技術的介紹
集成電路新突破:HKMG工藝引領性能革命






 高K介質(High-k Dielectric)和替代金屬柵(RMG)工藝介紹
高K介質(High-k Dielectric)和替代金屬柵(RMG)工藝介紹

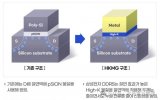












評論