智能門(mén)鎖指紋模組焊點(diǎn)補(bǔ)強(qiáng)加固用底部填充膠由漢思新材料提供。
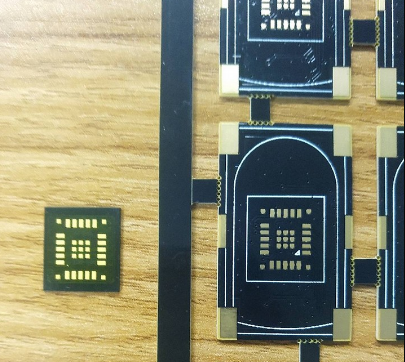

客戶(hù)產(chǎn)品:智能門(mén)鎖指紋模組,新產(chǎn)品工藝研發(fā)價(jià)段。
產(chǎn)品用膠點(diǎn):
1, QFN芯片底部填充(無(wú)錫球,印刷錫膏導(dǎo)通),芯片規(guī)格11*13mm,共33個(gè)焊盤(pán),焊盤(pán)最小間距0.4mm,
2, PCB板四邊中間條狀點(diǎn)膠(四角銅箔片中間),結(jié)構(gòu)粘接,用到黑色熱固膠水,粘接上蓋板為不銹鋼。
客戶(hù)產(chǎn)品要求:
接受熱固150攝氏度
熱風(fēng)槍返修移除芯片后看填充效果完整與否。
客戶(hù)已有設(shè)備:
氣動(dòng)閥點(diǎn)膠,有烤箱,有低溫冷凍條件。
漢思新材料推薦用膠:
通過(guò)我司技術(shù)人員到客戶(hù)現(xiàn)場(chǎng)拜訪(fǎng),詳細(xì)溝通確認(rèn),智能門(mén)鎖指紋模組焊點(diǎn)補(bǔ)強(qiáng)加固用底部填充膠,最終推薦漢思底部填充膠HS700系列。
-
焊點(diǎn)
+關(guān)注
關(guān)注
0文章
137瀏覽量
13040 -
智能門(mén)鎖
+關(guān)注
關(guān)注
17文章
1887瀏覽量
44140
發(fā)布評(píng)論請(qǐng)先 登錄
蘋(píng)果手機(jī)應(yīng)用到底部填充膠的關(guān)鍵部位有哪些?

漢思新材料HS711板卡級(jí)芯片底部填充封裝膠

芯片底部填充膠填充不飽滿(mǎn)或滲透困難原因分析及解決方案

漢思新材料:車(chē)規(guī)級(jí)芯片底部填充膠守護(hù)你的智能汽車(chē)

先進(jìn)封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

人工智能機(jī)器人關(guān)節(jié)控制板BGA芯片底部填充用膠方案

電路板元件保護(hù)用膠

項(xiàng)目分享 | 小熊派DIY一款指紋門(mén)鎖
芯片封裝膠underfill底部填充膠點(diǎn)膠工藝基本操作流程

底部填充工藝在倒裝芯片上的應(yīng)用

詳解點(diǎn)膠工藝用途和具體要求?
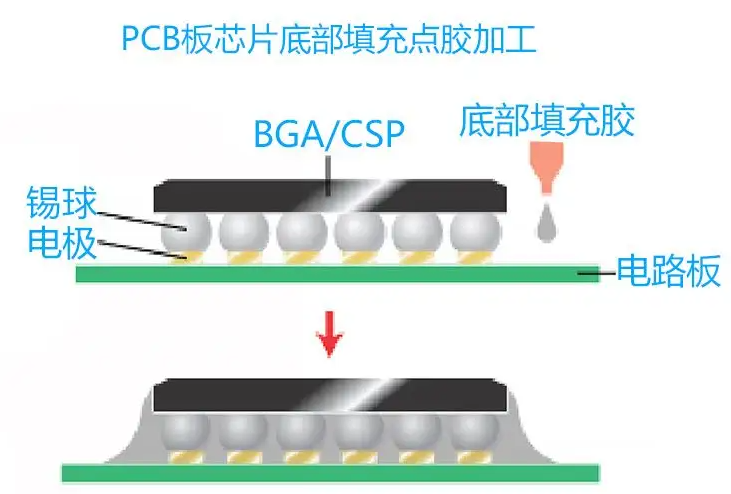





 智能門(mén)鎖指紋模組焊點(diǎn)補(bǔ)強(qiáng)加固用底部填充膠
智能門(mén)鎖指紋模組焊點(diǎn)補(bǔ)強(qiáng)加固用底部填充膠















評(píng)論