本文深入解析兩類應力的形成機制,揭秘從工藝優化(如LPCVD參數調控)到材料設計的全鏈條應對策略,并探討如何將熱應力“化敵為友”,為高可靠性MEMS器件的研發提供關鍵理論支撐。
殘余應力一直是MEMS技術發展中的一個重要問題,MEMS 器件中的殘余應力會對器件的性能以及可靠性產生重要影響。根據其產生的原因,一般可將殘余應力分為本征應力和熱失配應力兩大類。本征應力的成因比較復雜,主要是由于晶格失配引起的,而熱失配應力是由于不同材料的熱膨脹系數差異引起的。

圖 應力失配懸臂梁SEM
什么是本征應力?
本征應力又稱內應力,是指在室溫和零外加負載的情況下,材料自身內部存在的應力,分為壓應力和張應力。在MEMS薄膜材料中,表現尤為突出,當內應力在薄膜材料厚度方向分布不均勻時,會產生應力梯度。當應力梯度不足以抵抗薄膜自身的彈性模量時,薄膜會產生變形,從而帶動襯底產生翹曲或薄膜與襯底分離而破裂。除了單層膜存在應力梯度,復合膜的組合應力更加值得關注。在MEMS器件中,有大量的懸膜和懸臂梁為復合膜結構,此類復合膜結構設計的關鍵點為對膜層的應力匹配和補償。
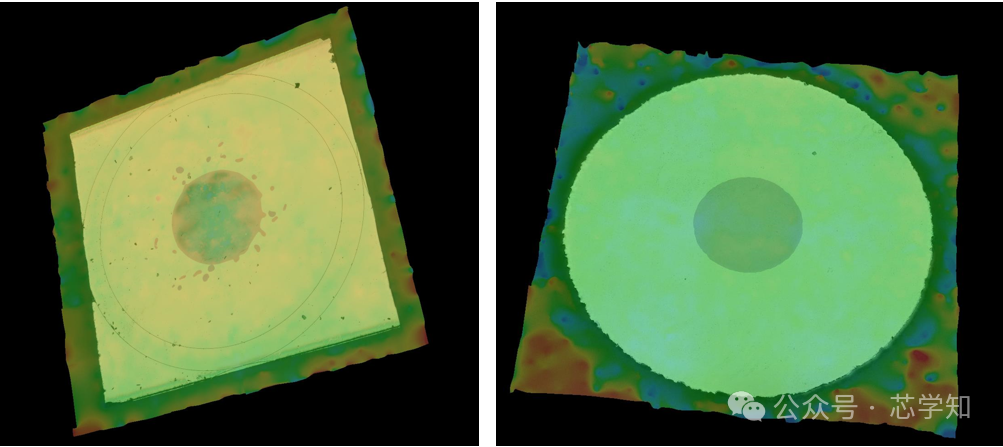
圖 本征應力引起的膜層變形:非應力匹配膜層和應力匹配膜層
本征應力的產生主要是源于沉積薄膜的過程中,成膜的方法、溫度、壓強和速率等因素引起內部晶格失配,例如金屬金(Au)薄膜采用蒸鍍成膜比磁控濺射成膜具有更低的本征應力。在MEMS常用的材料中,幾乎不存在本征應力為零的材料。因此,在材料制備工藝中,更多的關注點在如何制備出更低應力的薄膜。采用低壓化學氣象沉積(LPCVD)制備的氮化硅薄膜,通過控制溫度、壓強、反應氣體比例和反應時間等,制備低應力SiNx薄膜需要保證富硅,即高DCS/NH3比。值得注意的是,LPCVD爐管入氣口和出氣口與爐管中心溫度存在差異,導致同一爐SiNx薄膜應力出現大的波動,應提高中心溫度降低片間應力差異。
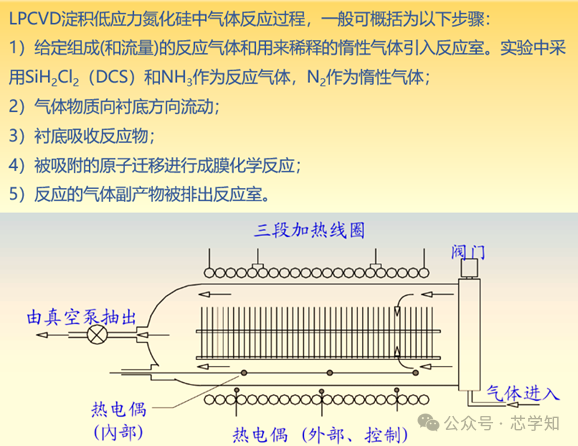
圖 低應力氮化硅制備工藝
什么是熱應力?
熱應力又稱熱失配,是指不同材料由于熱膨脹系數的差異引起的界面應力。產生熱應力,必須滿足2個條件,第一是有熱膨脹系數差異的兩種材料,第二是有溫度變化。熱應力在MEMS器件和使用過程中不可避免,若在MEMS器件制備和使用過程中,溫度變化引起的熱應力導致器件或者膜層的非彈性變形(塑性變形),則會造成器件制備的失敗和使用的可靠性問題。因此,我們在MEMS制備工藝過程中,熱預算是隨著工藝的進程逐步降低的,高溫工藝一般只出現在最前道。
相較于本征應力,熱應力在某些方面是可以化敵為友的。在MEMS熱敏感執行器中,基于膜層之間的熱膨脹系數差來實現懸臂梁的驅動。在雙層膜形成的MEMS熱驅動器中,溫度升高,懸臂梁會向熱膨脹系數小的一側彎曲,當溫度回降,懸臂梁回到原位。

圖 熱執行器(引用doi:0.1088/1361-6439/ab1633/meta)
如何實現MEMS工藝過程中的應力匹配?
MEMS工藝設計過程中,最重要的一個設計就是應力的匹配。可以說,沒有合理的膜層應力匹配,制備出的MEMS器件99%是失效的。以金屬懸臂梁為例,討論應力匹配的方法。選取的材料為Cr和Au,采用磁控濺射制備的Cr薄膜,本征應力為1000MPa,熱膨脹系數為4.9 e-6/°C;采用磁控濺射制備的Au薄膜,本征應力為200MPa,熱膨脹系數為14.1 e-6/°C。

圖 應力匹配模型示意圖
兩層復合膜情況:
Cr薄膜在下層,Au薄膜在上層,考慮本征應力引起的應力梯度,復合膜向應力大的方向,即向下彎曲;考慮熱應力,Cr的熱膨脹系數小于Au的,復合膜向熱膨脹系數小的方向,即向下彎曲。實際工藝過程中Cr常作為Au的黏附層使用,通過分析發現本征應力和熱應力都會使復合膜層變形,這對于器件的制備是非常不利的。解決方案一般為盡量降低Cr的成膜內應力和厚度,增加Au的厚度,以抵抗變形。
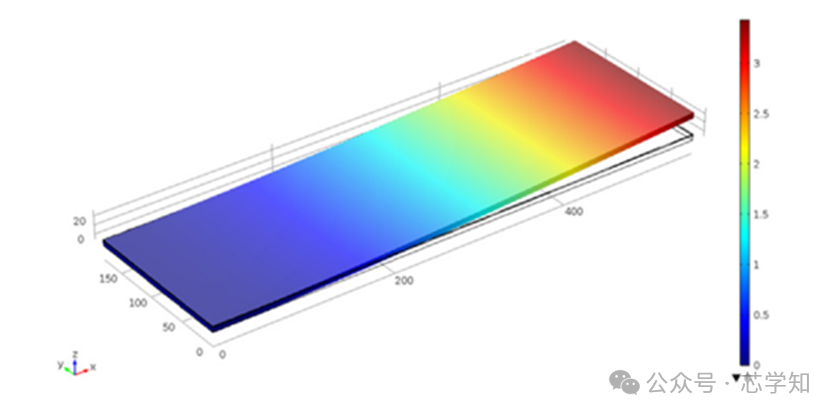
圖 應力匹配力學仿真
三層復合膜情況:
Cr薄膜在下層,Au薄膜在中層,Cr在上層,即形成三明治結構。考慮本征應力梯度,復合膜向應力大的方向彎曲,即由中間Cr層同時向上下Au層彎曲,這樣就實現了本征應力抵消。考慮熱應力,Cr的熱膨脹系數小于Au的,復合膜向熱膨脹系數小的方向,即由中間Cr層同時向上下Au層彎曲,這樣也實現了熱應力的補償。這里唯一要考慮的是,三明治結構,上下層應盡可能做到厚度相同,才能更好的實現本征應力和熱應力的同時補償。
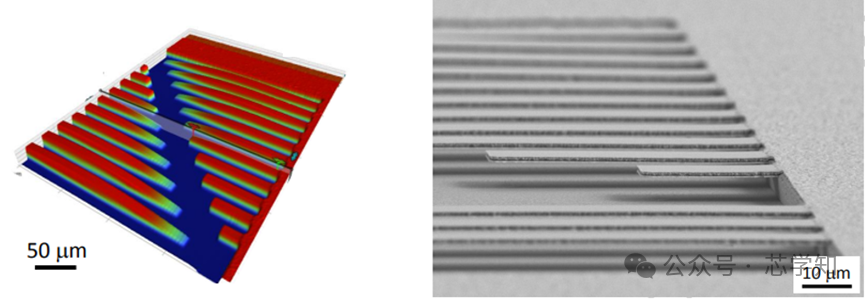
圖 Au-TiW雙層膜應力匹配仿真和SEM(引用10.1016/j.matdes.2016.06.003)
在實際的工藝設計和制造過程中,對于復合膜的使用,通過以上分析,我們明顯看到奇數層組合對應力的補償是優于偶數層的。在MEMS器件的膜層設計中,尤其涉及同時存在正負應力的情況,應考慮的是盡可能降低單層膜的應力,在所有膜層低應力的情況下,去做應力補償和匹配是器件設計和制造成功的關鍵。
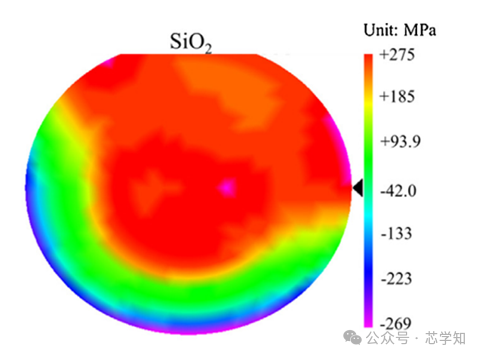
圖 單層膜應力儀測試數據
-
mems
+關注
關注
129文章
4110瀏覽量
192962 -
熱應力
+關注
關注
0文章
11瀏覽量
10840
原文標題:MEMS工藝制造過程中的頭號大敵
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
MEMS制造領域中光刻Overlay的概念
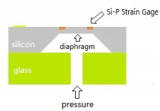
制造誤差歸零:SMA 接口尺寸對工藝嚴苛要求揭秘

揭秘半導體電鍍工藝
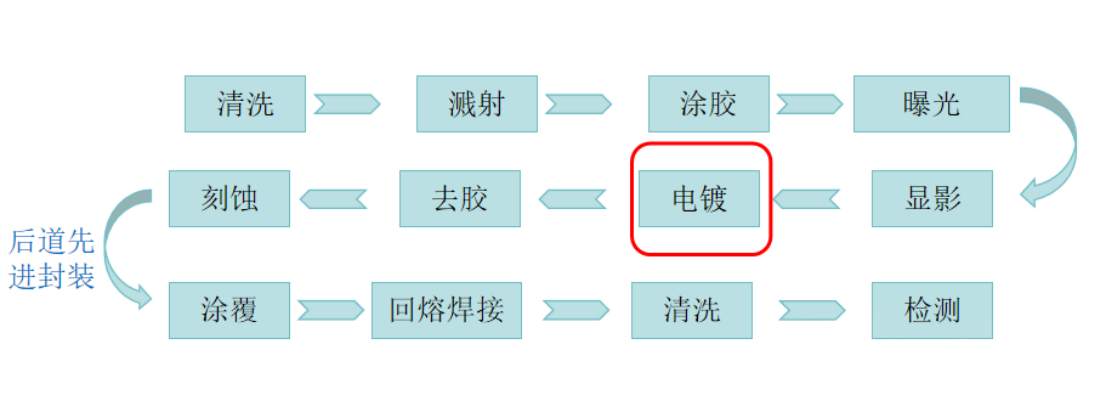
PanDao:光學設計中的制造風險管理
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
TRCX應用:顯示面板工藝裕量分析
芯片制造的7個前道工藝






 MEMS工藝制造中的首要挑戰:揭秘頭號大敵
MEMS工藝制造中的首要挑戰:揭秘頭號大敵





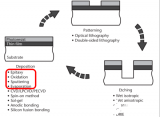











評論