近年來,芯片行業深陷大國博弈的風口浪尖。國內芯片產業的 “卡脖子” 難題,更多集中于芯片制造環節,尤其是光刻機、光刻膠等關鍵設備和材料領域。作為現代科技的核心,芯片的原材料竟是生活中隨處可見的沙子。從沙子到芯片,需歷經數百道工序。下面,讓我們深入了解芯片的制造流程。
一、從沙子到硅片(原材料階段)
沙子由氧和硅組成,主要成分是二氧化硅。芯片制造的首要步驟就是將沙子中的二氧化硅還原成硅錠,之后經過提純,得到一根根長長的硅棒。硅棒需依次進行研磨、切割、拋光等處理,得到厚度<1mm的鏡面硅片,這一階段在硅片廠商進行
整體流程為:沙子→硅熔煉→單晶硅錠→硅錠切割→硅片
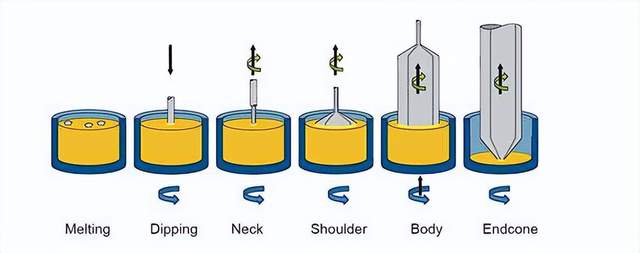
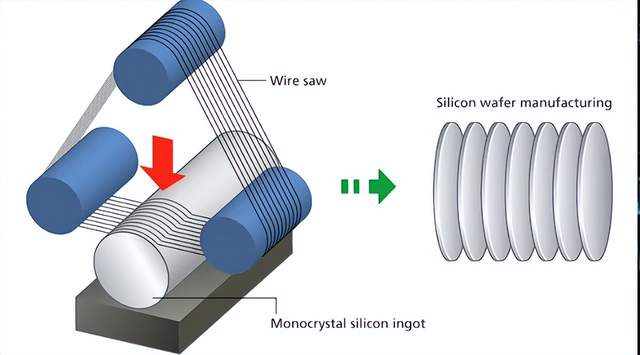
二、晶圓制造(核心工藝)
硅片生完完后,便進入晶圓廠開啟復雜的加工工序
在光禿禿的硅片上表面均勻涂抹光刻膠,利用光刻機進行曝光,將掩模版上的電路圖案轉移到光刻膠上。曝光后,對曝光細節進行處理,再溶解掉不需要的光刻膠。
蝕刻與清洗:通過蝕刻技術,將光刻后暴露出來的晶圓部分進行刻蝕,形成所需的電路結構。最后,清除殘留的光刻膠,得到了包含數百枚的晶圓,這一階段由晶圓廠進行。
整體流程為:光刻膠→曝光→曝光細節處理→溶解光刻膠→蝕刻→清除光刻膠→晶圓

三、CP測試即晶圓級測試
晶圓上單個Die的故障率可達5%-20%,為了減少封裝成本,都需進行CP測試(即晶圓級測試)可降低30%封裝成本,基于ATE測試平臺開發CP測試程序,ATE測試平臺通常采用PXIe模塊化儀器,搭配國產海量互連接口,形成一個可擴展、通用的測試平臺,滿足芯片的高精度、高效的測試需求

四、芯片封裝
CP測試合格后,晶圓進入芯片封裝階段
對晶圓進行切割,取出合格的芯片裸片(Pass Die),形成單顆Die,將單顆Die與基板、金屬散熱片進行封裝,保護芯片并實現電氣連接與散熱。
整體流程為:晶圓切割→取出Pass Die→單顆Die→基板、Die 和金屬散熱片→封裝
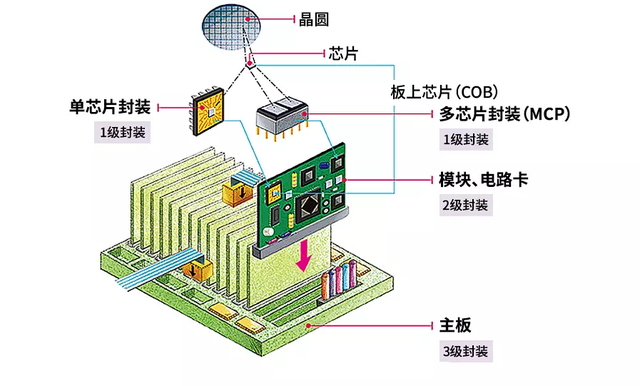
五、FT測試 —芯片級最終把關
封裝完成后,進行FT測試,即芯片級測試,這是芯片出貨前的最后一道測試工序,對保障芯片質量至關重要,基于ATE測試平臺開發CP測試程序。
芯片制造是一場涉及千億級投入的"馬拉松",盡管我國目前自主化程度不高,國產化率仍不足15%,但通過材料(硅片)、設備(光刻機)、測試(ATE)三大環節的垂直突破,可實現從上游的硅片制造,到中游的晶圓、芯片制造,實現芯片產業鏈的完全自主可控。
審核編輯 黃宇
-
芯片
+關注
關注
459文章
52446瀏覽量
439893 -
晶圓級
+關注
關注
0文章
37瀏覽量
10044
發布評論請先 登錄
瑞芯微的技術突圍:從邊緣計算到AI芯片的自主創新之路
國產 2.4G 芯片:從技術突破到產業應用的國產化之路
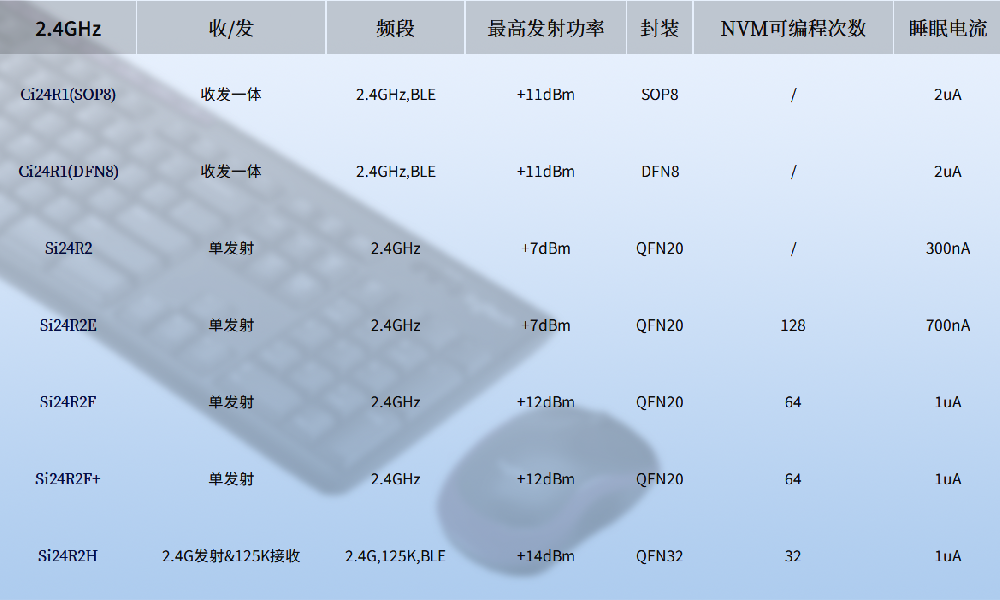

從汽車 BCM 方案看國產 MCU 芯片的突圍與挑戰
【「大話芯片制造」閱讀體驗】+ 芯片制造過程和生產工藝
《大話芯片制造》閱讀體會分享_1
大話芯片制造之讀后感超純水制造
GDS文件在芯片制造流程中的應用
淺談芯片制造的完整流程
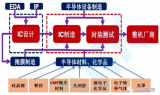






 從芯片制造流程,探尋國產芯片突圍之路
從芯片制造流程,探尋國產芯片突圍之路













評論