半導體制造過程中,清洗工序貫穿多個關鍵步驟,以確保芯片表面的潔凈度、良率和性能。以下是需要清洗的主要工序及其目的:
1. 硅片準備階段
硅片切割后清洗
目的:去除切割過程中殘留的金屬碎屑、油污和機械污染物。
方法:濕法化學清洗(如SC-1溶液)或超聲波清洗。
硅片拋光后清洗
目的:清除拋光液殘留(如氧化層、納米顆粒),避免影響后續光刻精度。
方法:DHF(氫氟酸)腐蝕+去離子水沖洗。
2. 光刻工序
光刻膠涂覆前清洗
目的:去除硅片表面的氧化物、有機物和顆粒,確保光刻膠均勻成膜。
方法:氧等離子體清洗或SC-2溶液清洗。
顯影后清洗
目的:去除殘留光刻膠、顯影液(如堿性溶劑),防止污染下一工序。
方法:去離子水噴淋+兆聲波清洗。
3. 刻蝕工序
干法刻蝕后清洗
目的:清除刻蝕副產物(如聚合物、金屬殘留),避免影響器件電學性能。
方法:氧等離子體清洗或化學濕法清洗(如緩沖氧化物蝕刻液)。
濕法刻蝕后清洗
目的:去除腐蝕性化學殘留(如氟化物、酸性溶液),防止腐蝕下層結構。
方法:去離子水沖洗+IPA(異丙醇)置換干燥。
4. 薄膜沉積工序
CVD/PVD前清洗
目的:去除表面氧化物、有機物和顆粒,確保薄膜均勻性。
方法:氬等離子體轟擊或SC-1溶液清洗。
原子層沉積(ALD)后清洗
目的:清除未反應的前驅體殘留,避免污染下一層級。
方法:惰性氣體吹掃+低溫等離子體清洗。
5. 離子注入工序
注入前清洗
目的:去除硅片表面的有機物和氧化物,防止離子注入能量損失或散射。
方法:紫外臭氧清洗或SC-2溶液清洗。
退火后清洗
目的:清除高溫退火過程中形成的氧化層或雜質擴散。
方法:DHF腐蝕+去離子水沖洗。
6. 封裝前最終清洗
芯片鍵合前清洗
目的:去除金屬氧化層、有機物和顆粒,確保鍵合界面強度。
方法:等離子體清洗(如氬/氧混合)或超聲波清洗。
劃片后清洗
目的:清除切割產生的碎屑和冷卻液殘留,避免封裝污染。
方法:高壓去離子水沖洗+氮氣吹干。
7. 其他關鍵清洗環節
光掩模清洗:去除光刻膠殘留和顆粒,保障圖案精度。
設備部件清洗:定期清潔刻蝕機、鍍膜機等腔體內壁,防止交叉污染。
中間存儲清洗:硅片在各工序間暫存時需清潔承載盒(如FOUP),避免環境污染物附著。
審核編輯 黃宇
-
半導體
+關注
關注
335文章
28880瀏覽量
237392
發布評論請先 登錄
功率半導體器件——理論及應用
蘇州芯矽科技:半導體清洗機的堅實力量
半導體芯片清洗用哪種硫酸好
半導體清洗SC1工藝
半導體單片清洗機結構組成介紹
單片腐蝕清洗方法有哪些
半導體VTC清洗機是如何工作的
半導體濕法清洗有機溶劑有哪些
半導體制造中的濕法清洗工藝解析






 半導體哪些工序需要清洗
半導體哪些工序需要清洗


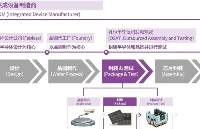










評論