來(lái)源:本文由長(zhǎng)電科技陳靈芝博士翻譯自Semiconductor Engineering,原發(fā)于芯華社,謝謝。
MIS在模擬、功率IC和數(shù)字貨幣等領(lǐng)域作為一種新型封裝方式而出現(xiàn)。
基于一種新興技術(shù)MIS的IC封裝正在積蓄動(dòng)力。
日月光(ASE)、嘉盛(Carsem)、長(zhǎng)電科技(JCET)/星科金朋(STATS ChipTAC)、宇芯(Unisem)等都在開(kāi)發(fā)基于MIS基板的IC封裝技術(shù),目前在模擬、功率IC、及數(shù)字貨幣等市場(chǎng)領(lǐng)域迅速發(fā)展。
MIS封裝采用特有的基板材料,開(kāi)始主要用在一些特定的IC封裝上。MIS基板目前有多家的供應(yīng)商在進(jìn)行開(kāi)發(fā)及銷(xiāo)售,因此封裝廠(chǎng)可以從多家廠(chǎng)商采購(gòu),然后進(jìn)行IC封裝。有人認(rèn)為MIS基板是一種引線(xiàn)框。
MIS與傳統(tǒng)的基板不同,包含一層或多層預(yù)包封結(jié)構(gòu)。每一層都通過(guò)電鍍銅來(lái)進(jìn)行互連,以提供在封裝過(guò)程中的電性連接。MIS支持單芯片或多芯片封裝,為超薄、高密度細(xì)節(jié)距封裝提供方案。它可以被用于開(kāi)發(fā)先進(jìn)的引線(xiàn)框封裝、倒裝芯片封裝、模組封裝及系統(tǒng)級(jí)封裝。
圖1:預(yù)包封的MIS引線(xiàn)框架
來(lái)源:宇芯Unisem
圖2:基于MIS的IC封裝
來(lái)源:Prismark,QDOS
表面上,MIS類(lèi)似于扇出型(Fan-Out)晶圓級(jí)封裝。它們之間最大的區(qū)別是,MIS在I/O和密度方面稍加遜色。因此,在實(shí)際封裝使用中,MIS主要跟目前一些已經(jīng)比較成熟的中端封裝進(jìn)行競(jìng)爭(zhēng)。
MIS已經(jīng)存在了近十年,但市場(chǎng)剛剛開(kāi)始起來(lái)。“(MIS)由于其先進(jìn)的布線(xiàn)能力和可靠性,在高、低功率應(yīng)用上都很適用,” 日月光工程技術(shù)營(yíng)銷(xiāo)總監(jiān)Mark Gerber說(shuō)。
此外,MIS還為客戶(hù)提供了一種新的封裝選擇,以及現(xiàn)有封裝的一種潛在的替代方案。“出貨量在這幾年不斷上升,”Nokibul Islam說(shuō)。“可以用MIS來(lái)替代一些傳統(tǒng)的如QFN封裝或基于引線(xiàn)框的封裝,因?yàn)镸IS具有更細(xì)的布線(xiàn)能力,更優(yōu)的電和熱性能,和更小的外形。”
還有, MIS封裝被鎖定用于數(shù)字貨幣芯片的封裝,進(jìn)入了數(shù)字貨幣服務(wù)器市場(chǎng)。這個(gè)市場(chǎng)的量是非常巨大的。當(dāng)然也有一些人開(kāi)始考慮數(shù)字貨幣市場(chǎng)是否或者說(shuō)何時(shí)可能結(jié)束。
什么是MIS?
MIS是在2010年左右開(kāi)發(fā)的,長(zhǎng)電科技是最早期的開(kāi)發(fā)者之一,然后將這項(xiàng)技術(shù)授權(quán)給其兄弟公司芯智聯(lián)(MISpak)。
MISpak開(kāi)發(fā)和銷(xiāo)售MIS材料給封裝廠(chǎng)(OSAT),其他MIS基板供應(yīng)商還包括ASM、PPT、QDOS和SIMMTECH。
因此,封裝廠(chǎng)購(gòu)買(mǎi)MIS基板有更多的選擇。然后,在封裝過(guò)程中,把芯片放在MIS基板上進(jìn)行封裝,最后形成MIS封裝。

圖3:矽品的倒裝MIS BGA封裝(FC-MISBGA)
來(lái)源:TechSearch International,矽品精密SPIL
隨著時(shí)間的推移, MIS業(yè)務(wù)規(guī)模開(kāi)始迅速成長(zhǎng)。2017年,僅芯智聯(lián)(MISpak)一家就預(yù)計(jì)出貨25億顆,而在2010年,其出貨量?jī)H2000萬(wàn)顆。在MIS封裝領(lǐng)域,芯智聯(lián)(MISpak)宣稱(chēng)其大約有30多家終端顧客。當(dāng)然這中間還沒(méi)包括其他MIS供應(yīng)商的出貨量。

圖4:芯智聯(lián)MIS基板出貨量
來(lái)源:芯智聯(lián)MISpak
MIS與傳統(tǒng) IC封裝基板不同。傳統(tǒng)封裝采用的是有機(jī)基板,這是基于PCB類(lèi)材料的多層基板技術(shù)。在封裝中,芯片置于基板之上。
“MIS技術(shù)的特點(diǎn)是,它是從包封技術(shù)引申發(fā)展出來(lái)的。在MIS基板中,銅布線(xiàn)是嵌入式的。因此,這種嵌入式結(jié)構(gòu)就可以做到更細(xì)的布線(xiàn),” Nokibul Islam說(shuō)。
MIS還具有其他的一些特性。“它使用包封料作為各層之間的絕緣材料,”Mark Gerber說(shuō)。“當(dāng)你使用該類(lèi)型的引線(xiàn)框,并在此上進(jìn)行封裝,那么封裝的包封料與引線(xiàn)框的材料特性就是相似的。因此,從吸潮性或功能的角度來(lái)看就非常好。”
目前制作MIS基板的方法有多種。MIS最早是以尺寸250mmX70mm的長(zhǎng)條形出現(xiàn) 。MIS制作需要經(jīng)過(guò)一系列的工藝步驟,如蝕刻、研磨、光刻、包封和電鍍。
比如,單層MIS工藝流程,往往從載板開(kāi)始。“在金屬載板上,通過(guò)電鍍銅來(lái)制作基板的布線(xiàn),”NokibulIslam解釋道。“所以在完成電鍍銅后,下一步就是去除光阻膜工藝。”
在去膜后。“就開(kāi)始進(jìn)行包封。然后研磨包封料進(jìn)行減薄,達(dá)到所要求的厚度。最后蝕刻載板,”NokibulIslam說(shuō)。
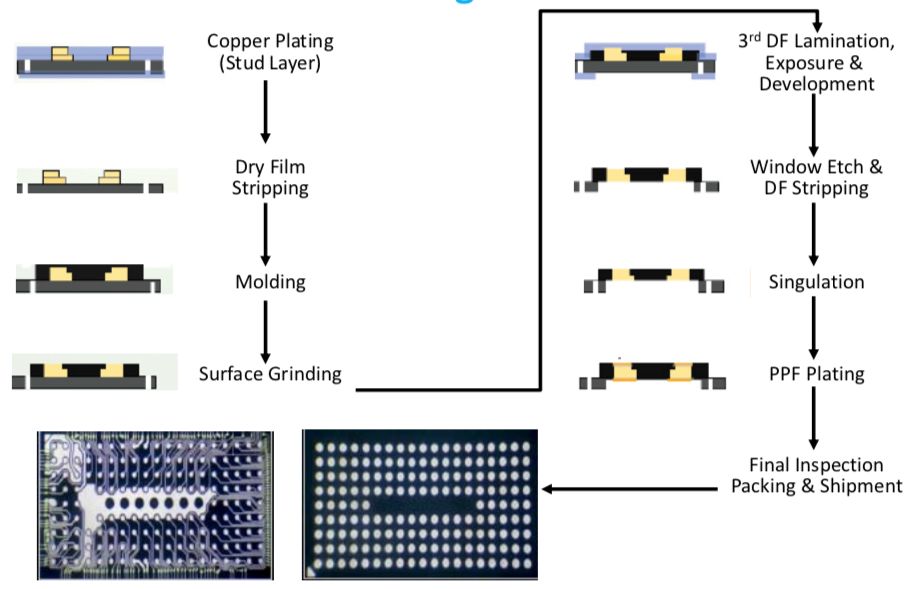
圖5:MIS基板制造工藝流程
來(lái)源:長(zhǎng)電科技JCET
對(duì)于MIS封裝,該技術(shù)最有優(yōu)勢(shì)的是薄型、I / O在150?200之間的封裝。但該技術(shù)受限于25μm左右的線(xiàn)寬線(xiàn)距,這意味著它主要面向中端應(yīng)用。線(xiàn)寬線(xiàn)距是指封裝中的金屬布線(xiàn)。
對(duì)比來(lái)看,主要用于高端應(yīng)用的扇出型封裝(Fan-Out),其標(biāo)準(zhǔn)密度是: I / O小于500的封裝,其線(xiàn)寬線(xiàn)距在8μm以上;而高密度扇出型封裝,其I / O大于500,線(xiàn)寬線(xiàn)距小于8μm。
同時(shí),MIS材料本身相對(duì)較薄。該類(lèi)基板在封裝過(guò)程中容易出現(xiàn)翹曲及均勻性問(wèn)題。產(chǎn)量和成本問(wèn)題則另論。
“不同的應(yīng)用需求在設(shè)計(jì)靈活性和封裝厚度方面需要特殊的封裝材料,” ASM材料業(yè)務(wù)部市場(chǎng)副總裁Ho Kwok Kuen說(shuō)。“相比引線(xiàn)框架,ABiT-MIS有能力可以生產(chǎn)出要求高、線(xiàn)路復(fù)雜的預(yù)包封基板。但是,為了達(dá)到設(shè)計(jì)的解析度需要更多的工藝步驟,因此為了達(dá)到最終產(chǎn)品的良率目標(biāo),我們需要高度關(guān)注在每一個(gè)工藝過(guò)程中如何實(shí)現(xiàn)更高的良率。”
除了設(shè)備,ASM也提供引線(xiàn)框架和MIS封裝材料。這里是指ASM加層互連技術(shù)(ABiT,ASM Buildup Interconnect Technology )。
盡管面臨種種挑戰(zhàn),但是MIS市場(chǎng)還是迅速成長(zhǎng)。“在過(guò)去的兩年里,我們已經(jīng)看到了許多客戶(hù)希望使用MIS封裝來(lái)滿(mǎn)足數(shù)字貨幣挖礦應(yīng)用的需求。”Ho說(shuō),“MIS不僅在通訊領(lǐng)域射頻封裝的市場(chǎng)份額不斷增加,其實(shí)在電源管理和汽車(chē)應(yīng)用方面的需求也在不斷增加。”
同時(shí)在市場(chǎng)上, MIS也是面臨著激烈的競(jìng)爭(zhēng)。這里指“Fan-Out”技術(shù),盡管MIS并不會(huì)與Fan-Out技術(shù)競(jìng)爭(zhēng)。其實(shí)MIS主要是與引線(xiàn)框封裝和LGA封裝進(jìn)行競(jìng)爭(zhēng)。“MIS的應(yīng)用領(lǐng)域主要是介于標(biāo)準(zhǔn)QFN封裝和簡(jiǎn)單的雙層基板兩者之間的封裝。”宇芯北美區(qū)副總裁Gil Chiu說(shuō)。
引線(xiàn)框封裝包括若干封裝類(lèi)型,諸如四面扁平無(wú)引線(xiàn)(QFN)和四面扁平封裝(QFP)。引線(xiàn)框是金屬框架,芯片粘貼在框架上,使用細(xì)導(dǎo)線(xiàn)進(jìn)行連接。

圖6:QFN封裝
來(lái)源:維基百科
QFN是成熟、價(jià)格低廉且可靠的封裝方式,因此在模擬、汽車(chē)電子、物聯(lián)網(wǎng)、RF等市場(chǎng)方面,QFN的需求巨大。通常來(lái)講,雖然QFN是一個(gè)I / O能力有限的單層技術(shù),但是“如果你可以用QFN實(shí)現(xiàn),你顯然會(huì)這么做,因?yàn)镼FN的成本比MIS更低,”Chiu說(shuō)。“但是當(dāng)你使用QFN時(shí),你要接受間距的限制。”
MIS還與LGA封裝技術(shù)競(jìng)爭(zhēng)。LGA在封裝底部有用于連接的金屬焊盤(pán)陣列。LGA適用于模塊、處理器等產(chǎn)品。
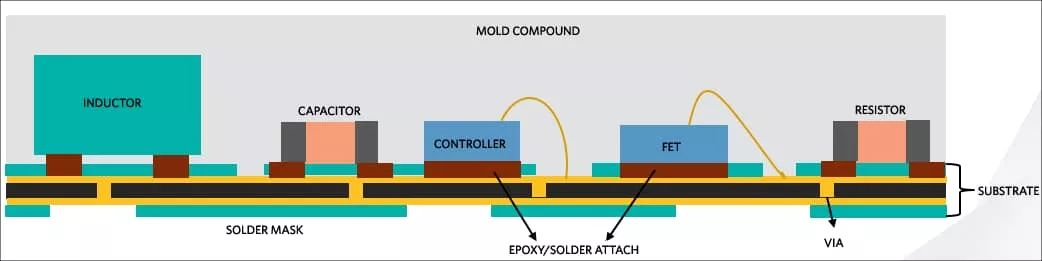
圖7:電源模塊LGA封裝結(jié)構(gòu)
MIS相比LGA更便宜,但功能更少。然而,宇芯公司認(rèn)為L(zhǎng)GA有時(shí)會(huì)受高昂的材料成本、連接孔(Via)成型成本等影響。
因此,QFN和LGA都有一些缺點(diǎn),這里就是MIS的用武之地。例如,IC設(shè)計(jì)公司可能會(huì)在給定的工藝節(jié)點(diǎn)有現(xiàn)成的芯片設(shè)計(jì),且芯片封裝采用QFN封裝。在這個(gè)假設(shè)的例子中,供應(yīng)商會(huì)面臨一些挑戰(zhàn)。“客戶(hù)基本上會(huì)說(shuō),我有一個(gè)現(xiàn)成的方案,我不想改變我的芯片,我不希望縮小我的芯片,但我想縮小我的封裝,我希望得到一個(gè)更薄、更小尺寸的封裝,”Chiu說(shuō)。
一種有效的解決方案就是從QFN封裝轉(zhuǎn)向MIS封裝。通常,你可以采用與引線(xiàn)框封裝相同的芯片,用在MIS上進(jìn)行封裝。MIS封裝可以做到跟QFN封裝類(lèi)似,但MIS可以有更多的I / O和更好的性能。
采用MIS封裝,基本上可以和其他封裝類(lèi)型一樣,例如:倒裝芯片、模塊和SiP。“MIS技術(shù)是不同的。它本質(zhì)上是一種積層工藝。它可以讓你實(shí)現(xiàn)更密的金屬布線(xiàn)。因此,您可以縮小封裝,而同時(shí)保持相同的芯片尺寸,”Chiu說(shuō)。“使用MIS,客戶(hù)不必花費(fèi)時(shí)間或資源來(lái)重新設(shè)計(jì)一個(gè)更小的芯片以及不必縮小芯片的外形。采用MIS,你可以讓產(chǎn)品獲得額外的。它可以讓你保持與現(xiàn)成方案的匹配。所以,MIS在相同的成本下可以為您提供更小的封裝。”
“搭上”或“錯(cuò)過(guò)”?
一段時(shí)間以來(lái),一些OSAT廠(chǎng)已經(jīng)不斷出貨MIS封裝。但是每個(gè)供應(yīng)商都有不同的戰(zhàn)略。
長(zhǎng)電科技/星科金朋已經(jīng)出貨了各類(lèi)基于MIS技術(shù)的Chip-on-lead、FC、模組及SiP封裝產(chǎn)品。“MIS具有其特定的優(yōu)勢(shì)。最優(yōu)的是低I / O數(shù)的高功率、高散熱的應(yīng)用。” 長(zhǎng)電科技的Islam說(shuō)。
到目前為止,業(yè)內(nèi)主要出貨的是線(xiàn)寬線(xiàn)距在25/25μm的單層MIS封裝。“對(duì)于未來(lái)的市場(chǎng),我們目前正在做更高的解析度,這意味著更細(xì)的線(xiàn)寬線(xiàn)距,以及更輕薄的外形,”Islam說(shuō)。“兩年以后,它可以做到15/15μm的線(xiàn)寬線(xiàn)距。”
此外,長(zhǎng)電科技/星科金朋以及其他廠(chǎng)商都在全力致力于基于Ajinomoto的ABF(Ajinomoto Build-up Film)膜技術(shù)的更先進(jìn)的工藝。使用激光成型和直接電鍍銅,ABF可以使MIS做到線(xiàn)寬線(xiàn)距達(dá)12/12μm的多層基板,這樣可以實(shí)現(xiàn)二層、三層及四層的多層封裝。
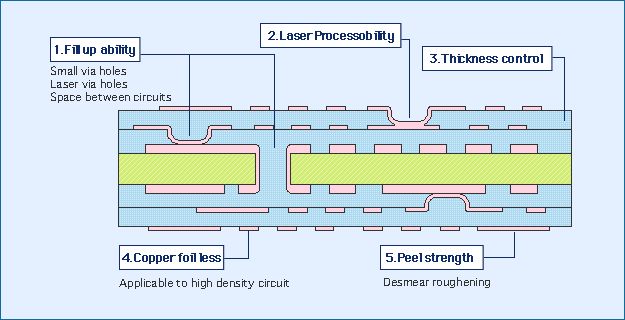
圖8:Ajinomoto 的ABF膜
來(lái)源:Ajinomoto
“使用ABF膜,MIS的工藝流程基本完全是一樣的。我們只是使用更厚的ABF膜來(lái)替代包封料,我們可以提供這種類(lèi)型的多層MIS基板,”他說(shuō)。“在今年年底左右我們就會(huì)開(kāi)始使用基于ABF膜的兩層或三層MIS基板。”
日月光的MIS封裝也正在成長(zhǎng)中。日月光的MIS技術(shù)被稱(chēng)為C2IM / MIS。“MIS可以讓你做到型同QFN封裝而同時(shí)具備精細(xì)節(jié)距布線(xiàn)能力的封裝,” 日月光的Gerber說(shuō)。“(有些客戶(hù))非常堅(jiān)持使用QFN封裝,但是有布線(xiàn)能力的限制。當(dāng)你可以進(jìn)行20/20μm或30/30μm的布線(xiàn),這就一下子為他們提供了一層布線(xiàn)金屬層的解決方案。”
除了C2IM / MIS,日月光還提供另一個(gè)競(jìng)爭(zhēng)性的技術(shù)叫“ChipLast扇出封裝”,這不同于現(xiàn)行的扇出型封裝。“它本質(zhì)上是一個(gè)芯片后置的工藝,這就意味著它是一個(gè)倒裝芯片工藝,”Gerber說(shuō)。“ChipLast扇出封裝是一個(gè)根據(jù)布線(xiàn)密度使用兩種不同絕緣材料,而只有一層金屬布線(xiàn)的無(wú)芯基板工藝方案”。
此外,相對(duì)于MIS基板,日月光還有另一個(gè)選擇方案叫做aS3 +。“aS3 +是一個(gè)嵌入式線(xiàn)路(ET)的無(wú)芯有機(jī)基板,這個(gè)技術(shù)也可以提供與C2IM / MIS類(lèi)似優(yōu)勢(shì)的方案。此外,aS3 + / ET基板可以做到三層或更多層布線(xiàn),而在這方面C2IM / MIS相對(duì)比較欠缺,”他說(shuō)。“aS3 + / ET可以使用傳統(tǒng)絕緣材料或ABF絕緣材料。同時(shí)由于不需要芯板材料以及其制造工藝流程和它內(nèi)在的結(jié)構(gòu)特點(diǎn),它可以帶來(lái)有利于更高速度連接的層間超低電感,同時(shí)不失成本競(jìng)爭(zhēng)力及可靠性 ”。
對(duì)宇芯來(lái)講,他們看到的是MIS封裝的三個(gè)應(yīng)用。這些封裝都可以做到整體厚度達(dá)到0.33毫米或更低。
第一種應(yīng)用是該公司所謂的空腔,芯片封裝在這個(gè)封裝體的空腔里。“我們正在利用MIS實(shí)現(xiàn)介于基板封裝與QFN封裝之間的細(xì)間距芯片倒裝封裝,在這方面可以一展身手,”宇芯的Chiu如是說(shuō)。“我們同樣還在考慮使用MIS進(jìn)行系統(tǒng)級(jí)封裝,這對(duì)于LGA標(biāo)準(zhǔn)模塊封裝來(lái)說(shuō),是一個(gè)成本更低的方案。”
對(duì)于MIS來(lái)說(shuō),最大的市場(chǎng)是電源/功率IC。另一個(gè)驅(qū)動(dòng)因素是數(shù)字貨幣IC封裝。展望未來(lái),MIS可能會(huì)超出這些市場(chǎng)。“好消息是,我們看到越來(lái)越多的常規(guī)產(chǎn)品也在考慮是否使用MIS封裝.”Chiu補(bǔ)充說(shuō)。
-
處理器
+關(guān)注
關(guān)注
68文章
19746瀏覽量
232953 -
芯片
+關(guān)注
關(guān)注
459文章
51947瀏覽量
433954 -
模塊
+關(guān)注
關(guān)注
7文章
2773瀏覽量
49121
發(fā)布評(píng)論請(qǐng)先 登錄
最全最詳盡的半導(dǎo)體制造技術(shù)資料,涵蓋晶圓工藝到后端封測(cè)
高密度封裝失效分析關(guān)鍵技術(shù)和方法

信號(hào)源分析儀的技術(shù)原理和應(yīng)用場(chǎng)景
SIP封裝技術(shù):引領(lǐng)電子封裝新革命!

2.5D和3D封裝技術(shù)介紹

全球先進(jìn)封裝市場(chǎng)現(xiàn)狀與趨勢(shì)分析

成都微光集電發(fā)布全新MIS20S1視頻產(chǎn)品
CoWoS先進(jìn)封裝技術(shù)介紹

射頻分析儀的技術(shù)原理和應(yīng)用場(chǎng)景
系統(tǒng)級(jí)封裝(SiP)技術(shù)介紹






 關(guān)于MIS封裝技術(shù)的分析介紹
關(guān)于MIS封裝技術(shù)的分析介紹

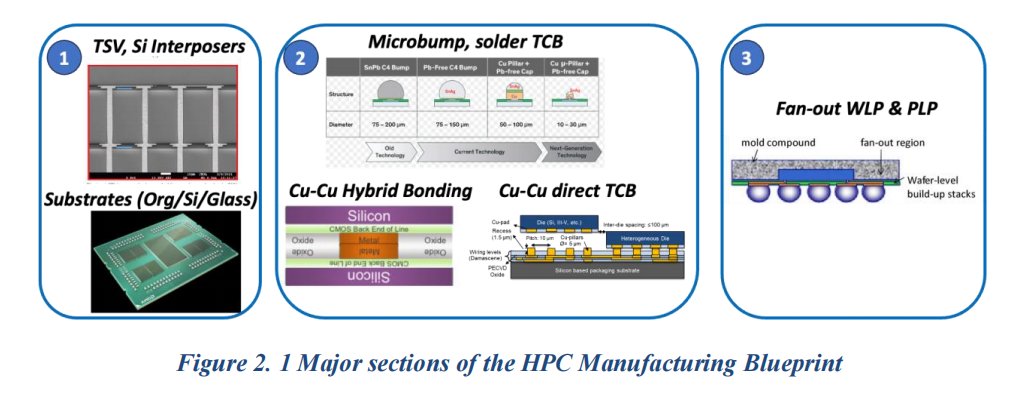










評(píng)論