汽車(chē)電動(dòng)化推動(dòng)了對(duì)碳化硅功率集成電路的需求,但同時(shí)也給尋找和識(shí)別這些芯片中的缺陷帶來(lái)了挑戰(zhàn)。對(duì)此,技術(shù)分析機(jī)構(gòu)semiengieering給出了具體分析。
與此同時(shí),業(yè)界越來(lái)越意識(shí)到碳化硅技術(shù)是多么不成熟,還有很多工作需要完成,而且需要迅速完成。汽車(chē)制造商正大力發(fā)展電動(dòng)車(chē),并且從400V升級(jí)至800V電池系統(tǒng),加速了電動(dòng)汽車(chē)電源模塊從IGBT到碳化硅器件的轉(zhuǎn)變。結(jié)果將是碳化硅需求呈指數(shù)級(jí)增長(zhǎng),而所有這些都需要完美無(wú)瑕地運(yùn)行。
“電動(dòng)汽車(chē)和可再生能源的快速增長(zhǎng)正在使功率半導(dǎo)體市場(chǎng)發(fā)生重大變化,”國(guó)家儀器公司SET部門(mén)副總裁兼技術(shù)負(fù)責(zé)人Frank Heidemann表示,“這種轉(zhuǎn)變推動(dòng)了對(duì)提高效率的需求,特別是在汽車(chē)領(lǐng)域,從而引發(fā)了碳化硅和氮化鎵等寬帶隙技術(shù)的出現(xiàn)。”
與硅基的IGBT器件相比,碳化硅器件具有多種性能優(yōu)勢(shì),使其成為更好的選擇。
“功率密度、更高的電壓和有吸引力的熱性能是使碳化硅功率器件對(duì)那些制造非常高效的電機(jī)驅(qū)動(dòng)器、非常密集的電機(jī)驅(qū)動(dòng)器或聚合電路的人具有吸引力的三個(gè)因素,”Wolfspeed公司功率IC副總裁高級(jí)工程師Jay Cameron表示。“我們看到許多需要大功率但體積更小或更輕的應(yīng)用。因此,如果你希望擁有使用較少銅材更輕量級(jí)的系統(tǒng),那么使用碳化硅,就可以在保持高功率水平的同時(shí)進(jìn)行電壓和電流之間的權(quán)衡來(lái)實(shí)現(xiàn)這一目標(biāo)。”
基于碳化硅的功率模塊需要更少的集成電路,并且不需要太多冷卻,這減少了所需的熱解決方案的數(shù)量。這些模塊在各個(gè)電池系統(tǒng)之間、充電站和電池系統(tǒng)之間,以及電機(jī)和電池系統(tǒng)之間執(zhí)行各種基本的電壓轉(zhuǎn)換。
在400V電池系統(tǒng)中,IGBT器件一直是支持這些功能的主要集成電路。為了降低整體功率模塊的成本,工程師們已經(jīng)開(kāi)始從IGBT轉(zhuǎn)向碳化硅器件,但隨著從400V升級(jí)至800V的電池車(chē)輛的轉(zhuǎn)變,這種轉(zhuǎn)變正在加速進(jìn)行。碳化硅可以在高達(dá)1200V的電壓下工作。
為了滿(mǎn)足對(duì)碳化硅日益增長(zhǎng)的需求,行業(yè)需要加快生產(chǎn)速度。這意味著要解決長(zhǎng)期以來(lái)影響碳化硅生產(chǎn)的制造挑戰(zhàn)。這些挑戰(zhàn)包括高昂的器件成本以及缺陷和可靠性問(wèn)題。為了解決成本問(wèn)題,碳化硅基片制造商正在從8英寸轉(zhuǎn)向12英寸晶圓。然而,這種預(yù)期的指數(shù)增長(zhǎng)給碳化硅器件的篩選帶來(lái)了挑戰(zhàn),這將需要制造商和檢測(cè)測(cè)試設(shè)備供應(yīng)商進(jìn)行創(chuàng)新。
NI公司的Heidemann表示:“與傳統(tǒng)的硅器件相比,這些寬帶隙器件在生產(chǎn)線(xiàn)末端(EoL,即晶圓、封裝、模塊和系統(tǒng)制造過(guò)程末端進(jìn)行的測(cè)試)測(cè)試中面臨著獨(dú)特的挑戰(zhàn),因?yàn)樗鼈冋故玖瞬煌墓收蠙C(jī)制和模型。”他還說(shuō):“此外,對(duì)它們進(jìn)行可靠性和高達(dá)2000伏或更高的高壓環(huán)境測(cè)試,對(duì)于以前沒(méi)有針對(duì)這些要求設(shè)計(jì)的EoL測(cè)試系統(tǒng)來(lái)說(shuō)是一個(gè)重大挑戰(zhàn)。”
碳化硅的制造過(guò)程有時(shí)會(huì)導(dǎo)致影響基本功能和性能特性的缺陷,因此需要通過(guò)檢查和電氣測(cè)試進(jìn)行篩選。高電壓和高電流測(cè)試需要精心設(shè)計(jì)的測(cè)試系統(tǒng),既能提供必要的電流和電壓,又能在不可避免的短路發(fā)生時(shí)保護(hù)設(shè)備。
到目前為止,這種篩選工作一直在低容量下進(jìn)行。要擴(kuò)大到更高容量需要?jiǎng)?chuàng)新,才能確保篩選的有效性和成本效益。
檢驗(yàn)和計(jì)量方法
硅和碳化硅功率IC之間的一個(gè)關(guān)鍵區(qū)別與襯底的生長(zhǎng)方式有關(guān)。作為一種均勻的晶體結(jié)構(gòu),硅幾乎沒(méi)有亞表面缺陷。相比之下,碳化硅是通過(guò)化學(xué)氣相沉積進(jìn)行生長(zhǎng)的,這可能導(dǎo)致各種亞表面缺陷,如堆垛層錯(cuò)和微管缺陷。在隨后的外延生長(zhǎng)過(guò)程中,晶體缺陷會(huì)傳播。此外,由于碳化硅是一種脆性材料,它更容易出現(xiàn)如劃痕和凹陷等表面缺陷,這可能會(huì)影響整個(gè)晶圓的性能。
此外,碳化硅晶圓在處理過(guò)程中容易破裂,切割成片后會(huì)產(chǎn)生更多的裂紋,這些裂紋可能會(huì)擴(kuò)展。因此,在整個(gè)晶圓和組裝過(guò)程中進(jìn)行檢查至關(guān)重要。
由于其高吞吐量,工程師在碳化硅制造過(guò)程中主要依賴(lài)于光學(xué)檢測(cè)系統(tǒng)。一些公司提供專(zhuān)門(mén)用于碳化硅的光學(xué)檢測(cè)工具,包括審查和分類(lèi)功能。
計(jì)量技術(shù)則較為復(fù)雜。計(jì)量反饋涉及眾多參數(shù),工藝工程師需要測(cè)量這些參數(shù),包括襯底平整度和厚度、晶格取向、電阻和表面粗糙度等。反過(guò)來(lái),這些參數(shù)又需要使用各種不同的系統(tǒng)進(jìn)行測(cè)量。
“白光干涉測(cè)量?jī)x器被用于襯底制造過(guò)程中的質(zhì)量保證/質(zhì)量控制,以測(cè)量硅、氮化鎵和碳化硅晶圓的粗糙度(亞納米級(jí)),”Bruker公司的白光干涉儀產(chǎn)品經(jīng)理Sandra Bergmann表示,“碳化硅襯底的生產(chǎn)更具挑戰(zhàn)性。由于其硬度較高,拋光過(guò)程困難。因此,白光干涉測(cè)量對(duì)于優(yōu)化/跟蹤拋光過(guò)程至關(guān)重要。”
碳化硅器件可以是平面或溝槽結(jié)構(gòu)技術(shù)。白光干涉測(cè)量尤其適用于溝槽深度計(jì)量。
“在高電壓集成電路制程中,對(duì)于高深寬比溝槽深度的測(cè)量,白光干涉測(cè)量?jī)x器可以從2μm的開(kāi)口測(cè)量到40μm的深度,”Bergmann表示。“它是非破壞性的,并且可以在視野范圍內(nèi)同時(shí)檢測(cè)所有的溝槽。我們通常使用5倍物鏡和0.5平方毫米的探測(cè)區(qū)域。我們還能提供整個(gè)視野范圍內(nèi)溝槽深度的完整變化。”
晶圓檢測(cè)需要考慮表面缺陷和亞表面缺陷,其中亞表面缺陷對(duì)于碳化硅尤為重要。
Onto Innovation公司的檢測(cè)產(chǎn)品市場(chǎng)經(jīng)理Burhan Ali表示:“光學(xué)檢測(cè)技術(shù)用于缺陷檢測(cè),而X射線(xiàn)和光致發(fā)光則用于計(jì)量。光學(xué)檢測(cè)的挑戰(zhàn)在于它在高吞吐量下能有效地檢測(cè)到表面缺陷,但當(dāng)涉及亞表面晶體缺陷時(shí)很快就會(huì)失去效果。在這些情況下,光致發(fā)光技術(shù)已被證明可以有效地檢測(cè)碳化硅襯底和外延層的亞表面晶體缺陷。”
在整個(gè)組裝過(guò)程中都需要進(jìn)行檢測(cè)。由于高吞吐量和低設(shè)備投資,光學(xué)檢測(cè)是首選的方法。但光學(xué)檢測(cè)只能檢測(cè)表面缺陷。對(duì)于檢測(cè)中度到高密度的亞表面缺陷,X射線(xiàn)是首選解決方案,因?yàn)樗梢愿咚龠\(yùn)行2D模式。另外,聲學(xué)檢測(cè)可以輕松檢測(cè)到分層,但需要將零件浸入水中。
Amkor Technology的全球測(cè)試服務(wù)副總裁George Harris表示:“手動(dòng)、光學(xué)和X射線(xiàn)檢測(cè)都是非破壞性的方法。基本的X射線(xiàn)檢測(cè)對(duì)于包裝完整性的評(píng)估非常有用。很多系統(tǒng)性的缺陷模式可以通過(guò)X射線(xiàn)輕松識(shí)別,因此深受客戶(hù)歡迎。根據(jù)客戶(hù)的要求,還可以在專(zhuān)門(mén)的故障分析實(shí)驗(yàn)室進(jìn)行破壞性的機(jī)械橫截面和掃描電子顯微鏡檢測(cè)。”
檢測(cè)不僅限于電氣問(wèn)題,還可以用于識(shí)別可能影響熱管理的缺陷。
Nordson Test & Inspection的產(chǎn)品線(xiàn)總監(jiān)Brad Perkins表示:“在封裝領(lǐng)域,大多數(shù)電氣缺陷與導(dǎo)線(xiàn)交叉/接觸成型工藝并導(dǎo)致短路有關(guān)。還需要考慮熱保護(hù)的需求,這就是為什么工程師要檢查芯片連接,因?yàn)樗菬峁芾淼囊徊糠帧H绻嬖谶^(guò)大的空隙、總空隙百分比過(guò)高或分層足夠大,將會(huì)在芯片中產(chǎn)生熱點(diǎn),從而導(dǎo)致過(guò)早故障。由于許多功率器件用于高可靠性應(yīng)用(汽車(chē)、火車(chē)、風(fēng)力發(fā)電等),故障成本可能非常高,因此對(duì)可能導(dǎo)致早期故障的缺陷進(jìn)行檢查對(duì)制造商來(lái)說(shuō)非常劃算。”
測(cè)試方法
碳化硅的大規(guī)模生產(chǎn)相對(duì)較新,它在汽車(chē)應(yīng)用中的使用也是如此。因此,業(yè)界正在制定嚴(yán)格的測(cè)試流程以確保質(zhì)量和可靠性。測(cè)試在多個(gè)溫度、電壓和頻率下進(jìn)行。這是至關(guān)重要的,因?yàn)槿毕菰谳^低頻率和電壓下可能表現(xiàn)出良好,但在較高頻率和/或電壓下可能顯現(xiàn)出來(lái)。
由于其模擬特性,功率集成電路需要進(jìn)行功能和性能測(cè)試。對(duì)于功率集成電路,測(cè)試被分為靜態(tài)測(cè)試和動(dòng)態(tài)測(cè)試,即直流測(cè)試和交流測(cè)試。靜態(tài)測(cè)試在室溫下進(jìn)行,而動(dòng)態(tài)測(cè)試在高溫下進(jìn)行。
Advantest Italy的總經(jīng)理Fabio Marino表示:“靜態(tài)測(cè)試不再是一個(gè)挑戰(zhàn),因?yàn)楸粶y(cè)器件(DUT)在穩(wěn)定狀態(tài)下進(jìn)行測(cè)試。這意味著低功率。即使它是超高電壓,也將是低電流,如果它是超高電流,也將是低電壓。工程界真正面臨的挑戰(zhàn)是動(dòng)態(tài)測(cè)試。動(dòng)態(tài)測(cè)試的功率極高,因?yàn)樗鼫y(cè)試了DUT從開(kāi)啟到關(guān)閉狀態(tài)的轉(zhuǎn)換,以及相反的過(guò)程,這意味著非常高的電流和電壓。雖然過(guò)渡過(guò)程只占用極短的時(shí)間,但它在極高的功率下進(jìn)行。”
對(duì)于寬帶隙器件中觀察到的柵閾值漂移引起的可靠性問(wèn)題也推動(dòng)了嚴(yán)格的測(cè)試。
NI公司的Heidemann表示:“在測(cè)試、鑒定和EoL方面,我們需要進(jìn)行更全面的測(cè)試,深入研究設(shè)備特性。例如,對(duì)于寬帶隙器件來(lái)說(shuō),柵極漂移是一種特有的現(xiàn)象,在不同的市場(chǎng)參與者之間存在顯著的差異。有些器件在汽車(chē)使用壽命內(nèi)會(huì)出現(xiàn)明顯的漂移,而其他器件則表現(xiàn)出較小的漂移。“他還指出:“有趣的是,即使是同一供應(yīng)商的不同器件,行為也可能不同。因此,需要進(jìn)行更全面的測(cè)試,包括EoL和資格認(rèn)證,相比硅材料更具挑戰(zhàn)性。”
目前,晶圓測(cè)試設(shè)備無(wú)法進(jìn)行動(dòng)態(tài)測(cè)試,因?yàn)榫A吸盤(pán)具有很高的雜散電感。工程師們只在晶圓分類(lèi)時(shí)使用靜態(tài)測(cè)試。即使如此,由于施加了高電壓,仍存在火花放電的風(fēng)險(xiǎn),可能損壞良品設(shè)備。
“由于這是一項(xiàng)物理上的挑戰(zhàn),多年來(lái)一直以相同的方式解決,即通過(guò)管理氣隙,當(dāng)然還有管理氣體,”Teradyne的功率分立產(chǎn)品經(jīng)理Tom Tran表示,“隨著電壓開(kāi)始攀升至400V甚至更高,通常我們會(huì)看到一種轉(zhuǎn)變,不再僅僅使用物理間距,而是通過(guò)向連接晶圓的壓力室添加壓縮干燥空氣(CDA)。”
當(dāng)前晶圓測(cè)試的局限性促使了裸片測(cè)試的發(fā)展。
Advantest的Marino表示:“功率模塊是我們可以進(jìn)行靜態(tài)和動(dòng)態(tài)測(cè)試的最堅(jiān)固的封裝部件。”他說(shuō):“但缺點(diǎn)是這些封裝包含多個(gè)開(kāi)關(guān),即6到48個(gè)。如果其中一個(gè)開(kāi)關(guān)損壞,整個(gè)封裝就作廢了,這是非常昂貴的。這就是為什么客戶(hù)轉(zhuǎn)向?qū)σr底進(jìn)行中間測(cè)試,例如在最終組裝之前。這樣成本會(huì)稍微降低,但仍然有6到48個(gè)器件。突破性的創(chuàng)新是對(duì)裸片進(jìn)行測(cè)試。這樣可以篩選出每個(gè)開(kāi)關(guān)(靜態(tài)和動(dòng)態(tài)測(cè)試)。通過(guò)只組裝好的裸片,客戶(hù)就可以在組裝成本方面獲益。”
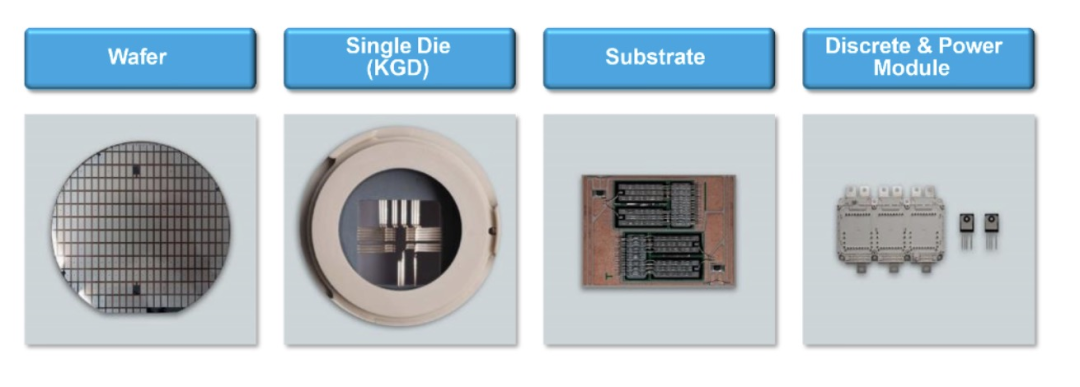
測(cè)試插入點(diǎn)涵蓋晶圓、芯片、封裝和功率模塊。來(lái)源:Advantest
裸片測(cè)試存在一個(gè)風(fēng)險(xiǎn),即如果一個(gè)失效的裸片承載了高電流,可能會(huì)損壞探針卡和/或自動(dòng)測(cè)試設(shè)備(ATE)。但工程師們已經(jīng)找到了解決這個(gè)問(wèn)題的方法。
“在轉(zhuǎn)向裸片測(cè)試時(shí),CREA(現(xiàn)在是Advantest的一部分)專(zhuān)門(mén)開(kāi)發(fā)了一項(xiàng)具有專(zhuān)利技術(shù)——探針卡接口(PCI)”,Marino說(shuō)道。“這是一種硬件和軟件算法,可以檢測(cè)異常的電流消耗。用于測(cè)試裸片的探針卡每個(gè)裸片擁有3000根探針,因?yàn)槊扛结樦荒茯?qū)動(dòng)1安培電流。在測(cè)試儀器和探針卡之間是PCI,一個(gè)硬件盒子。PCI監(jiān)測(cè)探針卡中每根探針或者探針組的電流流動(dòng)情況。如果出現(xiàn)異常的電流分布或者電流消耗(由于零件故障引起),PCI會(huì)立即切斷電源。零件會(huì)出現(xiàn)故障,但卡盤(pán)、探針卡和測(cè)試儀器都得到了保護(hù)。”
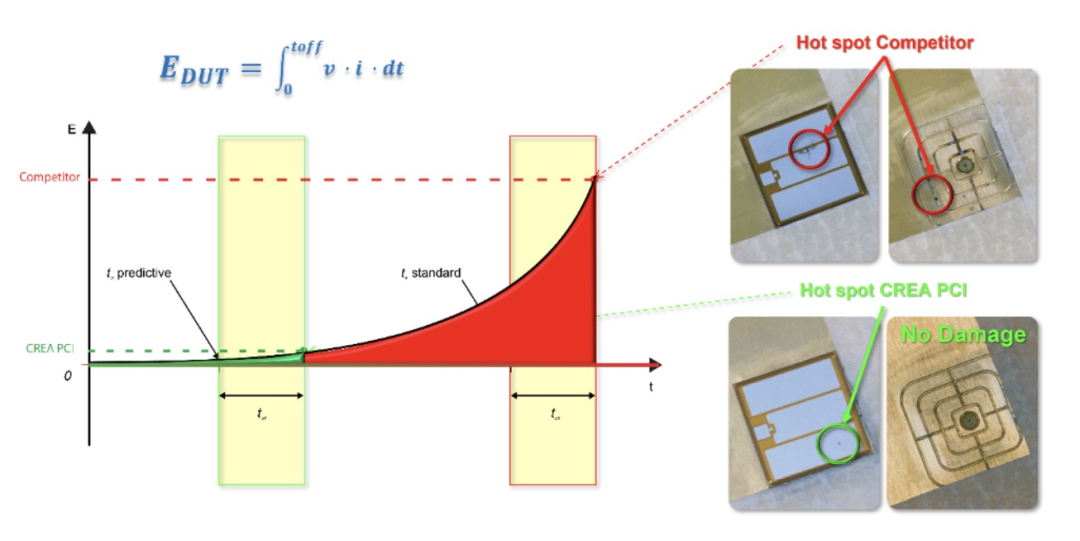
具有和不具有探針卡接口系統(tǒng)的測(cè)試系統(tǒng)之間的比較。來(lái)源:Advantest
一旦裸片被組裝到封裝中,測(cè)試可以篩選出與封裝相關(guān)的缺陷以及在動(dòng)態(tài)測(cè)試中出現(xiàn)的缺陷。
Teradyne的Tran表示:“除了局部放電測(cè)試外,一般通過(guò)從晶圓到封裝級(jí)別的行為變化來(lái)測(cè)試與封裝相關(guān)的缺陷機(jī)制。雖然局部放電更側(cè)重于封裝和材料方面,但電氣測(cè)試可以揭示封裝過(guò)程中的物理故障,例如由于引線(xiàn)鍵合損壞連續(xù)出現(xiàn)錯(cuò)誤,或分割過(guò)程的損壞。篩選還可以在從晶圓分類(lèi)到最終封裝測(cè)試的均值漂移和分布檢查中進(jìn)行。”
可靠性相關(guān)的缺陷檢測(cè)非常重要,現(xiàn)有的標(biāo)準(zhǔn)指導(dǎo)著零件資格認(rèn)證和生產(chǎn)制造的測(cè)試。
NI的Heidemann表示:“我們?cè)谏a(chǎn)線(xiàn)終端和資格認(rèn)證方面采用了各種測(cè)試方法。就資格認(rèn)證而言,像JEDEC和ECPE的AQG324等行業(yè)標(biāo)準(zhǔn)專(zhuān)門(mén)為碳化硅定義了動(dòng)態(tài)測(cè)試場(chǎng)景,以適應(yīng)引入具有不同故障模型的新材料。因此,資格認(rèn)證需要進(jìn)行大量的動(dòng)態(tài)測(cè)試,包括動(dòng)態(tài)H3TRB、DGS和DRB等,這些測(cè)試與IGB相比相對(duì)較新。同樣,在終端環(huán)境中,會(huì)觀察到各種各樣的動(dòng)態(tài)測(cè)試場(chǎng)景,因客戶(hù)而異。然而,可以說(shuō)終端線(xiàn)測(cè)試廣泛涉及在高溫和高電壓環(huán)境下進(jìn)行的動(dòng)態(tài)測(cè)試。其目標(biāo)是確保這些器件在整個(gè)生產(chǎn)系列中經(jīng)過(guò)動(dòng)態(tài)測(cè)試,防止出現(xiàn)故障效應(yīng)。”
未來(lái)發(fā)展
為了滿(mǎn)足對(duì)碳化硅器件的需求,晶圓廠正從8英寸轉(zhuǎn)向12英寸晶圓。為了支持產(chǎn)能增加的行業(yè)測(cè)試和檢驗(yàn)流程,專(zhuān)家們列舉了一些可以提供幫助的創(chuàng)新技術(shù)。這些創(chuàng)新技術(shù)包括對(duì)測(cè)試系統(tǒng)進(jìn)行改進(jìn),利用分析方法更好地理解在檢測(cè)過(guò)程中觀察到的缺陷的電學(xué)影響。
測(cè)試系統(tǒng)的創(chuàng)新可以使篩選能力在制造流程中提前,并增加吞吐量。其中一項(xiàng)創(chuàng)新技術(shù)是使用晶圓卡盤(pán),在晶圓上進(jìn)行動(dòng)態(tài)測(cè)試。這需要將晶圓卡盤(pán)的雜散電感從600微亨降低到100納亨以下。
目前,封裝測(cè)試僅支持單點(diǎn)測(cè)試。測(cè)試單元使用一個(gè)大型處理器,在多個(gè)測(cè)試儀之間移動(dòng)零部件,每個(gè)測(cè)試儀以特定的溫度運(yùn)行動(dòng)態(tài)或靜態(tài)測(cè)試。轉(zhuǎn)向多點(diǎn)測(cè)試可以降低總體成本。然而,同時(shí)進(jìn)行高能量測(cè)試面臨巨大的工程挑戰(zhàn)。這需要ATE設(shè)計(jì)的創(chuàng)新。
一個(gè)意想不到的差距是處理器的可用性,特別是對(duì)于裸片。
“最大的挑戰(zhàn)來(lái)自處理器方面。市場(chǎng)上缺乏足夠的處理器供應(yīng)商或處理器設(shè)備,”Marino表示,“處理器公司宣布一年以上的交付時(shí)間,而我們的交付時(shí)間只有四個(gè)月。因此,市場(chǎng)窗口面臨風(fēng)險(xiǎn)。這就是為什么我們要求探針測(cè)試設(shè)備供應(yīng)商進(jìn)入市場(chǎng)。探針設(shè)備公司擁有與我們相同的核心業(yè)務(wù)——半導(dǎo)體。但自動(dòng)化設(shè)備公司需要支持多種行業(yè),從手表裝配到半導(dǎo)體。”
以一致的方式連接來(lái)自各個(gè)制造步驟的數(shù)據(jù)還可以?xún)?yōu)化制造過(guò)程,并了解缺陷的影響。
“針對(duì)完整測(cè)試列表的特定部分進(jìn)行測(cè)試,數(shù)據(jù)完整性非常重要,”Amkor的Harris表示,“最近一直在推動(dòng)將收集到的數(shù)據(jù)遷移到企業(yè)內(nèi)部云平臺(tái),在那里數(shù)據(jù)分析算法可以不斷測(cè)試工作流程、測(cè)試設(shè)備以及封裝和制造相關(guān)的系統(tǒng)性故障機(jī)制。工廠自動(dòng)化可以實(shí)現(xiàn)閉環(huán)控制,并提高產(chǎn)量。光學(xué)和電子技術(shù)都用于單元級(jí)可追溯性。”
這種數(shù)據(jù)連接將使碳化硅制造能夠加速產(chǎn)量學(xué)習(xí)并降低總體測(cè)試成本。
“總的來(lái)說(shuō),化合物半導(dǎo)體技術(shù),無(wú)論是碳化硅、氮化鎵、砷化鎵、磷化銦,還是其他,都是幾年前的芯片技術(shù)。要實(shí)現(xiàn)低成本、無(wú)缺陷8英寸襯底可能需要多年的努力和投資。在可預(yù)見(jiàn)的未來(lái),襯底和外延片的質(zhì)量仍將是關(guān)注的問(wèn)題,”P(pán)DF Solutions的產(chǎn)品管理總監(jiān)Steve Zamek表示,“發(fā)現(xiàn)和識(shí)別襯底缺陷只是第一步。接下來(lái)是將所有數(shù)據(jù)類(lèi)型(缺陷檢查和審查、在線(xiàn)計(jì)量和電測(cè)試數(shù)據(jù))匯集到一個(gè)平臺(tái)上。這是一個(gè)不小的問(wèn)題,因?yàn)檫@些數(shù)據(jù)是在地理分散的工廠和設(shè)備中獲取的。但一旦完成,制造商就能夠構(gòu)建預(yù)測(cè)性分析模型,以最大限度地提高效率。那些能夠盡早實(shí)現(xiàn)這一目標(biāo)的企業(yè)將獲得好處。”
其他人也認(rèn)為實(shí)現(xiàn)可追溯性并非易事。在功率集成電路中,沒(méi)有電子標(biāo)識(shí),所以追溯性是組裝和測(cè)試過(guò)程中的一個(gè)挑戰(zhàn)。
“在具有設(shè)備標(biāo)識(shí)的后端器件中,可以進(jìn)行追蹤,”DR Yield的首席執(zhí)行官Dieter Rathei指出,“但在從晶圓分離后,很多設(shè)備就失去了設(shè)備級(jí)別的可追溯性。然后你會(huì)看到設(shè)備在批次中混在一起的情況。除非你知道哪個(gè)晶圓被放入了哪個(gè)批次,否則無(wú)法在晶圓和封裝之間進(jìn)行數(shù)據(jù)相關(guān)性分析。”
結(jié)論
電動(dòng)汽車(chē)生產(chǎn)的預(yù)期增長(zhǎng)對(duì)負(fù)責(zé)碳化硅集成電路生產(chǎn)的工程團(tuán)隊(duì)帶來(lái)了挑戰(zhàn)。市場(chǎng)需求推動(dòng)著從8英寸晶圓生產(chǎn)轉(zhuǎn)向12英寸晶圓生產(chǎn),也給當(dāng)前的檢查和測(cè)試流程造成壓力。許多人指出,碳化硅技術(shù)的成熟度與三十年前的硅技術(shù)相當(dāng)。隨著技術(shù)的成熟以滿(mǎn)足需求,工程團(tuán)隊(duì)將需要通過(guò)改進(jìn)的測(cè)試系統(tǒng)以及減少測(cè)試和檢查流程的吞吐量時(shí)間來(lái)解決缺陷問(wèn)題。
-
電動(dòng)汽車(chē)
+關(guān)注
關(guān)注
156文章
12417瀏覽量
234525 -
功率半導(dǎo)體
+關(guān)注
關(guān)注
23文章
1307瀏覽量
44076 -
碳化硅
+關(guān)注
關(guān)注
25文章
3060瀏覽量
50388
原文標(biāo)題:碳化硅從8英寸到12英寸,還有多少障礙需要克服?
文章出處:【微信號(hào):芯長(zhǎng)征科技,微信公眾號(hào):芯長(zhǎng)征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
全球最大碳化硅工廠頭銜易主?又有新8英寸碳化硅產(chǎn)線(xiàn)投產(chǎn)!
全球產(chǎn)業(yè)重構(gòu):從Wolfspeed破產(chǎn)到中國(guó)SiC碳化硅功率半導(dǎo)體崛起
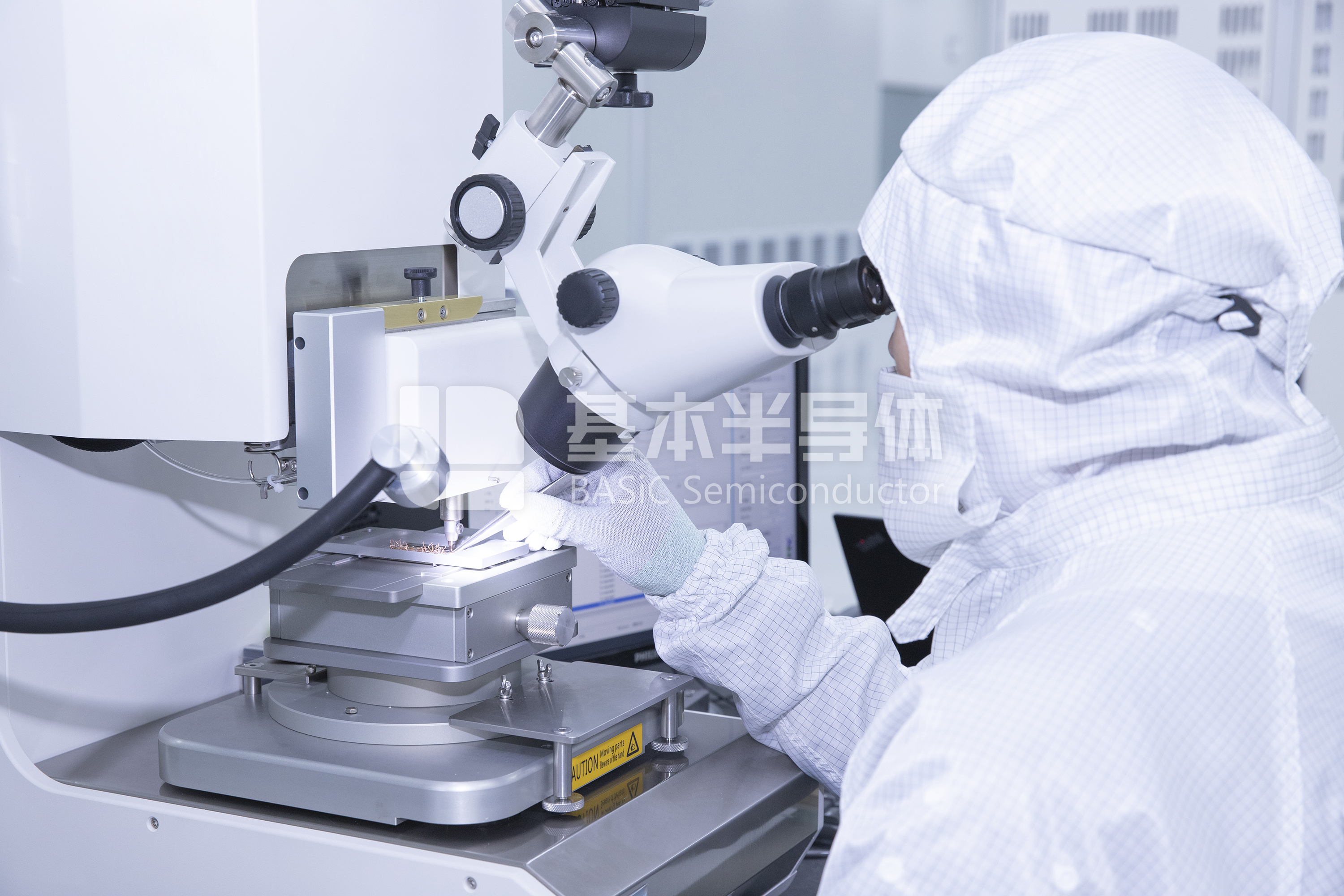
12英寸SiC,再添新玩家
12英寸碳化硅襯底,又有新進(jìn)展
士蘭微電子8英寸碳化硅項(xiàng)目封頂
三安光電與意法半導(dǎo)體重慶8英寸碳化硅項(xiàng)目通線(xiàn)
晶盛機(jī)電:6-8 英寸碳化硅襯底實(shí)現(xiàn)批量出貨
環(huán)球晶宣布:6英寸碳化硅襯底價(jià)格趨于穩(wěn)定
晶馳機(jī)電8英寸碳化硅電阻式長(zhǎng)晶爐順利通過(guò)客戶(hù)驗(yàn)證

8英寸單片高溫碳化硅外延生長(zhǎng)室結(jié)構(gòu)

碳化硅襯底,進(jìn)化到12英寸!

ASM推出全新PE2O8碳化硅外延機(jī)臺(tái)

ASM推出全新PE2O8碳化硅外延機(jī)臺(tái)

功率氮化鎵進(jìn)入12英寸時(shí)代!

萬(wàn)年芯:三代半企業(yè)提速,碳化硅跑步進(jìn)入8英寸時(shí)代






 碳化硅從8英寸到12英寸,還有多少障礙需要克服?
碳化硅從8英寸到12英寸,還有多少障礙需要克服?











評(píng)論