WLCSP(Wafer Level Chip Scale Packaging)即晶圓級芯片封裝方式,不同于傳統的芯片封裝方式(先切割再封測,而封裝后至少增加原芯片20%的體積),此種最新技術是先在整片晶圓上進行封裝和測試,然后才切割成一個個的IC顆粒,因此封裝后的體積即等同IC裸晶的原尺寸。
WLCSP的封裝方式,不僅明顯地縮小內存模塊尺寸,而符合行動裝置對于機體空間的高密度需求;另一方面在效能的表現上,更提升了數據傳輸的速度與穩定性。
WLP是晶圓級封裝(Wafer Level Packaging)的簡稱,是伴隨著智能手機等移動設備的高功能化、薄型化而備受期待的封裝技術之一。ULVAC為WLP制造工藝提供濺射、刻蝕、去膠等技術。

WLCSP的特性優點
芯片尺寸最小封裝方式
WLCSP晶圓級芯片封裝方式的最大特點便是有效地縮減封裝體積,故可搭配于運動裝置上而符合可攜式產品輕薄短小的特性需求。
數據傳輸路徑短、穩定性高
采用WLCSP封裝時,由于電路布線的線路短且厚(標示A至B的黃線),故可有效增加數據傳輸的頻寛減少電流耗損,也提升數據傳輸的穩定性。
散熱特性佳
由于WLCSP少了傳統密封的塑料或陶瓷包裝,故IC芯片運算時的熱能便能有效地發散,而不致增加主機體的溫度,而此特點對于行動裝置的散熱問題助益極大。
WLCSP分類
BOP和RDL
WLCSP可以被分成兩種結構類型:
?直接BOP(bump On pad)?重新布線(RDL)
直接BOP(Bump On Pad):這是一種在芯片上的凸點(bump)直接形成在焊盤(pad)上的技術。凸點的材料可以是銅、金、錫等,用于連接芯片與外部電路。這種技術減少了中間的布線層,從而減少了封裝體積,提高了封裝效率。
重新布線(RDL):這是一種用于將芯片的I/O接口重新分布到更合理的位置的技術。在芯片制造過程中,由于制造工藝的限制,有時芯片的I/O接口不能直接按照需求放置在合適的位置。此時,可以通過在芯片上增加一層重新布線層(Redistribution Layer, RDL),將I/O接口重新分布到更合理的位置,以滿足封裝和電路設計的需求。重新布線層可以由多個薄金屬層組成,每個金屬層上都有不同的電路圖形。通過在金屬層之間進行連接,可以將I/O接口重新分布到新的位置。這種技術可以提高封裝的靈活性和效率,同時也可以減少封裝體積和成本。
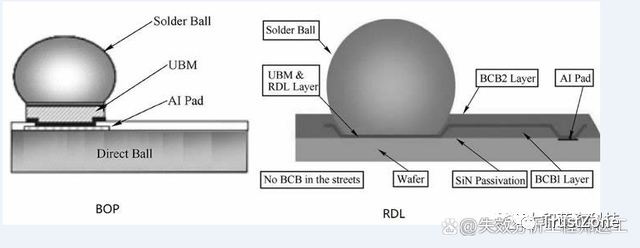
BOP即錫球直接長在die的Al pad上,而有的時候,如果出現引出錫球的pad靠的較近,不方便出球,則用重新布線(RDL)將solder ball引到旁邊。
Fan-In和Fan-out
最早的WLCSP是Fan-In,bump全部長在die上,而die和pad的連接主要就是靠RDL的metal line,封裝后的IC幾乎和die面積接近。
在WLCSP中,Fan-In是指扇入式封裝。這是指將芯片封裝在晶圓的內部分,引腳從芯片的四周引出,就像一個扇子一樣“扇入”到芯片的內部。這種封裝方式的特點是引腳數量較多,可以達到數千個引腳,適用于高集成度的芯片封裝。
相比傳統的封裝方式,Fan-In扇入式封裝具有更小的封裝體積、更低的成本、更好的散熱性能等優勢。同時,由于引腳從芯片的四周引出,Fan-In封裝方式也被稱為芯片級封裝(Chip-Scale Package, CSP)。
Fan-out,bump可以長到die外面,封裝后IC也較die面積大(1.2倍)。
Fan-out是指扇出式封裝,它與Fan-in相反,是將芯片封裝在晶圓的外部分,引腳從芯片的四周引出,就像一個扇子一樣“扇出”到晶圓的外部。
相比Fan-in,Fan-out扇出式封裝的特點是引腳數量較少,通常只有幾百個引腳,但可以實現更靈活的電路設計和更高的封裝密度。此外,Fan-out封裝方式還可以將多個芯片同時封裝在一個封裝體內,實現更高的集成度和更小的封裝體積。
Fan-in: 如下流程為Fan-in的RDL制作過程。
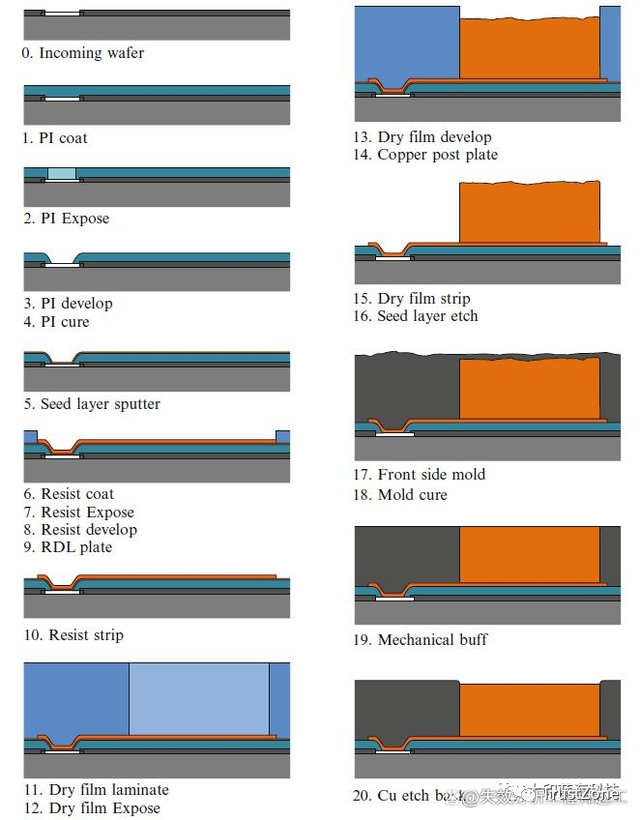
Fan-Out: 先將die從晶圓上切割下來,倒置粘在載板上(Carrier)。此時載板和die粘合起來形成了一個新的wafer,叫做重組晶圓(Reconstituted Wafer)。
在重組晶圓中,再曝光長RDL。

Fan-in和Fan-out 對比如下,從流程上看,Fan-out除了重組晶圓外,其他步驟與Fan-in RDL基本一致。
Fan-in RDL是一種扇入式重新布線技術,它是在晶圓的表面上應用重新布線層(RDL)技術,將芯片的I/O接口重新分布到晶圓的內部,以實現更小的封裝體積和更高的封裝效率。
具體來說,Fan-in RDL通過在晶圓的表面覆蓋一層或多層重新布線層,將芯片的I/O接口與外部電路連接起來。由于重新布線層位于晶圓的內部,因此可以減少封裝體積,提高封裝效率。同時,由于重新布線層可以根據需要進行設計和布局,因此可以實現更靈活的電路設計和更高的集成度。

擴展閱讀
WLP晶圓級封裝VS傳統封裝
在傳統晶圓封裝中,是將成品晶圓切割成單個芯片,然后再進行黏合封裝。不同于傳統封裝工藝,晶圓級封裝是在芯片還在晶圓上的時候就對芯片進行封裝,保護層可以黏接在晶圓的頂部或底部,然后連接電路,再將晶圓切成單個芯片。

相比于傳統封裝,晶圓級封裝具有以下優點:
1、封裝尺寸小
由于沒有引線、鍵合和塑膠工藝,封裝無需向芯片外擴展,使得WLP的封裝尺寸幾乎等于芯片尺寸。
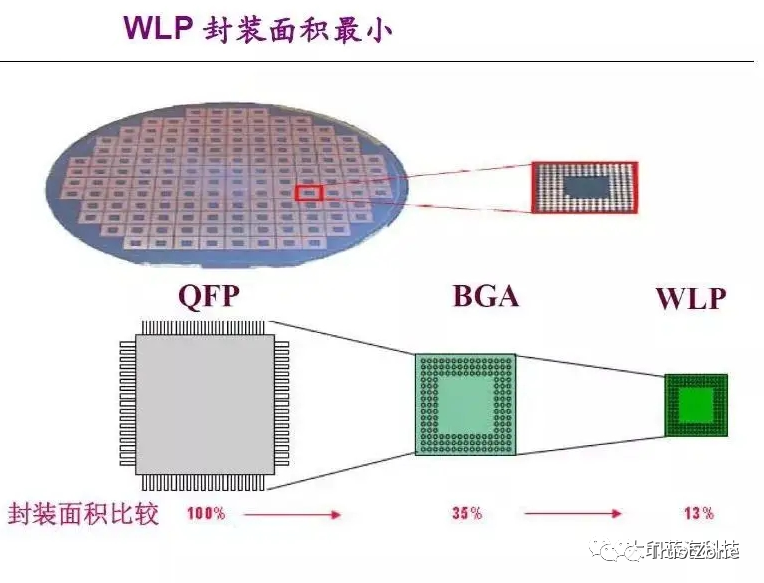
2、高傳輸速度
與傳統金屬引線產品相比,WLP一般有較短的連接線路,在高效能要求如高頻下,會有較好的表現。
3、高密度連接
WLP可運用數組式連接,芯片和電路板之間連接不限制于芯片四周,提高單位面積的連接密度。
4、生產周期短
WLP從芯片制造到、封裝到成品的整個過程中,中間環節大大減少,生產效率高,周期縮短很多。
5、工藝成本低
WLP是在硅片層面上完成封裝測試的,以批量化的生產方式達到成本最小化的目標。WLP的成本取決于每個硅片上合格芯片的數量,芯片設計尺寸減小和硅片尺寸增大的發展趨勢使得單個器件封裝的成本相應地減少。WLP可充分利用晶圓制造設備,生產設施費用低。
晶圓級封裝的工藝流程
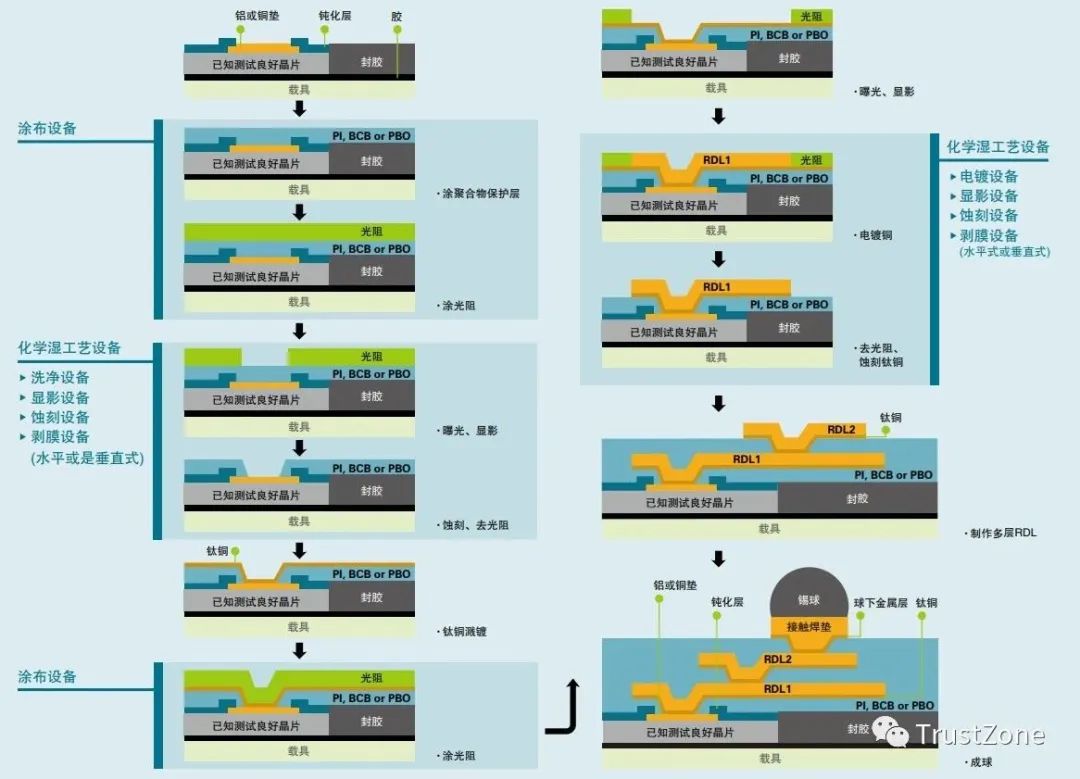
晶圓級封裝工藝流程如圖所示:
?1、涂覆第一層聚合物薄膜,以加強芯片的鈍化層,起到應力緩沖的作用。聚合物種類有光敏聚酰亞胺(PI)、苯并環丁烯(BCB)、聚苯并惡唑(PBO)。
?2、重布線層(RDL)是對芯片的鋁/銅焊區位置重新布局,使新焊區滿足對焊料球最小間距的要求,并使新焊區按照陣列排布。光刻膠作為選擇性電鍍的模板以規劃RDL的線路圖形,最后濕法蝕刻去除光刻膠和濺射層。
?3、涂覆第二層聚合物薄膜,是圓片表面平坦化并保護RDL層。在第二層聚合物薄膜光刻出新焊區位置。
?4、凸點下金屬層(UBM)采用和RDL一樣的工藝流程制作。
?5、植球。焊膏和焊料球通過掩膜板進行準確定位,將焊料球放置于UBM上,放入回流爐中,焊料經回流融化與UBM形成良好的浸潤結合,達到良好的焊接效果。
晶圓級封裝的發展趨勢
隨著電子產品不斷升級換代,智能手機、5G、AI等新興市場對封裝技術提出了更高要求,使得封裝技術朝著高度集成、三維、超細節距互連等方向發展。
晶圓級封裝技術可以減小芯片尺寸、布線長度、焊球間距等,因此可以提高集成電路的集成度、處理器的速度等,降低功耗,提高可靠性,順應了電子產品日益輕薄短小、低成本的發展要需求。
晶圓級封裝技術要不斷降低成本,提高可靠性水平,擴大在大型IC方面的應用:
?1、通過減少WLP的層數降低工藝成本,縮短工藝時間,主要是針對I/O少、芯片尺寸小的產品。
?2、通過新材料應用提高WLP的性能和可靠度。主要針對I/O多、芯片尺寸大的產品。
審核編輯:湯梓紅
-
芯片封裝
+關注
關注
11文章
577瀏覽量
31420 -
wlcsp
+關注
關注
1文章
24瀏覽量
18558 -
晶圓級封裝
+關注
關注
5文章
41瀏覽量
11658
原文標題:擴展閱讀
文章出處:【微信號:半導體封裝工程師之家,微信公眾號:半導體封裝工程師之家】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 WLCSP的特性優點和分類 晶圓級封裝的工藝流程和發展趨勢
WLCSP的特性優點和分類 晶圓級封裝的工藝流程和發展趨勢




















評論