近年來,電力電子應用中硅向碳化硅(SiC)和氮化鎵(GaN)的轉變越來越明顯。在過去的十年中,SiC和GaN半導體成為了推動電氣化和強大未來的重要力量。得益于其固有特性,寬禁帶半導體正在逐漸取代許多電力應用中的傳統硅基設備。硅的時代已經過去,其應用的可靠性一直很高。如今,有必要驗證這兩種新型半導體在長期使用中是否能夠提供相同的安全前景,以及它們在未來是否會成為設計師可信賴的選擇。
如今,應用的需求日益增長,要求能夠管理更高電壓、頻率和溫度的能源和電力,同時保持效率和可靠性。新材料碳化硅(SiC)和氮化鎵(GaN)作為寬帶隙半導體,展現出廣闊的前景,并在電力電子應用中相較于傳統硅材料提供了顯著的優勢。然而,盡管目前新材料的應用越來越廣泛,其長期可靠性仍然是大規模采用的持續研究主題。隨著這項技術逐漸成熟,關于其長期可靠性的疑慮也自然隨之而來。
寬帶隙半導體在極端電力應用中的使用必須伴隨對設備可靠性的仔細評估和分析。毫無疑問,新的SiC和GaN設備相比于硅具有更優越的特性,包括更高的Vds電壓、更低的Rds(ON)電阻以及更高的開關速度。這些特性使得可以構建具有更高功率密度、降低損耗和更好整體效率的系統和電路。然而,SiC和GaN獨特的屬性也帶來了新的可靠性挑戰。
設計師和企業必須更加關注的一個主要參數是設備的長期穩定性,尤其是在高電壓和高溫操作條件下。高電場和熱應力可能導致柵氧化層的降解、通道遷移率的降低以及與封裝本身相關的故障。這種情況尤其發生在MOS設備的柵極受到熱和電的壓力時。此外,材料中新缺陷的形成也可能對這些設備的可靠性產生負面影響。
然而,與研究并行,針對進一步提升SiC和GaN設備可靠性的研究也在進行中,通過改善材料質量、設備設計和封裝技術,以增強它們的韌性和使用壽命。企業和制造商在實驗室和實際操作環境中執行加速老化程序和極端條件下的測試,以評估長期性能并識別潛在的故障模式。加速測試可以在確定加速應力壽命后,用于預測在正常最終使用條件下產品的使用壽命。這些評估在電力設備的測試中起著至關重要的作用,使操作員能夠評估和分類滿足溫度和電氣應力要求的產品。
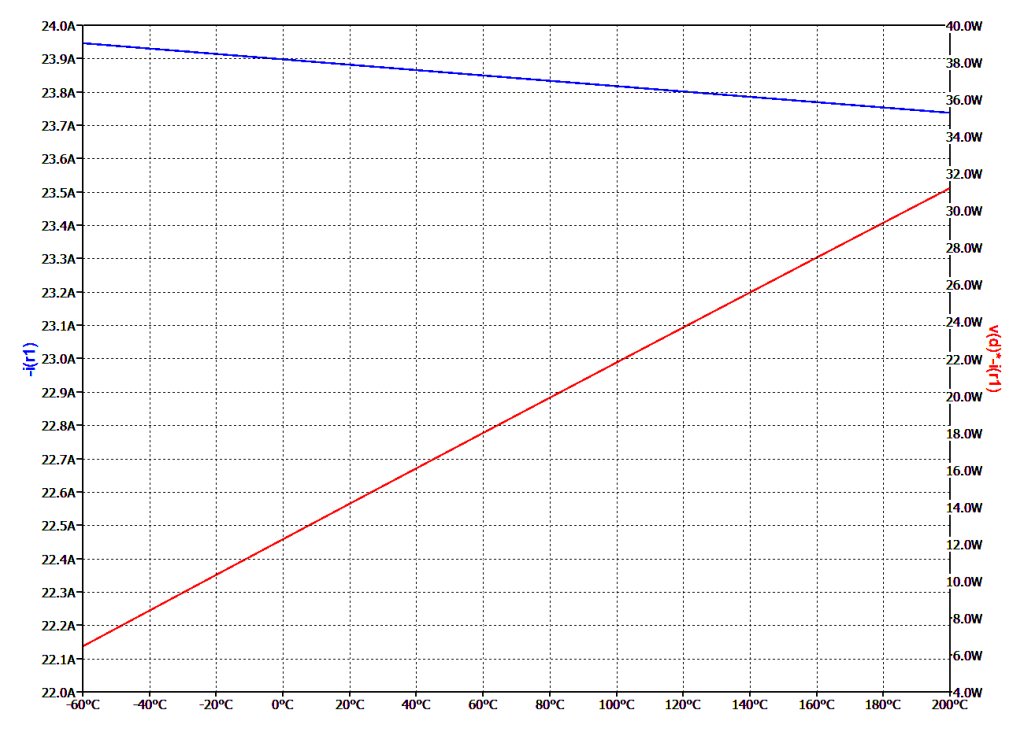
圖1
測試主要關注設備的工作溫度極限和在DS通道中多次重復施加的強電流的監督。這些測試實施連續和交替的電氣和熱測試,并能生成詳細的最終報告。我們知道,電子元件的最大敵人就是高溫。圖1顯示了SiC MOSFET的電流和功率的典型趨勢,工作溫度在-60°C到+200°C之間變化(在給定負載和供電電壓的電路仿真中)。雖然電流幾乎保持不變并在溫度升高時略有下降,但功率耗散在整個范圍內卻出現了劇烈的增加(甚至超過5倍)。這意味著在長期內會出現各種問題,縮短設備的使用壽命。
SiC和GaN組件的可靠性
SiC和GaN屬于一種新型現代技術,盡管它們在許多電力應用中已經被廣泛使用,但仍然未完全成熟。隨著它們的使用呈指數級增長,材料可靠性的概念正受到越來越多的關注,尤其是在安全領域,涉及的行業眾多,汽車行業首當其沖。SiC設備的主要問題之一與柵氧化層相關,該層不斷變薄,可能導致降解(見圖2)。
這種缺陷可能直接導致設備的嚴重故障。在SiC MOSFET設備開始商業化時,它們的可靠性水平遠低于硅的同類產品,但這一差距正在逐漸縮小。總體而言,涉及的故障過程略有不同,因為SiC是垂直PN結設備,而GaN是橫向HEMT設備。在電力和高電壓應用中,MOSFET的穩健性極為重要。
MOSFET或二極管在用于任何最終解決方案之前,必須經過多種測試。半導體產品可靠性測試的目的是確保設備的長壽命。許多應用要求中或長時間的使用壽命和低故障率。一些測試可能需要相當長的時間來完成,而通常這種要求并不完全可行。因此,許多測試通常會對組件進行壓力測試,通過故意加速一些參數(如電壓、電流、溫度和濕度)來縮短時間。
SiC MOSFET的可靠性主要受到熱應力的影響,而熱應力又依賴于操作條件。由于這些溫度變化,模塊內部的材料會發生降解。典型的熱故障發生在具有不同熱膨脹系數的材料之間,尤其是在絕緣基板和基板之間的接觸點。制造商在設備的開發過程和生命周期早期階段進行電子元件的可靠性研究和評估。只有這樣,才能確保基于SiC和GaN的組件安全可靠地運行。
設備應力測試涉及在類似真實世界的操作條件下并聯測試數千個設備。這些測試持續超過四個月,使操作員能夠獲得足夠的故障數據,以便描繪出相對可靠的統計數據。一些方法可以通過柵電壓應力測試估算MOS設備的柵氧化層穩定性。對于一組樣本,按照制造商規定的最大結溫進行操作測試。在測試期間,柵電壓從制造商推薦的電壓逐漸增加。在每個時間間隔結束后,計算失敗設備的數量并將其從測試電路中剔除。測試持續到所有設備失效,此時可以使用特定的數學模型可視化故障分布。
許多制造商為SiC-MOSFETs制造極高可靠性的柵氧化層薄膜,可靠性與Si-MOSFETs相當,而后者現在是一個極其成熟的領域,其結果與前者相當。許多測試是在操作條件極限下進行的,確認了數千小時的無故障操作。某些故障涉及體二極管導通的降解,這會導致電流路徑發生變化,并引起Rds(ON)和二極管Vf參數的增加。與硅MOSFET相比,SiC-MOSFET的芯片面積更小、電流強度更高。因此,它們的短路承受能力也較低。
 圖2
圖2平均而言,這些設備的短路耐受時間在幾十微秒的量級。這一時限還取決于電壓Vgs和Vdd。在高海拔和太空應用中,宇宙射線可能會引發擔憂。相關的輻射測試表明,大多數模型非常耐用。此外,考慮到SiC芯片的體積小于硅,因靜電放電(ESD)導致的故障概率較高。因此,有必要采取適當的靜電防護措施,通過離子發生器和接地手環消除人體和工作環境中的靜電。
結論
汽車行業以其嚴格的可靠性要求推動了SiC和GaN設備的創新。由于其在效率、尺寸和重量方面的優勢,這些半導體在電動車輛中的應用迅速增長,但其長期可靠性的證明是確保車輛安全和耐用性的關鍵因素。像汽車這樣的高要求市場對可靠性標準提出了非常高的要求,故障率達到十億分之一(PPB)級別。盡管得益于技術進步,SiC和GaN設備的可靠性不再受到質疑,但這仍然是一個活躍且不斷發展的研究領域。
確保這些設備滿足真實應用的嚴格可靠性要求的努力正在為電力電子技術的革命鋪平道路。隨著持續的發展和廣泛的采用,SiC和GaN有望塑造一個更加電氣化和可持續的未來,鞏固其作為能源轉型關鍵技術的地位。
浮思特科技深耕功率器件領域,為客戶提供IGBT、IPM模塊等功率器件以及單片機(MCU)、觸摸芯片,是一家擁有核心技術的電子元器件供應商和解決方案商。
-
半導體
+關注
關注
335文章
28776瀏覽量
235315 -
SiC
+關注
關注
31文章
3200瀏覽量
64772 -
GaN
+關注
關注
19文章
2190瀏覽量
76480
發布評論請先 登錄
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
從IGBT模塊大規模失效爆雷看國產SiC模塊可靠性實驗的重要性
40mR/650V SiC 碳化硅MOSFET,替代30mR 超結MOSFET或者20-30mR的GaN!
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
SiC半導體產品如何實現高質量和高可靠性

瞻芯電子參與編制SiC MOSFET可靠性和動態開關測試標準

半導體封裝的可靠性測試及標準

第三代功率半導體器件動態可靠性測試系統
瞻芯電子交付碳化硅(SiC)MOSFET逾千萬顆 產品長期可靠性得到驗證

威兆半導體發布新一代高性能SiC MOSFET
發力新能源汽車和儲能市場,威兆半導體推出新一代700V SiC MOSFET
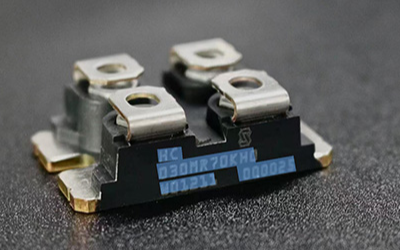





 SiC和GaN:新一代半導體能否實現長期可靠性?
SiC和GaN:新一代半導體能否實現長期可靠性?















評論