透射電子顯微鏡(TEM)樣品制備是現(xiàn)代材料科學(xué)研究的重要環(huán)節(jié)。在這一過程中,金鑒實(shí)驗(yàn)室憑借其先進(jìn)的設(shè)備和專業(yè)的技術(shù)團(tuán)隊(duì),能夠?yàn)榭蛻籼峁└哔|(zhì)量的FIB測(cè)試服務(wù),確保樣品制備的精確性和可靠性。
透射電子顯微鏡(TEM)樣品制備
1. 粉末樣品:適用于粉末形態(tài)的觀察、粒度分析以及結(jié)構(gòu)和成分的分析。
2. 薄膜樣品:適用于研究樣品的內(nèi)部組織結(jié)構(gòu)、成分、位錯(cuò)排列及其密度,以及晶體相的取向關(guān)系。
3. 表面復(fù)制型與萃取復(fù)制型樣品:適用于金相組織的觀察、斷口形貌分析、變形條紋觀察、第二相的形態(tài)和分布研究。金鑒實(shí)驗(yàn)室的FIB制樣技術(shù)不僅可以實(shí)現(xiàn)高精度的樣品制備,還能夠通過實(shí)時(shí)監(jiān)控加工過程,確保樣品的表面特性得到最大程度的保留。

TEM工作機(jī)制詳述
透射電子顯微鏡的工作原理是利用電子束穿透超薄樣品,樣品原子與電子相互作用后產(chǎn)生散射,形成具有不同散射角的圖像。這些散射角與樣品的密度和厚度相關(guān),從而在圖像中形成明暗對(duì)比。
TEM的分辨率可達(dá)到0.1至0.2納米,放大倍數(shù)從數(shù)萬至百萬倍,專門用于觀察小于0.2微米的微觀結(jié)構(gòu),即“亞顯微結(jié)構(gòu)”。與光學(xué)顯微鏡不同,TEM使用電子束作為光源,采用磁透鏡聚焦,由于電子波長(zhǎng)極短,遵循布拉格散射方程,因此TEM不僅分辨率高,還具備結(jié)構(gòu)分析的能力。金鑒實(shí)驗(yàn)室擁有專業(yè)的技術(shù)團(tuán)隊(duì),能夠?yàn)榭蛻籼峁┰敿?xì)的TEM樣品制備方案,并通過FIB技術(shù)優(yōu)化樣品質(zhì)量,確保最終觀察結(jié)果的可靠性。

FIB制樣技術(shù)及其優(yōu)勢(shì)
聚焦離子束(FIB)制樣技術(shù)通過電透鏡將離子源產(chǎn)生的離子束(主要是鎵離子,也包括氦和氖離子源)加速并聚焦,作用于樣品表面,實(shí)現(xiàn)材料的精確銑削、沉積、注入和成像。金鑒實(shí)驗(yàn)室致力于為客戶提供專業(yè)的FIB測(cè)試服務(wù),幫助研究人員在材料科學(xué)領(lǐng)域取得更大的成就。
FIB制樣面臨的挑戰(zhàn)
盡管FIB技術(shù)在樣品制備方面具有顯著優(yōu)勢(shì),但它也存在一些局限性。使用離子束可能會(huì)對(duì)樣品造成意外損傷,改變樣品表面特性。
例如,在30kV的鎵離子束作用下,大部分材料表面約30納米深度范圍內(nèi)都會(huì)受到鎵注入的影響,導(dǎo)致原有原子結(jié)構(gòu)的改變或破壞。這種非晶層或損傷層在FIB制備的TEM樣品中尤為明顯,可能影響最終的觀察結(jié)果。因此,研究人員在使用FIB制樣時(shí)需特別注意這種潛在損傷,并采取措施以最大程度保留樣品的原始結(jié)構(gòu)和特性。
優(yōu)化FIB制樣策略
1. 氣體輔助蝕刻:雖然提高了研磨速率,但增加了結(jié)晶-非晶界面的粗糙度,可能進(jìn)一步損害TEM圖像。
2. 低能量FIB:在這些能量下,蝕刻速率和位置分辨率會(huì)受到影響,但束能量的減少可以使損傷深度最小化。
3. 氬離子研磨精修:原始的FIB損傷層,可以通過氬離子精修去除,去除的效果取決于氬離子的能量、角度和時(shí)間。通過這些方法,可以在一定程度上減輕FIB制樣過程中可能引起的樣品損傷,提高樣品制備的質(zhì)量。
-
顯微鏡
+關(guān)注
關(guān)注
0文章
616瀏覽量
24054 -
fib
+關(guān)注
關(guān)注
1文章
94瀏覽量
11337 -
TEM
+關(guān)注
關(guān)注
0文章
101瀏覽量
10707
發(fā)布評(píng)論請(qǐng)先 登錄
聚焦離子束(FIB)技術(shù)的應(yīng)用原理
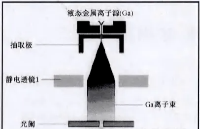
氬離子束研磨拋光助力EBSD樣品的高效制備

雙束聚焦離子束-掃描電鏡(FIB):TEM樣品制備

聚焦離子束FIB在失效分析技術(shù)中的應(yīng)用-剖面制樣
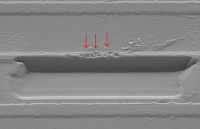
聚焦離子束技術(shù)中液態(tài)鎵作為離子源的優(yōu)勢(shì)

氬離子切拋技術(shù)在簡(jiǎn)化樣品制備流程中的應(yīng)用

聚焦離子束(FIB)在加工硅材料的應(yīng)用

TEM樣本制備:透射電子顯微鏡技術(shù)指南

詳細(xì)解讀——FIB-SEM技術(shù)(聚焦離子束)制備透射電鏡(TEM)樣品

不同材料的 EBSD 樣品制備方法

FIB技術(shù)在透射樣品制備中的應(yīng)用
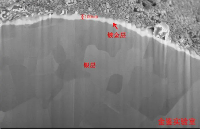
氬離子拋光在電鏡樣品制備中的優(yōu)勢(shì):超越FIB的大面積處理能力

透射電鏡(TEM)樣品制備方法






 FIB在TEM樣品制備中的利與弊
FIB在TEM樣品制備中的利與弊

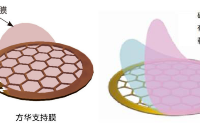










評(píng)論