
BGA(Ball Grid Array)芯片是一種表面貼裝技術(shù),它通過(guò)底部的焊球陣列來(lái)實(shí)現(xiàn)與PCB(Printed Circuit Board)的電氣連接。由于BGA封裝具有高密度、小體積等優(yōu)點(diǎn),在電子設(shè)備中得到了廣泛應(yīng)用,尤其是在高性能計(jì)算和移動(dòng)設(shè)備領(lǐng)域。
BGA芯片在安裝到PCB上后,通常需要進(jìn)行底部填充(Underfill),這是一種用于提高BGA封裝可靠性的工藝。底部填充膠是一種特殊的環(huán)氧樹(shù)脂材料,被用來(lái)填充BGA芯片與PCB之間的空隙。這種填充有幾個(gè)主要目的:
底部填充膠的主要目的
1.增強(qiáng)機(jī)械強(qiáng)度:通過(guò)增加芯片與PCB之間的粘合力,可以有效防止因熱膨脹系數(shù)不匹配導(dǎo)致的應(yīng)力集中問(wèn)題,減少焊接點(diǎn)開(kāi)裂的風(fēng)險(xiǎn)。
2.改善散熱性能:雖然不是所有類型的底部填充膠都具備良好的導(dǎo)熱性,但是一些專門設(shè)計(jì)的材料確實(shí)可以幫助熱量從芯片傳導(dǎo)至PCB或散熱器,從而提高整個(gè)系統(tǒng)的散熱效率。
3.提高耐濕性和抗腐蝕能力:合適的底部填充膠還可以提供額外保護(hù),避免潮氣侵入以及化學(xué)物質(zhì)對(duì)焊點(diǎn)造成損害。
底部填充膠的使用原理
使用時(shí),底部填充膠一般采用毛細(xì)作用原理自動(dòng)流入BGA下方的空間內(nèi),并且會(huì)根據(jù)特定的應(yīng)用需求選擇不同性質(zhì)(如固化時(shí)間、溫度敏感度等)的產(chǎn)品。此外,為了保證最佳效果,施加過(guò)程中的控制參數(shù)(比如流量、壓力等)也需要嚴(yán)格遵守制造商提供的指導(dǎo)說(shuō)明。
底部填充膠未來(lái)發(fā)展
隨著集成電路向著輕薄化、小型化以及多功能化趨勢(shì)發(fā)展,先進(jìn)封裝必將成為主流的封裝發(fā)展趨勢(shì)。因此,對(duì)于BGA芯片底部填充膠的性能要求也將越來(lái)越高。目前,噴射技術(shù)因?yàn)榫雀摺⒐?jié)約膠水而將成為未來(lái)的主流應(yīng)用。
總之,正確地選用并應(yīng)用底部填充膠對(duì)于確保BGA封裝產(chǎn)品的長(zhǎng)期穩(wěn)定工作至關(guān)重要。隨著電子產(chǎn)品向著更小尺寸、更高性能方向發(fā)展,對(duì)于這類輔助材料的研究也將繼續(xù)深入。
-
芯片
+關(guān)注
關(guān)注
459文章
52243瀏覽量
436730 -
BGA
+關(guān)注
關(guān)注
5文章
566瀏覽量
48175 -
底部填充劑
+關(guān)注
關(guān)注
0文章
8瀏覽量
5480
發(fā)布評(píng)論請(qǐng)先 登錄
無(wú)人機(jī)控制板BGA芯片模塊底部填充膠點(diǎn)膠保護(hù)方案

臺(tái)式電腦顯卡PCB上BGA芯片底部填充膠點(diǎn)膠應(yīng)用
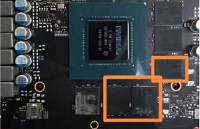
BGA芯片底部填充膠點(diǎn)膠工藝標(biāo)準(zhǔn)和選擇與評(píng)估
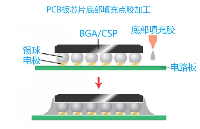
藍(lán)牙模組BGA芯片底部填充膠應(yīng)用

移動(dòng)U盤主板bga芯片底部填充膠應(yīng)用
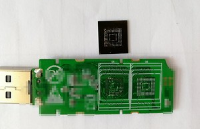
盲人聽(tīng)書(shū)機(jī)BGA芯片底部填充膠應(yīng)用

藍(lán)牙耳機(jī)BGA芯片底部填充膠應(yīng)用
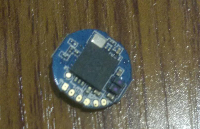
航空攝像機(jī)芯片BGA底部填充膠應(yīng)用

手機(jī)芯片底部填充膠應(yīng)用-漢思底部填充膠
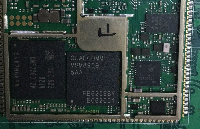
底部填充膠的返修工藝步驟有哪些?如何返修BGA芯片?

漢思HS711芯片BGA底部填充膠水應(yīng)用






 bga芯片底部填充膠介紹
bga芯片底部填充膠介紹
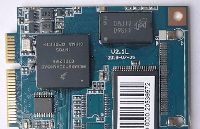












評(píng)論