完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
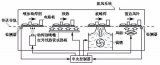
據傳,業界公認的臺積電獨吞蘋果訂單的關鍵利器就是CoWoS封裝技術。這幾年,先進封裝技術不斷涌現,目前可以列出的估計有幾十種,讓人眼花繚亂。主流的封裝技術都有哪些?如何區分呢?下面就給大家盤點一下。...

圖1為您呈現了半導體封裝方法的不同分類,大致可以分為兩種:傳統封裝和晶圓級(Wafer-Level)封裝。...
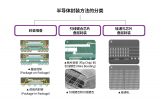

劃片工序是將已擴散完了形成芯片單元的大圓片進行分割分離。從劃片工藝上區分有:全切和半切兩種 全切:將大圓片劃透。適用于比較大的芯片,是目前最流行的劃片工藝。...

熔融焊料在金屬表面潤濕的程度除了與液態焊料與母材表面清潔程度有關,還與液態焊料的表面張力有關。 表面張力與潤濕力的方向相反,不利于潤濕。表面張力是物質的本性,不能消除,但可以改變。...
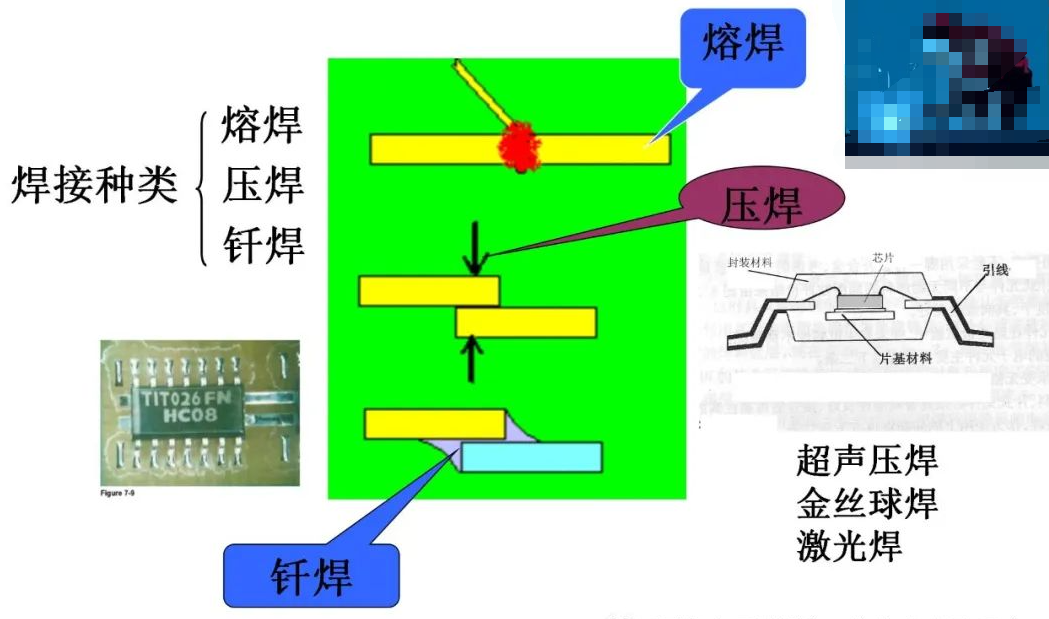
先進封裝處于晶圓制造與封測的交叉區域 先進封裝處于晶圓制造與封測制程中的交叉區域,涉及IDM、晶圓代工、封測廠商。先進封裝要求在晶圓劃片前融入封裝工藝步驟,具體包括應用晶圓研磨薄化、重布線(RDL)、凸塊制作(Bumping)及硅通孔(TSV)等工藝技術,涉及與晶圓制造相似的光刻、顯影、刻蝕、剝離等...

近年來,半導體封裝變得越發復雜,更加強調設計的重要性。半導體封裝設計工藝需要各類工程師和業內人士的共同參與,以共享材料信息、開展可行性測試、并優化封裝特性。在之前的文章:[半導體后端工藝:第四篇] 了解不同類型的半導體封裝(第二部分)中,我們探討了不同類型的半導體封裝。本篇文章將詳細闡述半導體封裝設...

光纖微裂紋診斷儀(OLI)對硅光芯片耦合質量和內部裂紋損傷檢測非常有優勢,以亞毫米級別的空間分辨率精準探測到光鏈路中每個事件節點,具有靈敏度高、定位精準、穩定性高、簡單易用等特點,是硅光芯片檢測的不二選擇。...


半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝(Wafer level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進封裝技術...

晶圓是制作硅半導體IC所用之硅晶片,狀似圓形,故稱晶圓。材料是「硅」, IC(Integrated Circuit)廠用的硅晶片即為硅晶體,因為整片的硅晶片是單一完整的晶體,故又稱為單晶體。但在整體固態晶體內,眾多小晶體的方向不相,則為復晶體(或多晶體)。...
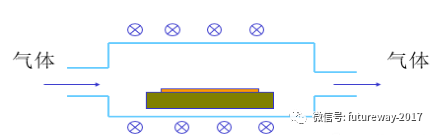
QFN是有源器件,在工作時會產生大量的熱量,這些熱量的一一個主要釋放途徑就是通過焊點來排放出去,以避免器件工作時出現過熱而導致損壞。...

覆晶載板FC Carrier是一種HDI增層(Build up)式多層板。其中Core板為高Tg(220℃)剛性強與超薄銅皮(5μm)的特殊板材。...
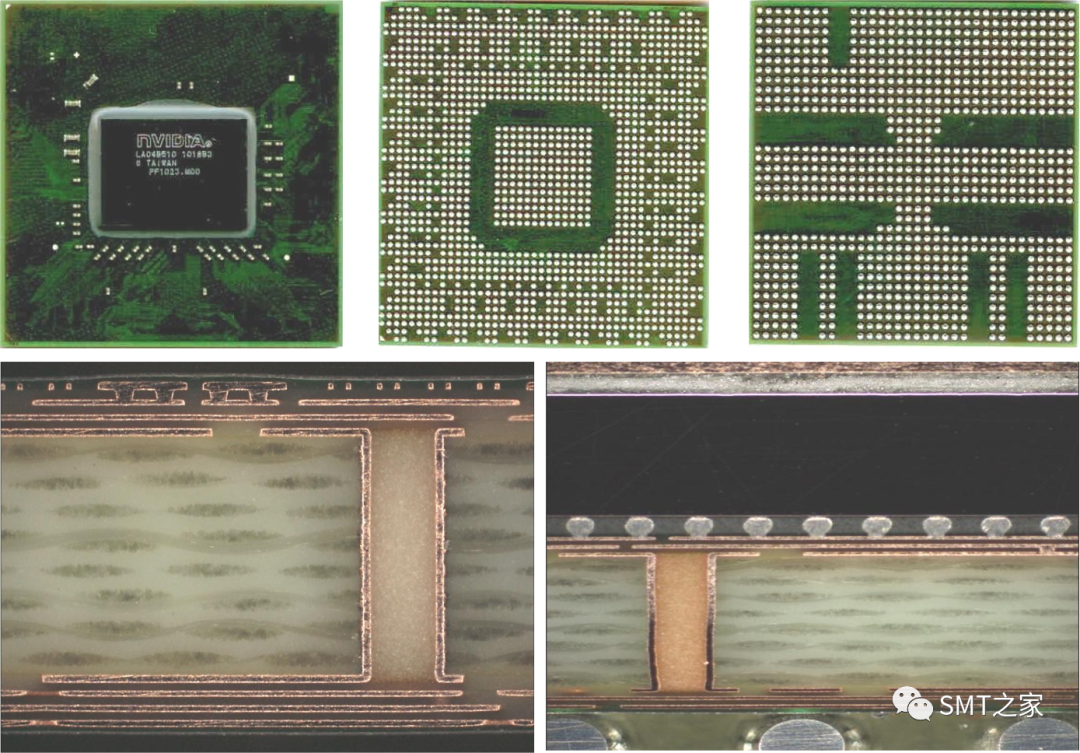
早在公元前350年,古希臘著名的哲學家亞里士多德在文獻中對齒輪有過記錄。公元前250年左右,數學家阿基米德也在文獻中對使用了渦輪蝸桿的卷揚機進行了說明。在現今伊拉克凱特斯芬遺跡中還保存著公元前的齒輪。...

硅在暴露在空氣中時會形成一層氧化硅(SiO2)層。在許多制程步驟中,如在熱處理過程之前,需要移除這層氧化硅。氫氟酸是唯一能夠有效清洗硅片表面氧化硅的化學品。氫氟酸能夠與SiO2發生反應,生成揮發性的氟硅酸,從而清除硅片表面的氧化物層。...
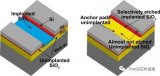
電子封裝技術與器件的硬件結構有關。這些硬件結構包括有源元件1(如半導體)和無源元件2(如電阻器和電容器3)。因此,電子封裝技術涵蓋的范圍較廣,可分為0級封裝到3級封裝等四個不同等級。圖1展示了半導體封裝工藝的整個流程。...
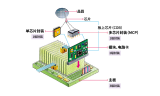
從事半導體行業,尤其是半導體封裝行業的人,總繞不開幾種封裝工藝,那就是芯片粘接、引線鍵合、倒裝連接技術。...
