完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
隨著電子行業的飛速發展, 電子器件的集成度 越來越高, 人們對集成電路的需求逐漸地向高集成 度、 低功耗和小體積的方向發展。倒裝芯片球柵格 陣列 (FCBGA:Flip Chip Ball Grid Array) 封裝器件以其高密度、多I/O 端口封裝和散熱好等優點成 為多種集成電路的封裝首選, 尤...
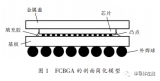
摩爾定律已面臨物理、技術與成本極限的多重挑戰,集成電路在沿著摩爾定律預測的尺寸縮小路徑艱難發展的同時,亟需開辟新的方向。...
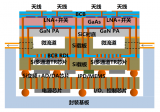
Fab 6 是臺積電首個一體式先進封裝測試工廠,是臺積電不斷增加的封裝投資的一部分。該晶圓廠已準備好量產臺積電 SoIC 封裝技術。請記住,當臺積電說量產時,他們指的是 Apple iPhone 尺寸的量產,而不是工程樣品或內部產品。...

隨著摩爾定律的放緩以及前沿節點復雜性和成本的增加,先進封裝正在成為將多個裸片集成到單個封裝中的關鍵解決方案,并有可能結合成熟和先進的節點。...

3D 堆棧存儲器——HBM、3DS 和 3D NAND——是最大的貢獻者,到 2028 年占總市場份額的 70% 以上。增長最快的四大 =平臺是 3D SoC、有源硅中介層、嵌入式硅橋和 3D NAND堆。...

如下圖所示,CPA model是Pkg Layout(封裝基板設計)通過工具提取出來的一個模型,主要包括封裝基板中的RLC參數。...
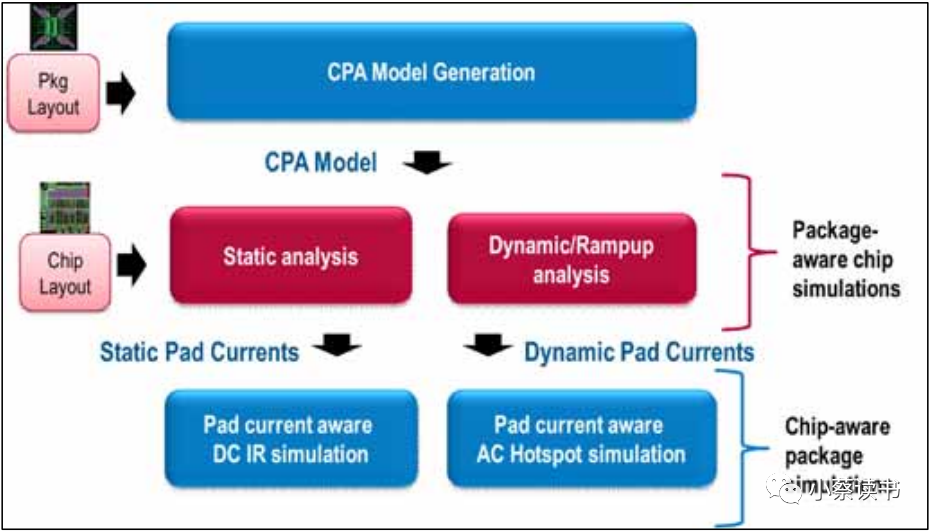
大部分從事后端設計的同行應該沒有接觸過帶封裝的IR Drop分析(模塊級別的IR分析不需要考慮封裝),一般只有PA工程師、后端項目經理、封裝同事等才會接觸這一部分內容。...
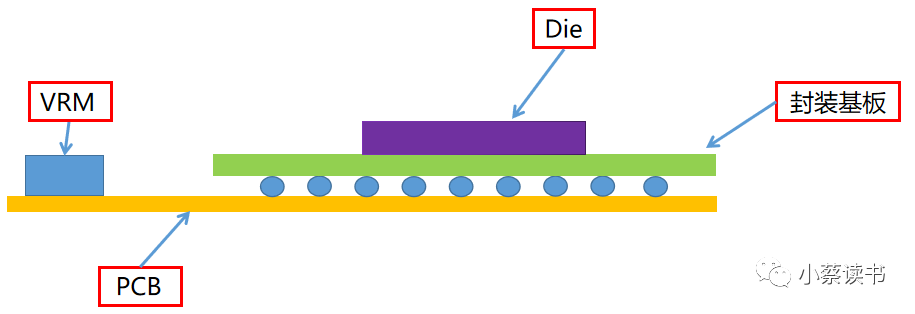
光刻機可分為前道光刻機和后道光刻機。光刻機既可以用在前道工藝,也可以用在后道工藝,前道光刻機用于芯片的制造,曝光工藝極其復雜,后道光刻機主要用于封裝測試,實現高性能的先進封裝,技術難度相對較小。...
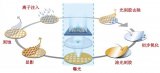
封裝可靠性設計是指針對集成電路使用中可能出現的封裝失效模式,采取相應的設計技術,消除或控制失效模式,使集成電路滿足規定的可靠性要求所采取的技術活動。...
AMD XDNA XDNA帶有本地存儲器和數據移動器的高度可擴展引擎陣列,是AMD利用深厚的FPGA和自適應SOC編譯算法專業知識推出的一種算法工具。...

也稱CPAC(globe top pad array carrier)。球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI 芯片,然后用模壓樹脂或灌封方法進行密封。也稱為凸點陳列載體(PAC)。引腳可超過200,是多引腳LSI用的一種封...
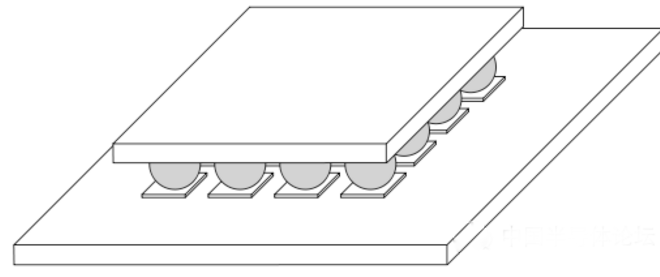
該路線圖概述了標準 FinFET 晶體管將持續到 3nm,然后過渡到新的全柵 (GAA) 納米片設計,該設計將在 2024 年進入大批量生產。Imec繪制了 2nm和A7(0.7nm)Forksheet設計的路線圖,隨后分別是A5和A2的CFET 和原子通道等突破性設計。...

金屬-氧化物半導體場效應晶體管(MOSFET)的革命,讓我們可以在相同面積的晶圓上同時制造出更多晶體管。MOSFET體積越小,單個 MOSFET的耗電量就越少,還可以制造出更多的晶體管,讓其發揮作用,可謂是一舉多得。...

先進封裝是對應于先進圓晶制程而衍生出來的概念,一般指將不同系統集成到同一封裝內以實現更高效系統效率的封裝技術。...

目前,微電子產業已經逐步演變為設計、制造和封裝三個相對獨立的產業。微電子封裝技術即半導體封裝技術,又稱先進集成電路封裝。半導體封裝包括組裝(Assembly)和封裝(Packing)兩個方面,它是將數萬計的半導體元器件組裝成一個緊湊的封裝體,與外界進行信息交流,它的基本功能包括電源供給、信息交流、散...

電子封裝是集成電路芯片生產完成后不可缺少的一道工序,是器件到系統的橋梁。封裝這一生產環節對微電子產品的質量和競爭力都有極大的影響。按目前國際上流行的看法認為,在微電子器件的總體成本中,設計占了三分之一,芯片生產占了三分之一,而封裝和測試也占了三分之一,真可謂三分天下有其一。...
凸塊制造過程一般是基于定制的光掩模,通過真空濺鍍、黃光、電鍍、蝕刻等環節而成,該技術是晶圓制造環節的延伸,也是實施倒裝(FC)封裝工藝的基礎及前提。...

太陽能電池需要硅晶片來提高效率并吸收更多的陽光。經常使用非晶硅、單晶硅和碲化鎘等材料。Floating Zone 方法等制造工藝可將太陽能電池效率提高近 25%。...
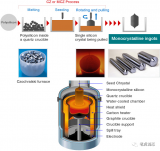
MOSFET結構的核心就是柵極(Gate)。MOSFET與BJT晶體管不同,柵極不與電流溝道(S與D的中間部分)直接接觸,只是“間接”發揮作用。...