完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
由后段制程(BEOL)金屬線寄生電阻電容(RC)造成的延遲已成為限制先進節點芯片性能的主要因素[1]。減小金屬線間距需要更窄的線關鍵尺寸(CD)和線間隔,這會導致更高的金屬線電阻和線間電容。...
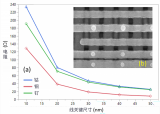
光刻機可分為前道光刻機和后道光刻機。光刻機既可以用在前道工藝,也可以用在后道工藝,前道光刻機用于芯片的制造,曝光工藝極其復雜,后道光刻機主要用于封裝測試,實現高性能的先進封裝,技術難度相對較小。...
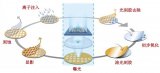
超過50%的PCB元器件焊點缺陷可追溯到不正確或次優的焊膏印刷。雖然良好的錫膏印刷習慣通常在小批量時就已足夠,但對于大批量印刷,應仔細考慮錫膏檢查(SPI)。...
將從晶圓廠出來的Wafer進行背面研磨,來減薄晶圓達到 封裝需要的厚度(5mils~10mils); 磨片時,需要在正面(Active Area)貼膠帶保護電路區域 同時研磨背面。研磨之后,去除膠帶,測量厚度;...
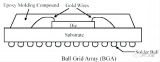
極紫外光刻的制約因素 耗電量高極紫外線波長更短,但易被吸收,可利用率極低,需要光源提供足夠大的功率。如ASML 3400B光刻機,250W的功率,每天耗電達到三萬度。 生產效率仍不夠高同樣以3400B來說,該EUV光刻機的生產效率是每小時125片晶圓,還不到DUV光刻機生產效率的一半...


光刻機需要采用全反射光學元件,掩模需要采用反射式結構。 這些需求帶來的是EUV光刻和掩模制造領域的顛覆性技術。EUV光刻掩模的制造面臨著許多挑戰,包括掩模基底的低熱膨脹材料的開發、零缺陷襯底拋光、多層膜缺陷檢查、多層膜缺陷修復等。...


IGBT相比MOSFET,可在更高電壓下持續工作,同時需要兼顧高功率密度、低損耗、高可靠性、散熱好、低成本等因素。一顆高性能、高可靠性與低成本的IGBT芯片,不僅僅需要在設計端不斷優化器件結構,對晶圓制造和封裝也提高了更高的要求。...
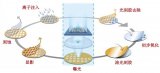
旋轉圓盤與旋轉輪類似,不同之處在于旋轉圓盤不是擺動整個圓盤,而是用掃描離子束的方式在整個晶圓表面獲得均勻的離子注入。下圖說明了旋轉圓盤系統。...
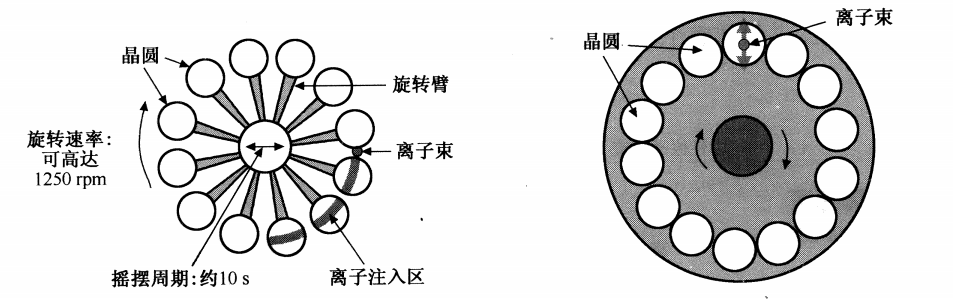

利用Simcenter Flotherm Package Creator芯片封裝工具可以幫助你在幾分鐘內創建出一個常用的IC封裝詳細模型...

在焊縫或近縫區,由于焊接的影響,材料的原子結合遭到破壞,形成新的界面而產生的縫隙稱為焊接裂縫,它具有缺口尖銳和長寬比大的特征。按產生時的溫度和時間的不同,裂紋可分為:熱裂紋、冷裂紋、應力腐蝕裂紋和層狀撕裂。...


晶圓鍵合是半導體行業的“嫁接”技術,通過化學和物理作用將兩塊已鏡面拋光的晶片緊密地結合起來,進而提升器件性能和功能,降低系統功耗、尺寸與制造成本。...

由于接觸電阻增加和IR下降,導致能量損失、性能降低和高溫,向更薄的節點供電已經成為一種挑戰。背面PDN(PowerVia)將電源線從數據I/O線路移開,簡化了連接性并使PDN更加成熟。...

隨著光刻技術的進步,光刻光源的曝光波長已經減小很多。早期投影式光刻技術的曝光波長為436nm、365nm (分別來自于汞弧燈可見光g線和紫外光i線),所制造的集成電路特征尺寸為600nm或更大。...

電子封裝技術與器件的硬件結構有關。這些硬件結構包括有源元件1(如半導體)和無源元件2(如電阻器和電容器3)。因此,電子封裝技術涵蓋的范圍較廣,可分為0級封裝到3級封裝等四個不同等級。...
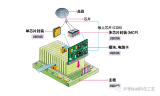
直接鍍銅陶瓷基板(Direct Plating Copper, DPC)是在陶瓷薄膜工藝加工基礎上發展起來的陶瓷電路加工工藝。以氮化鋁/氧化鋁陶瓷作為線路的基板,采用濺鍍工藝于基板表面復合金屬層,并以電鍍和光刻工藝形成電路。...
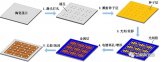
車規級半導體也稱“汽車芯片”,用于車體控制裝置,車載監控裝置及車載電子控制裝置等領域,主要分布在車體控制模塊上、車載信息娛樂系統等方面,包括動力傳動綜合控制系統,主動安全系統和高級輔助駕駛系統等,半導體比傳統燃油車更多用于新能源汽車,增加電動機控制系統和電池管理系統的應用場景。...
