完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
摘要:射頻前端模塊是無線通信的核心,濾波器作為射頻前端的關鍵器件,可將帶外干擾和噪聲濾除以保留特定頻段內的信號,滿足射頻系統的通訊要求。...

由于高密度打件采用微小化元器件與制程,因此元器件與載板之間的連結,吃錫量大幅減少,為提高打件可靠度,避免外界濕度、高溫及壓力等影響,塑封制程可將完整的元器件密封包覆在載板上。...

機器學習和人工智能等數據豐富的應用程序是數據中心、5G 和自動駕駛汽車等廣泛應用程序的關鍵數據推動因素。要運行這些應用程序,需要一個強大的處理器,其基礎是基于 Si 的集成電路 (IC)。...


改質切割是一種將半導體晶圓分離成單個芯片或晶粒的激光技術。該過程是使用精密激光束在晶圓內部形成改質層,使晶圓可以通過輕微外力沿激光掃描路徑精確分離。...

感光速度:即光刻膠受光照射發生溶解速度改變所需的最小能量,感光速度越快,單位時間內芯片制造的產出越高,經濟效益越好,另-方面,過快的感光速度會對引起工藝寬容度的減小,影響工藝制程的穩定性。...

無論是采用Fan-in還是Fan-out,WLP晶圓級封裝和PCB的連接都是采用倒裝芯片形式,芯片有源面朝下對著印刷電路板,可以實現最短的電路徑,這也保證了更高的速度和更少的寄生效應。...
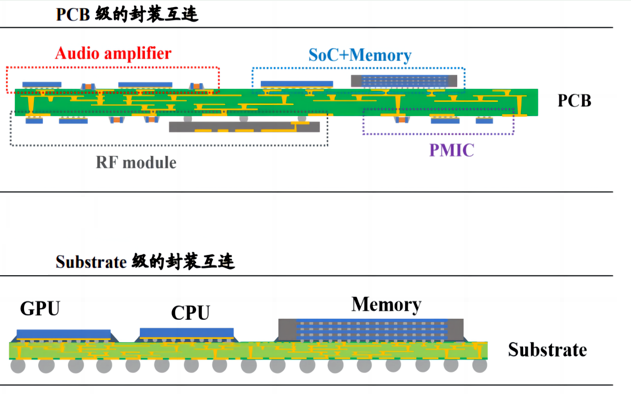
集成電路芯片持續朝著密度不斷增加和器件尺寸不斷微縮的方向發展,其中最為關鍵的一個參數就是柵極線條寬度。任何經過光刻后的光刻膠線條寬度或刻蝕后柵極線條寬度與設計尺寸的偏離都會直接影響最終器件的性能、成品率及可靠性,所以先進的工藝控制都需要對線條寬度進行在線測量,通常稱為關鍵尺寸(CriticalD...

摘 要:針對半導體工藝與制造裝備的發展趨勢進行了綜述和展望。首先從支撐電子信息技術發展的角度,分析半導體工藝與制造裝備的總體發展趨勢,重點介紹集成電路工藝設備、分立器件工藝設備等細分領域的技術發展態勢和主要技術挑戰。...

芯片的制造過程可以分為前道工藝和后道工藝。前道是指晶圓制造廠的加工過程,在空白的硅片完成電路加工,出廠后依然是完整的圓形硅片。后道是指封裝和測試過程,在封測廠中將圓形的硅片切割成單獨的晶粒,完成外殼的封裝,最后完成終端測試,出廠為芯片成品。...
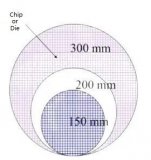
基于傳感器和物聯網(IoT),可以感知產品的狀態,從而進行預防性維修維護,及時幫助客戶更換備品備件,甚至可以通過了解產品運行的狀態,幫助客戶帶來商業機會。...
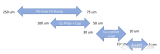
隨著晶圓代工制程不斷縮小,摩爾定律逼近極限,先進封裝是后摩爾時代的必然選擇。其中,利用高端封裝融合最新和成熟節點,采用系統封裝(SiP)和基于小芯片的方法,設計和制造最新的SoC產品已經成為主要的技術路徑。2.5D/3D封裝正在加速3D互連密度的技術突破,TSV及TGV的技術作為2.5D/3D封裝的...

集成電路和電子系統的快速發展,推動著封裝和集成技術向著輕型化、高集成度、多樣化的方向不斷革新,也帶動了封裝的電/熱/機械及結構的設計與仿真工具的快速發展。...
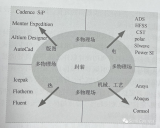
傳統CMOS技術的缺陷在于: 襯底的厚度會影響片上的寄生電容, 間接導致芯片的性能下降。 SOI技術主要是將 源極/漏極 和 硅片襯底分開, 以達到(部分)消除寄生電容的目的。...

刻蝕設備的重要性僅次于光刻機。而隨著NAND閃存進入3D、4D時代,要求刻蝕技術實現更高的深寬比,刻蝕設備的投資占比顯著提升,從25%提至50%。...

經過前端工藝處理并通過晶圓測試的晶圓將從背面研磨(Back Grinding)開始后端處理。背面研磨是將晶圓背面磨薄的工序,其目的不僅是為了減少晶圓厚度,還在于聯結前端和后端工藝以解決前后兩個工藝之間出現的問題。半導體芯片(Chip)越薄,就能堆疊(Stacking)更多芯片,集成度也就越高。但集成...

高端性能封裝主要以追求最優化計算性能為目的,其結構主要以 UHD FO、2.5D 和 3D 先進封裝為 主。在上述封裝結構中,決定封裝形式的主要因素為 價格、封裝密度和性能等。...
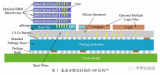
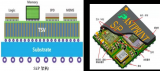
精密陶瓷基板具有優良的電絕緣性、高導熱性、高附著強度和大的載流能力。使用溫度范圍寬,可以達到-55℃~850℃,熱膨脹系數接近于硅芯片。在多溫區測試環境下,是解決形變的有效方案之一。...