完善資料讓更多小伙伴認識你,還能領取20積分哦,立即完善>
電子發燒友網技術文庫為您提供最新技術文章,最實用的電子技術文章,是您了解電子技術動態的最佳平臺。
回顧過去五六十年,先進邏輯芯片性能基本按照摩爾定律來提升。提升的主要動力來自三極管數量的增加來實現,而單個三極管性能的提高對維護摩爾定律只是起到輔佐的作用。隨著SOC的尺寸逐步逼近光罩孔極限尺寸(858mm2)以及制程的縮小也變得非常艱難且性價比遇到挑戰, 多芯片封裝技術來到了舞臺的中心成為進一步提...

系統級封裝 (System in Package, SiP)是指將單個或多個芯片與各類元件通過系統設計及特定的封裝工藝集成于單一封裝體或模塊,從而實現具完整功能的電路集成,如圖 7-115 所示。與系統級芯片 (SoC)常用于集成數字及邏輯電路不同,系統級封裝(SiP)更適用于無法(或非常困難)在單...
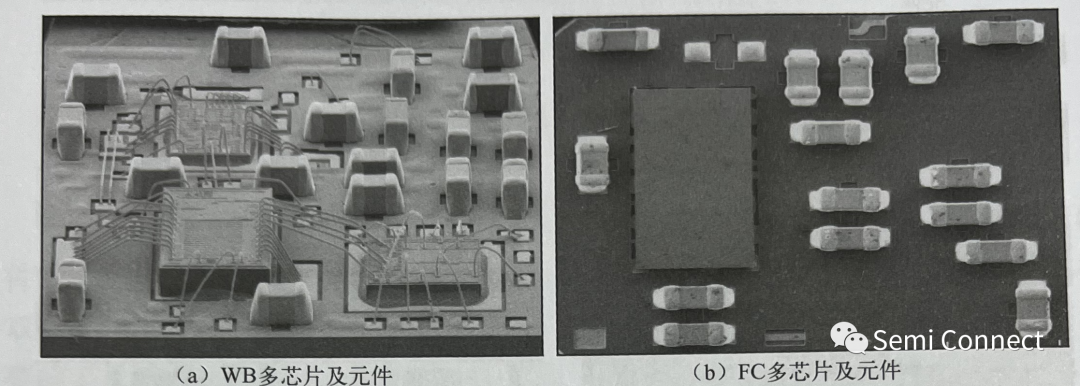
半導體技術按摩爾定理的發展,集成電路的密度將越來越高,且尺寸越來越小。所有芯片工作時都會發熱,熱量的累積必導致結點溫度的升高,隨著結點溫度提高...

由于GRE報文為明文封裝,在網絡中傳輸容易被監聽導致信息泄漏。基于此,本案例提供一種方案,使用NAT技術隱藏客戶端源地址。...

板級埋人式封裝是一種在基板制造工藝的基礎上融合芯片封裝工藝及 SMT工藝的集成封裝技術,既可以是單芯片封裝、多芯片封裝,也可以是模組封裝、堆疊封裝。與傳統封裝中在基板表面貼裝芯片或元件不同,板級埋人式封裝直接將芯片或元件嵌人基板中間,因此它具有更短的互連路徑、更小的體積、更優的電熱性能及更高的集成度...
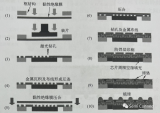
碳化硅襯底 產業鏈核心材料,制備難度大碳化硅襯底制備環節主要包括原料合成、碳化硅晶體生長、晶錠加工、晶棒切割、切割片研磨、研磨片拋光、拋光片清洗等環節。...


三維封裝通過非 WB 互連技術實現芯片間的高密度封裝,為微電子系統封裝在三維空間開辟了一個新的發展方向,可以有效地滿足高功能芯片超輕、超薄、高性能、低功耗及低成本的需求"。該技術主要應用在高速計算、網絡和GPU 等系統芯片中。傳統二維封裝與三維封裝對比示意圖如圖所示。...
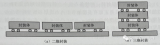
EUV光刻膠需要具有足夠的耐刻蝕性,以便在后續的刻蝕過程中保護圖案。為了提高耐刻蝕性,研究人員正在開發新型刻蝕抑制劑和交聯劑,以增強光刻膠的結構穩定性。...
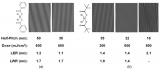
將半導體芯片壓焊區與框架引腳之間用鋁線連接起來的封裝工藝技術!季豐電子所擁有的ASM綁定焊線機AB550為桌面式焊線機,其為全自動超聲波焊線機,應用于細鋁線的引線鍵合,主要應用于COB及PCB領域。...

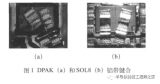
晶圓測試的方式主要是通過測試機和探針臺的聯動,在測試過程中,測試機臺并不能直接對待測晶圓進行量測,而是透過探針卡(Probe Card)中的探針(Probe)與晶圓上的焊墊(Pad)或凸塊(Bump)接觸而構成電性接觸。...
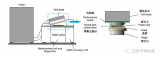
硅通孔(TSV) 是當前技術先進性最高的封裝互連技術之一。基于 TSV 封裝的核心工藝包括 TSV 制造、RDL/微凸點加工、襯底減薄、圓片鍵合與薄圓片拿持等。...

扇出型圓片級封裝(FoWLP)是圓園片級封裝中的一種。相對于傳統封裝圓片級封裝具有不需要引線框、基板等介質的特點,因此可以實現更輕、薄短、小的封裝。扇出型圓片級封裝也可以支持多芯片、2.5D/3D 和系統級封裝(SP)。扇出型圓片級封裝可以徹底去除芯片和封裝的連接環節(既不需要打線,也不需要凸塊),...

先進邏輯芯片性能基本按照摩爾定律來提升。提升的主要動力來自三極管數量的增加來實現,而單個三極管性能的提高對維護摩爾定律只是起到輔佐的作用。...

對于BGA扇孔,同樣過孔不宜打孔在焊盤上,推薦打孔在兩個焊盤的中間位置。很多工程師為了出線方便,隨意挪動BGA里面過孔的位置,甚至打在焊盤上面...
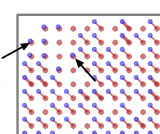
IC的發熱量相當驚人,一般的CPU為2.3W,高速度、高功能的IC則可高達20.30W,藉由封裝的熱傳設計,可將IC的發熱排出,使IC在可工作溫度下( 通常小于85C )正常運作c...

貼片化是從帶獨立散熱片的插件封裝走向更高功率散熱的第一步。一般貼片封裝的散熱主要是靠芯片底部跟PCB(印刷電路板)之間的接觸,利用PCB銅箔把芯片產生的熱量傳導出去。...
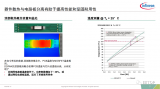
按照器件結構,分為二極管、功率晶體管、晶閘管等,其中功率晶體管分為雙極性結型晶體管(BJT)、結型場效應晶體管(JFET)、金屬氧化物場效應晶體管(MOSFET)和絕緣柵雙極晶體管(IGBT)等。...
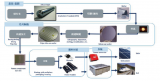
QFN封裝(方形扁平無引腳封裝),如圖1所示,具有良好的電和熱性能、體積小、重量輕、其應用正在快速增長,采用微型引線框架的QFN封裝稱為MLF封裝(微引線框架)。...