摘要
在未來幾代器件中,去除光刻膠和殘留物變得非常關(guān)鍵。在前端線后離子注入(源極/漏極、擴展),使用PR來阻斷部分電路導(dǎo)致PR基本上硬化并且難以去除。在后端線(BEOL)蝕刻中,除低k材料的情況下去除抗蝕劑和殘留物的選擇性非常具有挑戰(zhàn)性。
介紹
光致抗蝕劑用于保護晶片的某些區(qū)域免受干蝕刻化學(xué)物質(zhì)、離子注入等影響。工藝完成后,需要選擇性去除光刻膠并清潔表面,確保表面無殘留物和顆粒。使用濕化學(xué)物質(zhì),如熱 SPM、有機溶劑或使用干等離子體“ 灰化”,原則上可以去除抗蝕劑。然而,抗蝕劑在干法蝕刻或注入處理期間被化學(xué)改性,并且適種改性可以顯著降低剝離速率。
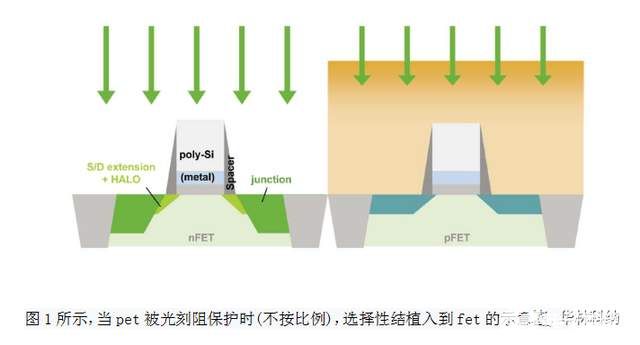
?
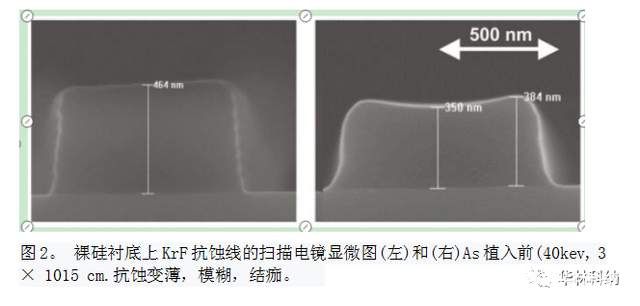
當(dāng)前的方法
為了達到足夠,從而達到可接受的低周期時間,以及良好的殘留去除,腐蝕等離子體str ip化學(xué)與晶片加熱結(jié)合使用。這些典型的inyolye等離子體是基于高度氧化的自由基。為了增強結(jié)殼帶,在等離子體中加入含f的物質(zhì)。然而,這些傾向于攻擊暴露的氧化硅襯底。為了解決這個問題,通常采用兩步工藝:含f的結(jié)殼帶和無f的散裝帶 。

審核編輯:湯梓紅
 電子發(fā)燒友App
電子發(fā)燒友App












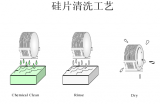

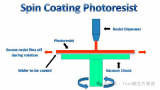
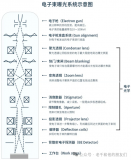





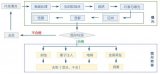

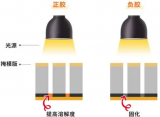

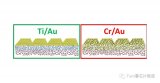
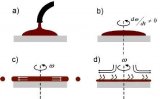
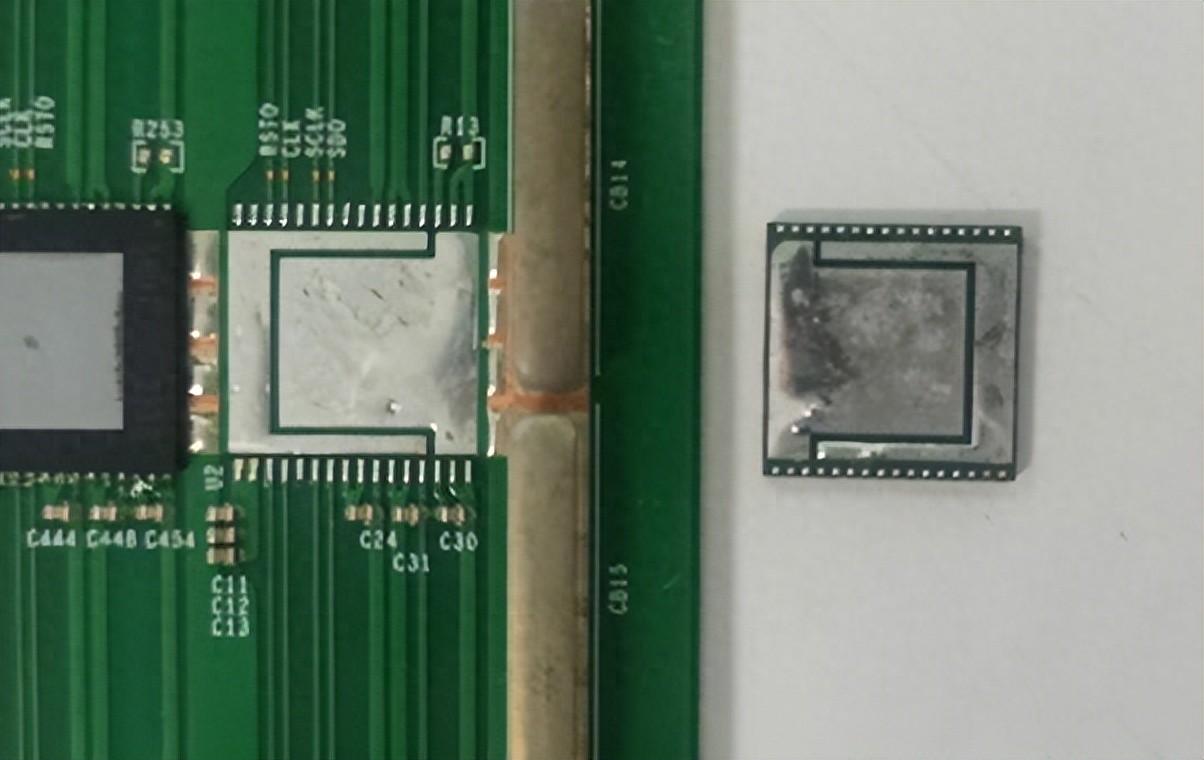




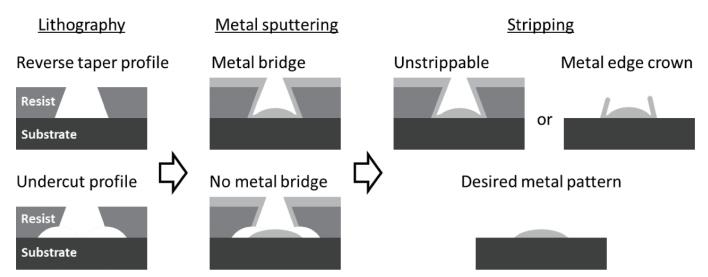

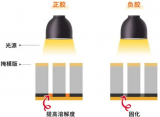

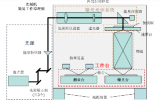







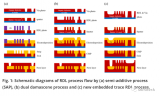




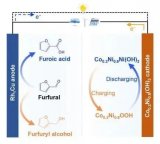

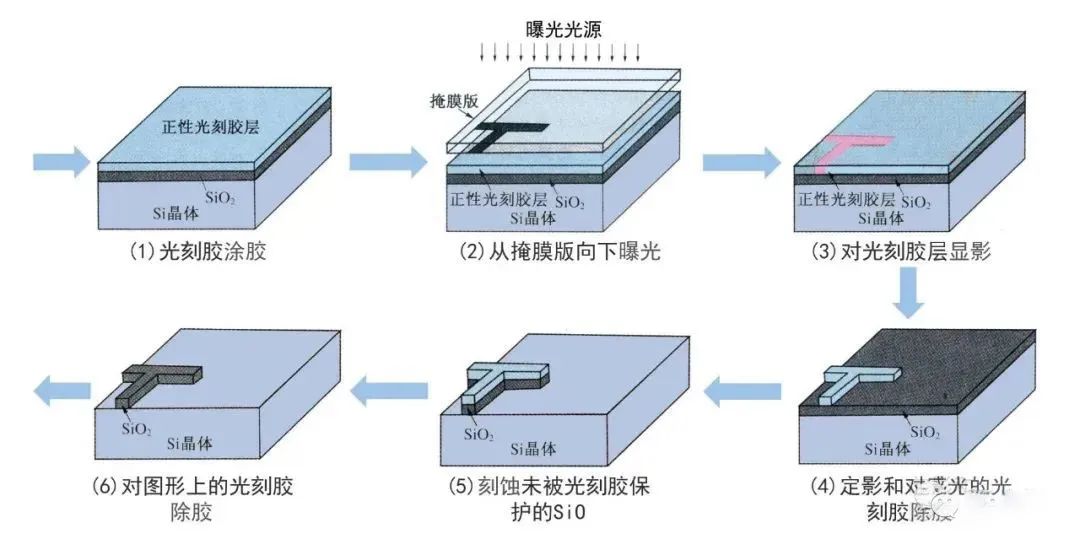

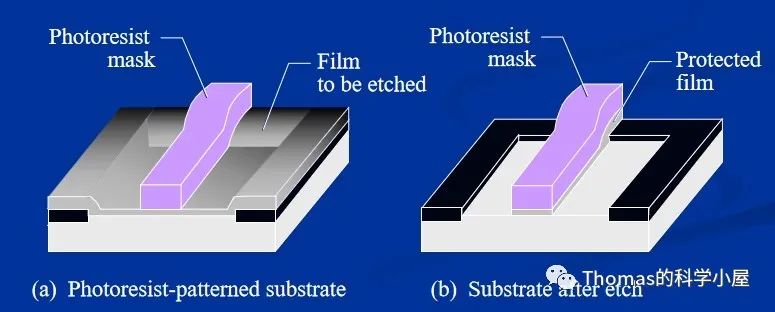



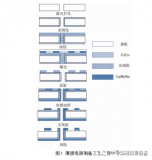




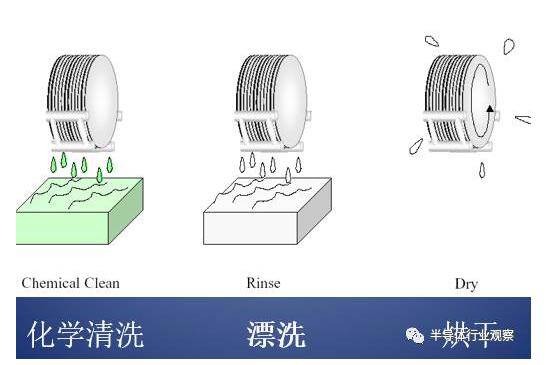
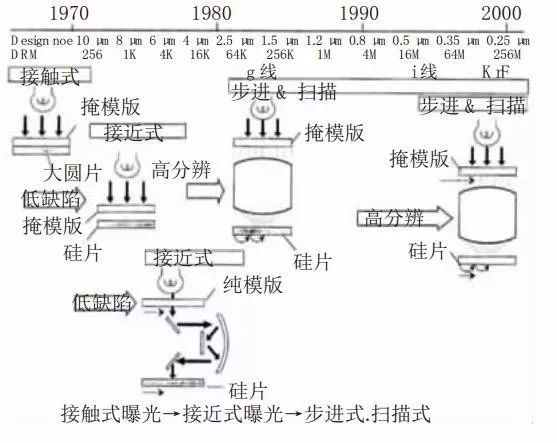










評論