目前在全球半導(dǎo)體產(chǎn)業(yè)領(lǐng)域,有業(yè)界人士認(rèn)為2.5D先進(jìn)封裝技術(shù)的芯片產(chǎn)品成本,未來(lái)可望隨著相關(guān)產(chǎn)品量產(chǎn)而愈來(lái)愈低,但這樣的假設(shè)可能忽略技術(shù)本身及制造商營(yíng)運(yùn)管理面的諸多問(wèn)題與困境,可能并非如此容易預(yù)測(cè)新興封裝技術(shù)產(chǎn)品的未來(lái)價(jià)格走勢(shì)。
2016-03-24 08:23:56 3645
3645 有一種先進(jìn)封裝技術(shù)被稱為“晶圓級(jí)封裝”(WLP),即直接在晶圓上完成集成電路的封裝程序。通過(guò)該工藝進(jìn)行封裝,可以制成與原裸片大小近乎相同的晶圓。
2020-10-26 15:01:10 944
944 SiP的關(guān)注點(diǎn)在于:系統(tǒng)在封裝內(nèi)的實(shí)現(xiàn),所以系統(tǒng)是其重點(diǎn)關(guān)注的對(duì)象,和SiP系統(tǒng)級(jí)封裝對(duì)應(yīng)的為單芯片封裝;先進(jìn)封裝的關(guān)注點(diǎn)在于:封裝技術(shù)和工藝的先進(jìn)性,所以先進(jìn)性的是其重點(diǎn)關(guān)注的對(duì)象,和先進(jìn)封裝對(duì)應(yīng)的是傳統(tǒng)封裝。
2021-03-15 10:31:53 8490
8490 
(858mm2)以及制程的縮小也變得非常艱難且性價(jià)比遇到挑戰(zhàn), 多芯片封裝技術(shù)來(lái)到了舞臺(tái)的中心成為進(jìn)一步提升芯片性能的關(guān)鍵。覆晶鍵合技術(shù)已然成為先進(jìn)多芯片封裝最重要的技術(shù)之一。
2023-05-11 10:24:38 615
615 
隨著晶圓代工制程不斷縮小,摩爾定律逼近極限,先進(jìn)封裝是后摩爾時(shí)代的必然選擇。其中,利用高端封裝融合最新和成熟節(jié)點(diǎn),采用系統(tǒng)封裝(SiP)和基于小芯片的方法,設(shè)計(jì)和制造最新的SoC產(chǎn)品已經(jīng)成為
2023-05-23 12:29:11 2878
2878 
先進(jìn)封裝是“超越摩爾”(More than Moore)時(shí)代的一大技術(shù)亮點(diǎn)。當(dāng)芯片在每個(gè)工藝節(jié)點(diǎn)上的微縮越來(lái)越困難、也越來(lái)越昂貴之際,工程師們將多個(gè)芯片放入先進(jìn)的封裝中,就不必再費(fèi)力縮小芯片了。本文將對(duì)先進(jìn)封裝技術(shù)中最常見的10個(gè)術(shù)語(yǔ)進(jìn)行簡(jiǎn)單介紹。
2023-07-12 10:48:03 625
625 
先進(jìn)封裝處于晶圓制造與封測(cè)的交叉區(qū)域 先進(jìn)封裝處于晶圓制造與封測(cè)制程中的交叉區(qū)域,涉及IDM、晶圓代工、封測(cè)廠商。先進(jìn)封裝要求在晶圓劃片前融入封裝工藝步驟,具體包括應(yīng)用晶圓研磨薄化、重布線(RDL
2023-08-07 10:59:46 852
852 
? 半導(dǎo)體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級(jí)封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標(biāo)一代比一代先進(jìn)。總體說(shuō)來(lái)
2023-08-28 09:37:11 1072
1072 
隨著晶圓級(jí)封裝技術(shù)的不斷提升,眾多芯片設(shè)計(jì)及封測(cè)公司開始思考并嘗試采用晶圓級(jí)封裝技術(shù)替代傳統(tǒng)封裝。其中HRP(Heat?Re-distribution?Packaging)晶圓級(jí)先進(jìn)封裝工藝技術(shù)
2023-11-30 09:23:24 1124
1124 
半導(dǎo)體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級(jí)封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標(biāo)一代比一代先進(jìn)。總體說(shuō)來(lái),半導(dǎo)體
2024-01-16 09:54:34 606
606 
最近,在先進(jìn)封裝領(lǐng)域又出現(xiàn)了一個(gè)新的名詞“3.5D封裝”,以前聽?wèi)T了2.5D和3D封裝,3.5D封裝又有什么新的特點(diǎn)呢?還是僅僅是一個(gè)吸引關(guān)注度的噱頭?
2024-01-23 16:13:29 496
496 
摘 要:先進(jìn)封裝技術(shù)不斷發(fā)展變化以適應(yīng)各種半導(dǎo)體新工藝和材料的要求和挑戰(zhàn)。在半導(dǎo)體封裝外部形式變遷的基礎(chǔ)上,著重闡述了半導(dǎo)體后端工序的關(guān)鍵一封裝內(nèi)部連接方式的發(fā)展趨勢(shì)。分析了半導(dǎo)體前端制造工藝的發(fā)展
2018-11-23 17:03:35
BGA封裝技術(shù)是一種先進(jìn)的集成電路封裝技術(shù),主要用于現(xiàn)代計(jì)算機(jī)和移動(dòng)設(shè)備的內(nèi)存和處理器等集成電路的封裝。與傳統(tǒng)的封裝方式相比,BGA封裝具有更小的體積,更好的散熱性能和電性能,可在相同體積下提高
2023-04-11 15:52:37
LED封裝技術(shù)大都是在分立器件封裝技術(shù)基礎(chǔ)上發(fā)展與演變而來(lái)的,但卻有很大的特殊性。一般情況下,分立器件的管芯被密封在封裝體內(nèi),封裝的作用主要是保護(hù)管芯和完成電氣互連。而LED封裝則是完成輸出電信號(hào)
2016-11-02 15:26:09
LED封裝膠屬于電子化學(xué)品,是LED產(chǎn)業(yè)主要的配套材料,最近幾年全球LED產(chǎn)業(yè)逐漸向中國(guó)轉(zhuǎn)移,國(guó)內(nèi)LED芯片和LED封裝產(chǎn)值在全球占據(jù)越來(lái)越高的比例,隨之而來(lái)的是對(duì)LED封裝膠需求量的大幅提升
2018-09-27 12:03:58
LED的封裝對(duì)封裝材料的特殊要求大功率LED封裝的技術(shù)原理
2021-03-08 07:59:26
誰(shuí)來(lái)闡述一下cof封裝技術(shù)是什么?
2019-12-25 15:24:48
皇家飛利浦電子公司宣布在超薄無(wú)鉛封裝技術(shù)領(lǐng)域取得重大突破,推出針對(duì)邏輯和 RF 應(yīng)用的兩款新封裝:MicroPak?II 和 SOD882T。MicroPakII 是世界上最小的無(wú)鉛邏輯封裝,僅 1.0mm2,管腳間距為 0.35mm。
2019-10-16 06:23:44
微電子三級(jí)封裝是什么?新型微電子封裝技術(shù)介紹
2021-04-23 06:01:30
停止,應(yīng)用需求封裝采用更先進(jìn)的技術(shù),向高性能的微型化小尺寸封裝外形演繹、目前,分立器件微小尺寸封裝有更多規(guī)格版本供貨,提供了更低的成本和空間優(yōu)勢(shì),簡(jiǎn)化外圍電路設(shè)計(jì)更自由,易連接.例如,數(shù)字晶體管的小平腿
2018-08-29 10:20:50
多芯片整合封測(cè)技術(shù)--種用先進(jìn)封裝技術(shù)讓系統(tǒng)芯片與內(nèi)存達(dá)到高速傳輸ASIC 的演進(jìn)重復(fù)了從Gate Array 到Cell Base IC,再到系統(tǒng)芯片的變遷,在產(chǎn)業(yè)上也就出現(xiàn)了,負(fù)責(zé)技術(shù)開發(fā)的IC
2009-10-05 08:11:50
封裝技術(shù)至關(guān)重要。衡量一個(gè)芯片封裝技術(shù)先進(jìn)與否的重要指標(biāo)是:芯片面積與封裝面積之比,這個(gè)比值越接近1越好。封裝時(shí)主要考慮的因素:芯片面積與封裝面積之比,為提高封裝效率,盡量接近1:1。引腳要盡量短以
2020-02-24 09:45:22
半導(dǎo)體封裝的主流技術(shù) 微電子裝聯(lián)技術(shù)包括波峰焊和再流焊 再流焊技術(shù)有可能取代波峰焊技術(shù) 成為板級(jí)電路組裝焊接技術(shù)的主流 從微電子封裝技術(shù)的發(fā)展歷程可以看出 IC芯片與微電子封裝技術(shù)是相互促進(jìn) 協(xié)調(diào)發(fā)展 密不可分的 微電子封裝技術(shù)將向小型化 高性能并滿足環(huán)保要求的方向發(fā)展
2013-12-24 16:55:06
。如比較小的阻抗值、較強(qiáng)的抗干擾能力、較小的信號(hào)失真等等。芯片的封裝技術(shù)經(jīng)歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM。技術(shù)指標(biāo)和電器性能一代比一代先進(jìn)。
2011-10-28 10:51:06
2種新型的芯片封裝技術(shù)介紹在計(jì)算機(jī)內(nèi)存產(chǎn)品工藝中,內(nèi)存的封裝技術(shù)是內(nèi)存制造工藝中最關(guān)鍵一步,采用不同封裝技術(shù)的內(nèi)存條,在性能上存在較大差距。只有高品質(zhì)的封裝技術(shù)才能生產(chǎn)出完美的內(nèi)存產(chǎn)品。本文就主要
2009-04-07 17:14:08
先進(jìn)封裝發(fā)展背景晶圓級(jí)三維封裝技術(shù)發(fā)展
2020-12-28 07:15:50
求pads 五向開關(guān)封裝。。謝謝各位了
2015-02-12 17:11:08
,20世紀(jì)最后二十年,隨著微電子、光電子工業(yè)的巨變,為封裝技術(shù)的發(fā)展創(chuàng)造了許多機(jī)遇和挑戰(zhàn),各種先進(jìn)的封裝技術(shù)不斷涌現(xiàn),如BGA、CSP、FCIP、WLP、MCM、SIP等,市場(chǎng)份額不斷增加,2000年已達(dá)
2018-08-23 12:47:17
全球微型化趨勢(shì)下,空前增長(zhǎng)的電力電子發(fā)展以及伴隨之下更高效的生產(chǎn)效率,是這一高端行業(yè)尋求更高效灌封以及封裝技術(shù)的主要?jiǎng)恿ΑU澈蟿┕I(yè)對(duì)這一趨勢(shì)作出了積極響應(yīng)。市面上如雨后春筍般出現(xiàn)了眾多新研發(fā)的產(chǎn)品。
2020-08-06 06:00:12
和其他LSI集成電路都起著重要的作用。新一代CPU的出現(xiàn)常常伴隨著新的封裝形式的使用。芯片的封裝技術(shù)已經(jīng)歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM,技術(shù)指標(biāo)一代比一代先進(jìn)
2018-09-03 09:28:18
統(tǒng)的一道橋梁,隨著微電子技術(shù)的飛速發(fā)展及其向各行業(yè)的迅速滲透,芯片封裝也在近二、三十年內(nèi)獲得了巨大的發(fā)展,并已經(jīng)取得了長(zhǎng)足的進(jìn)步。本文簡(jiǎn)要介紹了近20年來(lái)計(jì)算機(jī)行業(yè)芯片封裝形成的演變及發(fā)展趨勢(shì),從中可以
2018-11-23 16:59:52
研究院(先進(jìn)電子封裝材料廣東省創(chuàng)新團(tuán)隊(duì))、上海張江創(chuàng)新學(xué)院、深圳集成電路設(shè)計(jì)產(chǎn)業(yè)化基地管理中心、桂林電子科技大學(xué)機(jī)電工程學(xué)院承辦的 “第二期集成電路封裝技術(shù) (IC Packaging
2016-03-21 10:39:20
與技術(shù)、陶瓷封裝、塑料封裝、氣密性封裝、封裝可靠性工程、封裝過(guò)程中的缺陷分析和先進(jìn)封裝技術(shù)。第1章 集成電路芯片封裝概述 第2章 封裝工藝流程 第3章 厚/薄膜技術(shù) 第4章 焊接材料 第5
2012-01-13 13:59:52
8~12 英寸先進(jìn)封裝技術(shù)專用勻膠設(shè)備沈陽(yáng)芯源微電子設(shè)備有限公司沈陽(yáng)芯源微電子設(shè)備有限公司研制的8~12 英寸先進(jìn)封裝技術(shù)專用勻膠設(shè)備獲得“2007年中國(guó)半導(dǎo)體創(chuàng)新產(chǎn)
2009-12-14 10:42:38 8
8 論文綜述了自 1990 年以來(lái)迅速發(fā)展的先進(jìn)封裝技術(shù),包括球柵陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級(jí)封裝(WLP)、三維封裝(3D)和系統(tǒng)封裝(SiP)等項(xiàng)新技術(shù);同時(shí),敘述了我國(guó)封
2009-12-14 11:14:49 28
28 提高取光效率降熱阻功率型LED封裝技術(shù)
超高亮度LED的應(yīng)用面不斷擴(kuò)大,首先進(jìn)入特種照明的市場(chǎng)領(lǐng)域,并向普通照明市場(chǎng)邁進(jìn)。由于L
2009-12-20 14:31:22 503
503 超高亮度LED的應(yīng)用面不斷擴(kuò)大,首先進(jìn)入特種照明的市場(chǎng)領(lǐng)域,并向普通照明市場(chǎng)邁進(jìn)。由于LED芯片輸入功率的不斷提高,對(duì)這些功率型LED的封裝技術(shù)提出了更高的要求。功率型LED封裝
2011-09-26 16:41:44 690
690 全球晶圓代工龍頭臺(tái)積電次代先進(jìn)封裝布局可望再進(jìn)一步,持續(xù)替摩爾定律延壽。日前苗栗縣政府已經(jīng)表示,臺(tái)積電竹南之先進(jìn)封測(cè)廠建廠計(jì)畫已經(jīng)展開環(huán)評(píng),而熟悉半導(dǎo)體先進(jìn)封裝業(yè)者表示,臺(tái)積電近期陸續(xù)研發(fā)并推動(dòng)
2018-09-25 13:56:20 4157
4157 在業(yè)界先進(jìn)封裝技術(shù)與傳統(tǒng)封裝技術(shù)以是否焊線來(lái)區(qū)分,先進(jìn)封裝技術(shù)包括FC BGA、FC QFN、2.5D/3D、WLCSP、Fan-Out等非焊線形式。先進(jìn)封裝技術(shù)在提升芯片性能方面展現(xiàn)的巨大優(yōu)勢(shì),吸引了全球各大主流IC封測(cè)廠商在先進(jìn)封裝領(lǐng)域的持續(xù)投資布局。
2019-08-31 11:42:30 4216
4216 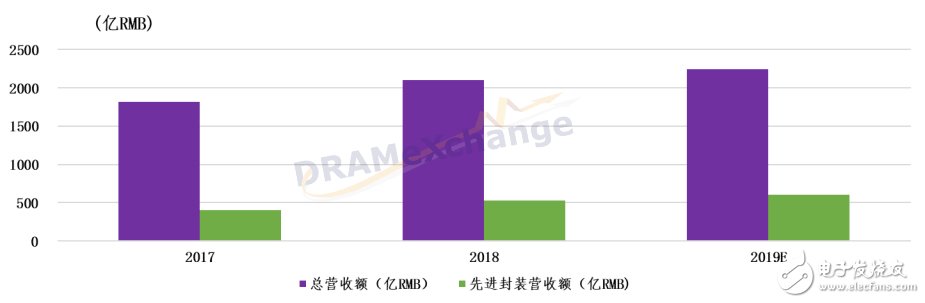
的芯片,透過(guò)多芯片封裝包在一起,以最短的時(shí)程推出符合市場(chǎng)需求的產(chǎn)品,就成為重要性持續(xù)水漲船高的技術(shù)顯學(xué)。 而這些先進(jìn)芯片封裝也成為超級(jí)電腦和人工智能的必備武器。別的不提,光論nVidia 和AMD 的高效能運(yùn)算專用GPU、
2020-10-10 17:24:13 1949
1949 技術(shù)發(fā)展方向 半導(dǎo)體產(chǎn)品在由二維向三維發(fā)展,從技術(shù)發(fā)展方向半導(dǎo)體產(chǎn)品出現(xiàn)了系統(tǒng)級(jí)封裝(SiP)等新的封裝方式,從技術(shù)實(shí)現(xiàn)方法出現(xiàn)了倒裝(FlipChip),凸塊(Bumping),晶圓級(jí)封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。
2020-10-12 11:34:36 15949
15949 
(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。 ▌ SoC vs.SiP ?SoC:全稱System-on-chip,系統(tǒng)級(jí)芯片
2020-10-21 11:03:11 28156
28156 
隨著5G通信、汽車電子等領(lǐng)域的發(fā)展,對(duì)集成電路的先進(jìn)封裝要求也更高,先進(jìn)封裝技術(shù)有望逐漸成為市場(chǎng)主流。根據(jù)中國(guó)半導(dǎo)體行業(yè)協(xié)會(huì)封裝分會(huì)統(tǒng)計(jì),當(dāng)前以TVS、WLCSP、SiP、3D、MCM等先進(jìn)技術(shù)在國(guó)內(nèi)封裝市場(chǎng)已經(jīng)占據(jù)了超三成的市場(chǎng)份額。
2020-11-23 10:09:20 2589
2589 臺(tái)積電和三星于先進(jìn)封裝的戰(zhàn)火再起。2020年,三星推出3D封裝技術(shù)品牌X-Cube,宣稱在7納米芯片可直接堆上SRAM內(nèi)存,企圖在先進(jìn)封裝拉近與臺(tái)積電的距離。幾天之后,臺(tái)積電總裁魏哲家現(xiàn)身,宣布推出自有先進(jìn)封裝品牌3D Fabric,臺(tái)積電最新的SoIC(系統(tǒng)集成芯片)備受矚目。
2021-01-04 10:37:09 1269
1269 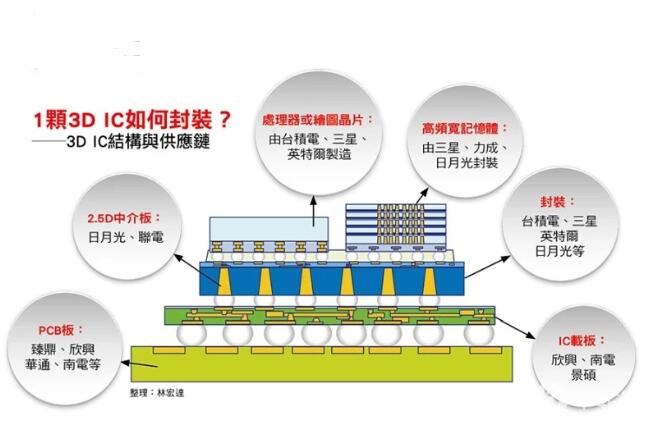
據(jù)彭博社今日下午報(bào)道,繼赴美建設(shè)5nm晶圓代工廠后,全球晶圓代工龍頭臺(tái)積電正計(jì)劃赴日本建設(shè)先進(jìn)封裝廠。如果消息屬實(shí),這將是臺(tái)積電首座位于海外的封測(cè)廠。
2021-01-06 12:06:16 1804
1804 作為華天集團(tuán)晶圓級(jí)先進(jìn)封裝基地,華天昆山2008年6月落戶昆山開發(fā)區(qū),研發(fā)的晶圓級(jí)傳感器封裝技術(shù)、扇出型封裝技術(shù)、超薄超小型晶圓級(jí)封裝、晶圓級(jí)無(wú)源器件制造技術(shù)目前已達(dá)到世界領(lǐng)先水平。
2021-01-09 10:16:09 4166
4166 先進(jìn)封裝大部分是利用「晶圓廠」的技術(shù),直接在晶圓上進(jìn)行,由于這種技術(shù)更適合晶圓廠來(lái)做,因此臺(tái)積電大部分的先進(jìn)封裝都是自己做的。
2021-02-22 11:45:21 2200
2200 
一項(xiàng)技術(shù)能從相對(duì)狹窄的專業(yè)領(lǐng)域變得廣為人知,有歷史的原因,也離不開著名公司的推波助瀾,把SiP帶給大眾的是蘋果(Apple),而先進(jìn)封裝能引起公眾廣泛關(guān)注則是因?yàn)榕_(tái)積電(TSMC)。 蘋果
2021-04-01 16:07:24 32556
32556 
在5G應(yīng)用相關(guān)的眾多封裝技術(shù)中,倒裝芯片技術(shù)的應(yīng)用需求越來(lái)越廣泛,隨之而來(lái)的是對(duì)底部填充材料提出了更高的要求,既要確保保護(hù)蓋或強(qiáng)化件與基材的良好粘合,又要減少芯片和封裝體在熱負(fù)荷下會(huì)發(fā)生翹曲的影響。
2021-04-08 16:22:43 4648
4648 最近,關(guān)于臺(tái)積電的先進(jìn)封裝有很多討論,讓我們透過(guò)他們的財(cái)報(bào)和最新的技術(shù)峰會(huì)來(lái)對(duì)這家晶圓代工巨頭的封裝進(jìn)行深入的介紹。 資料顯示,在張忠謀于2011年重返公司之后,就下定決定要做先進(jìn)封裝。而1994
2021-06-18 16:11:50 3699
3699 半導(dǎo)體行業(yè)已經(jīng)基本實(shí)現(xiàn)分工精細(xì)化,產(chǎn)業(yè)鏈主要由設(shè)計(jì)、生產(chǎn)、封測(cè)等環(huán)節(jié)組成。先進(jìn)封裝推動(dòng)前后道工藝相互滲透融合,具有較高技術(shù)壁壘和技術(shù)積累的廠商會(huì)向上下游工序延伸。
2022-04-27 11:42:13 11058
11058 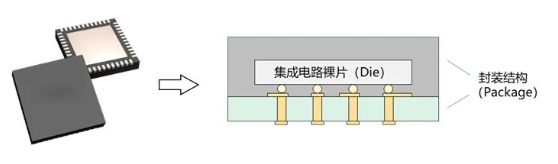
先進(jìn)封裝技術(shù)FC/WLCSP的應(yīng)用與發(fā)展分析。
2022-05-06 15:19:12 24
24 先進(jìn)封裝形式μBGA、CSP的回流焊接技術(shù)介紹說(shuō)明。
2022-05-06 15:17:46 4
4 2021年對(duì)于先進(jìn)封裝行業(yè)來(lái)說(shuō)是豐收一年,現(xiàn)在包括5G、汽車信息娛樂/ADAS、人工智能、數(shù)據(jù)中心和可穿戴應(yīng)用在內(nèi)的大趨勢(shì)繼續(xù)迫使芯片向先進(jìn)封裝發(fā)展。2021年先進(jìn)封裝市場(chǎng)總收入為321億美元,預(yù)計(jì)
2022-06-13 14:01:24 2047
2047 預(yù)計(jì)2024年,全球先進(jìn)封裝市場(chǎng)達(dá)440億元。先進(jìn)封裝設(shè)備貼片機(jī)升級(jí)成封裝廠商投資重點(diǎn)。
2022-06-13 17:08:02 2381
2381 通富微電、華天科技也表示已儲(chǔ)備Chiplet相關(guān)技術(shù)。Chiplet是先進(jìn)封裝技術(shù)之一,除此以外,先進(jìn)封裝概念股也受到市場(chǎng)關(guān)注。4連板大港股份表示已儲(chǔ)備TSV、micro-bumping(微凸點(diǎn))和RDL等先進(jìn)封裝核心技術(shù)。
2022-08-08 12:01:23 1048
1048 近年來(lái),先進(jìn)封裝技術(shù)的內(nèi)驅(qū)力已從高端智能手機(jī)領(lǐng)域演變?yōu)楦咝阅苡?jì)算和人工智能等領(lǐng)域,涉及高性能處理器、存儲(chǔ)器、人工智能訓(xùn)練和推理等。當(dāng)前集成電路的發(fā)展受“四堵墻”(“存儲(chǔ)墻”“面積墻”“功耗
2022-12-28 14:16:29 3295
3295 SiP是一個(gè)非常寬泛的概念,廣義上看,它囊括了幾乎所有多芯片封裝技術(shù),但就最先進(jìn)SiP封裝技術(shù)而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及異構(gòu)Chiplet封裝技術(shù)。
2023-03-20 09:51:54 1037
1037 
難以在全球化的先進(jìn)制程中分一杯羹,手機(jī)、HPC等需要先進(jìn)制程的芯片供應(yīng)受到嚴(yán)重阻礙,亟需另辟蹊徑。而先進(jìn)封裝/Chiplet等技術(shù),能夠一定程度彌補(bǔ)先進(jìn)制程的缺失,用面積和堆疊換取算力和性能。
2023-04-15 09:48:56 1953
1953 SiP系統(tǒng)級(jí)封裝(System in Package),先進(jìn)封裝HDAP(High Density Advanced Package),兩者都是當(dāng)今芯片封裝技術(shù)的熱點(diǎn),受到整個(gè)半導(dǎo)體產(chǎn)業(yè)鏈的高度關(guān)注
2023-05-19 09:54:26 1326
1326 
先進(jìn)封裝是對(duì)應(yīng)于先進(jìn)圓晶制程而衍生出來(lái)的概念,一般指將不同系統(tǒng)集成到同一封裝內(nèi)以實(shí)現(xiàn)更高效系統(tǒng)效率的封裝技術(shù)。
2023-06-13 11:33:24 282
282 
一、核心結(jié)論 ?1、先進(jìn)制程受限,先進(jìn)封裝/Chiplet提升算力,必有取舍。在技術(shù)可獲得的前提下,提升芯片性能,先進(jìn)制程升級(jí)是首選,先進(jìn)封裝則錦上添花。 2、大功耗、高算力的場(chǎng)景,先進(jìn)封裝
2023-06-13 11:38:05 747
747 
隨著摩爾定律的放緩以及前沿節(jié)點(diǎn)復(fù)雜性和成本的增加,先進(jìn)封裝正在成為將多個(gè)裸片集成到單個(gè)封裝中的關(guān)鍵解決方案,并有可能結(jié)合成熟和先進(jìn)的節(jié)點(diǎn)。
2023-06-16 17:50:09 340
340 
Fab 6 是臺(tái)積電首個(gè)一體式先進(jìn)封裝測(cè)試工廠,是臺(tái)積電不斷增加的封裝投資的一部分。該晶圓廠已準(zhǔn)備好量產(chǎn)臺(tái)積電 SoIC 封裝技術(shù)。請(qǐng)記住,當(dāng)臺(tái)積電說(shuō)量產(chǎn)時(shí),他們指的是 Apple iPhone 尺寸的量產(chǎn),而不是工程樣品或內(nèi)部產(chǎn)品。
2023-06-19 11:25:56 219
219 
緊密相連。在業(yè)界,先進(jìn)封裝技術(shù)與傳統(tǒng)封裝技術(shù)以是否焊線來(lái)區(qū)分。先進(jìn)封裝技術(shù)包括FCBGA、FCQFN、2.5D/3D、WLCSP、Fan-Out等非焊線形式。先進(jìn)
2022-04-08 16:31:15 641
641 
在異質(zhì)異構(gòu)的世界里,chiplet是“生產(chǎn)關(guān)系”,是決定如何拆分及組合芯粒的方式與規(guī)則;先進(jìn)封裝技術(shù)是“生產(chǎn)力”,通過(guò)堆疊、拼接等方法實(shí)現(xiàn)不同芯粒的互連。先進(jìn)封裝技術(shù)已成為實(shí)現(xiàn)異質(zhì)異構(gòu)的重要前提。
2023-06-26 17:14:57 601
601 1. 先進(jìn)制程受限,先進(jìn)封裝/Chiplet提升算力,必有取舍。
2023-07-07 09:42:04 1693
1693 
Chiplet技術(shù)是一種利用先進(jìn)封裝方法將不同工藝/功能的芯片進(jìn)行異質(zhì)集成的技術(shù)。這種技術(shù)設(shè)計(jì)的核心思想是先分后合,即先將單芯片中的功能塊拆分出來(lái),再通過(guò)先進(jìn)封裝模塊將其集成為大的單芯片。
2023-07-17 09:21:50 2309
2309 
隨著chatGPT橫空出世,生成式AI紅遍全球,帶動(dòng)AI芯片的需求強(qiáng)勁,英偉達(dá)(NVIDIA)的H100、A100全部由臺(tái)積電代工,并使用臺(tái)積電的CoWoS先進(jìn)封裝技術(shù),除了英偉達(dá)外,AMD MI300也導(dǎo)入CoWoS技術(shù),造成CoWoS產(chǎn)能供不應(yīng)求。
2023-07-31 12:49:24 2216
2216 level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。
2023-08-05 09:54:29 398
398 
半導(dǎo)體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級(jí)封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標(biāo)一代比一代先進(jìn)。
2023-08-11 09:43:43 1796
1796 
半導(dǎo)體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類可分為引腳插入型、表面貼裝型和高級(jí)封裝三類。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標(biāo)一代比一代先進(jìn)。
2023-08-14 09:59:17 1086
1086 
(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。免責(zé)聲明:本文轉(zhuǎn)自網(wǎng)絡(luò),版權(quán)歸原作者所有,如涉及作品版權(quán)問(wèn)題,
2023-08-14 09:59:24 457
457 
隨著芯片制造持續(xù)往更小的制程節(jié)點(diǎn)邁進(jìn),晶圓代工廠利用先進(jìn)封裝技術(shù)直接封裝晶片的模式乃應(yīng)運(yùn)而生。不過(guò),此模式也意味著晶圓代工廠將攫取傳統(tǒng)封測(cè)廠的部分業(yè)務(wù),所以自從臺(tái)積電于 2011 年宣布進(jìn)軍先進(jìn)封裝領(lǐng)域之后,其對(duì)于傳統(tǒng)封測(cè)廠的“威脅論”就不曾間斷,那么此說(shuō)法是否屬實(shí)呢?
2023-08-23 16:33:57 613
613 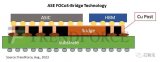
先進(jìn)封裝增速高于整體封裝,將成為全球封裝市場(chǎng)主要增量。根據(jù)Yole的數(shù)據(jù),全球封裝市場(chǎng)規(guī)模穩(wěn)步增長(zhǎng),2021 年全球封裝 市場(chǎng)規(guī)模 約達(dá) 777 億美元。其中,先進(jìn)封裝全球市場(chǎng)規(guī)模約 350 億美元,占比約 45%, 2025 年,先進(jìn)封裝在全部封裝市場(chǎng)的 占比將增長(zhǎng)至 49.4%。
2023-09-22 10:43:18 1189
1189 
先進(jìn)封裝技術(shù)以SiP、WLP、2.5D/3D為三大發(fā)展重點(diǎn)。先進(jìn)封裝核心技術(shù)包括Bumping凸點(diǎn)、RDL重布線、硅中介層和TSV通孔等,依托這些技術(shù)的組合各廠商發(fā)展出了滿足多樣化需求的封裝解決方案,SiP系統(tǒng)級(jí)封裝、WLP晶圓級(jí)封裝、2.5D/3D封裝為三大發(fā)展重點(diǎn)。
2023-09-28 15:29:37 1614
1614 
此時(shí)先進(jìn)封裝開始嶄露頭角,以蘋果和臺(tái)積電為代表,開啟了一場(chǎng)新的革命,其主要分為兩大類,一種是基于XY平面延伸的先進(jìn)封裝技術(shù),主要通過(guò)RDL進(jìn)行信號(hào)的延伸和互連;第二種則是基于Z軸延伸的先進(jìn)封裝技術(shù),主要通過(guò)TSV進(jìn)行信號(hào)延伸和互連。
2023-10-10 17:04:30 573
573 
半導(dǎo)體產(chǎn)品在由二維向三維發(fā)展,從技術(shù)發(fā)展方向半導(dǎo)體產(chǎn)品出現(xiàn)了系統(tǒng)級(jí)封裝(SiP)等新的封裝方式,從技術(shù)實(shí)現(xiàn)方法出現(xiàn)了倒裝(FlipChip),凸塊(Bumping),晶圓級(jí)封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。
2023-10-31 09:16:29 836
836 
近年來(lái),隨著晶圓級(jí)封裝技術(shù)的不斷提升,眾多芯片設(shè)計(jì)及封測(cè)公司開始思考并嘗試采用晶圓級(jí)封裝技術(shù)替代傳統(tǒng)封裝。其中HRP(Heat Re-distribution Packaging)晶圓級(jí)先進(jìn)封裝工藝技術(shù)
2023-11-18 15:26:58 0
0 先進(jìn)封裝基本術(shù)語(yǔ)
2023-11-24 14:53:10 362
362 
相比于晶圓制造,中國(guó)大陸封測(cè)環(huán)節(jié)較為成熟,占據(jù)全球封測(cè)接近40%的份額,但中國(guó)大陸先進(jìn)封裝的滲透率較低,2022年僅為14%,低于全球45%的滲透率。在制程工藝受到外部制裁的背景下
2023-11-25 15:44:25 740
740 先進(jìn)的封裝技術(shù)可以將多個(gè)半導(dǎo)體芯片和組件集成到高性能的系統(tǒng)中。隨著摩爾定律的縮小趨勢(shì)面臨極限,先進(jìn)封裝為持續(xù)改善計(jì)算性能、節(jié)能和功能提供了一條途徑。但是,與亞洲相比,美國(guó)目前在先進(jìn)封裝技術(shù)方面落后
2023-12-14 10:27:14 383
383 
level package),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。 審核編輯 黃宇
2024-02-21 10:34:20 178
178 
)和集成電路的飛速發(fā)展,人工智能芯片逐漸成為全球科技競(jìng)爭(zhēng)的焦點(diǎn)。在后摩爾時(shí)代,AI 芯片的算力提升和功耗降低越來(lái)越依靠具有硅通孔、微凸點(diǎn)、異構(gòu)集成、Chiplet等技術(shù)特點(diǎn)的先進(jìn)封裝技術(shù)。從 AI 芯片的分類與特點(diǎn)出發(fā),對(duì)國(guó)內(nèi)外典型先進(jìn)封裝技術(shù)
2024-03-04 18:19:18 582
582 

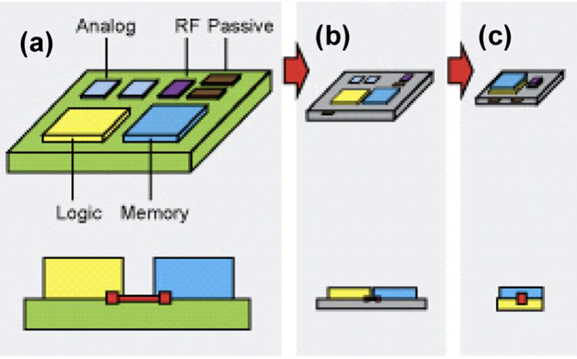
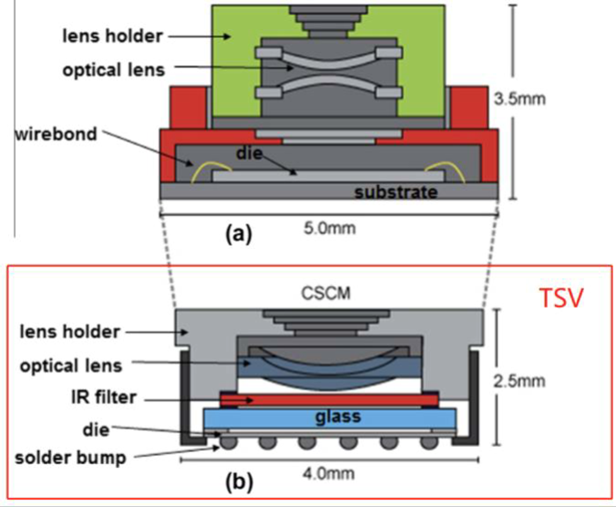
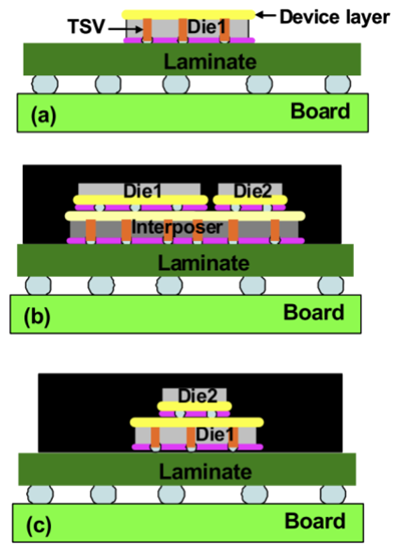
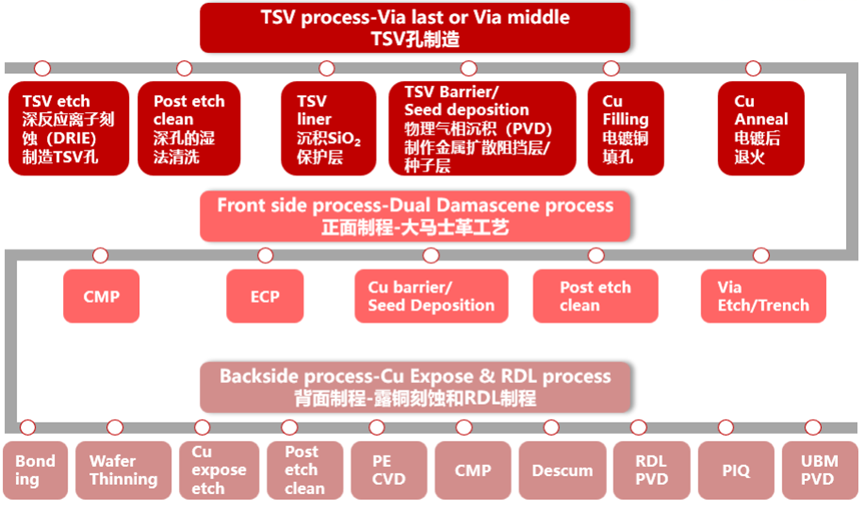

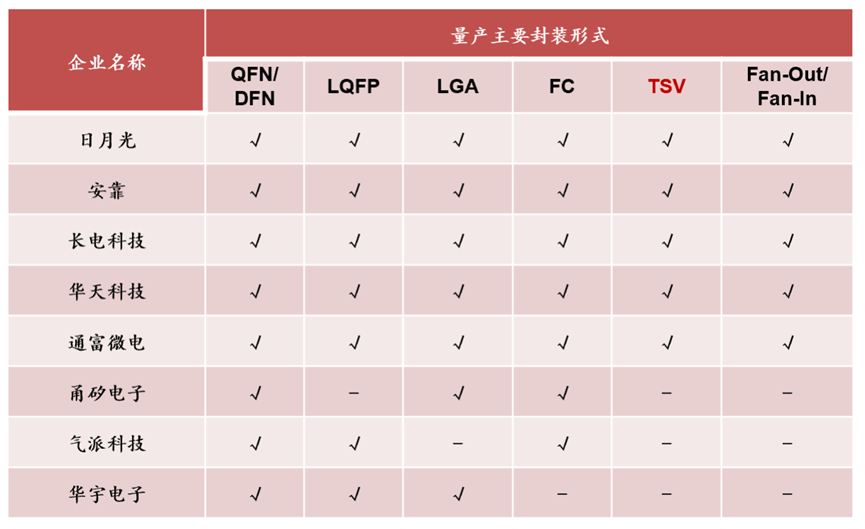
 電子發(fā)燒友App
電子發(fā)燒友App
































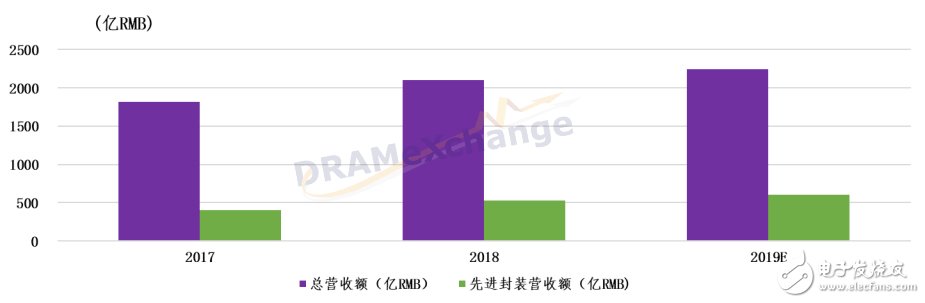


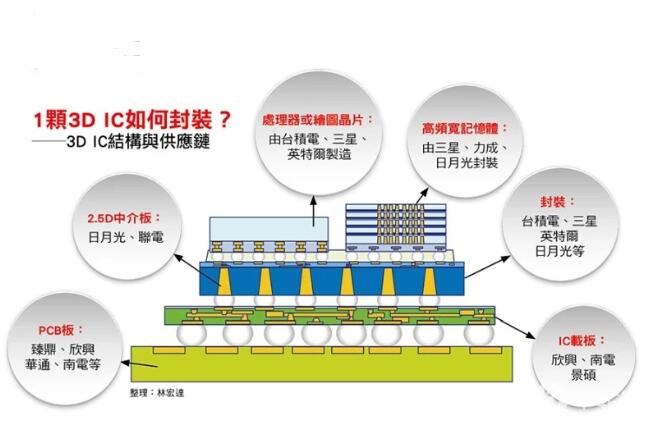


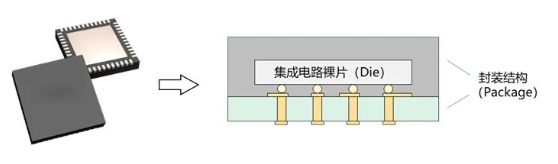












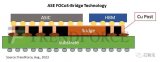


















評(píng)論