直拉硅單晶生長的過程是熔融的多晶硅逐漸結晶生長為固態的單晶硅的過程,沒有雜質的本征硅單晶的電阻率很高....

在半導體制造流程中����,晶圓在前端工藝階段需保持一定厚度����,以確保其在流片過程中的結構穩定性��,避免彎曲變形....
Plating(電鍍)是一種電化學過程,通過此過程在基片(wafer)表面沉積金屬層��。在微電子領域�����,....
隨著極紫外光刻(EUV)技術面臨光源功率和掩模缺陷挑戰�����,X射線光刻技術憑借其固有優勢,在特定領域正形....

本文介紹了通過LPCVD制備氮化硅低應力膜 氮化硅膜在MEMS中應用十分廣泛�����,可作為支撐層����、....
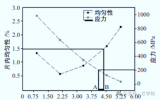
CPU Socket是連接中央處理單元(CPU)與計算機主板之間的關鍵部件,它充當著傳遞電信號����、電源....
半導體的典型封裝工藝流程包括芯片減薄�����、芯片切割、芯片貼裝��、芯片互連����、成型固化、去飛邊毛刺�����、切筋成型����、....

當激光器導通時,開始產生自發輻射的光子直到載流子密度超過一個閾值��。因而�����,產生受激輻射�����,也就是說,真實....
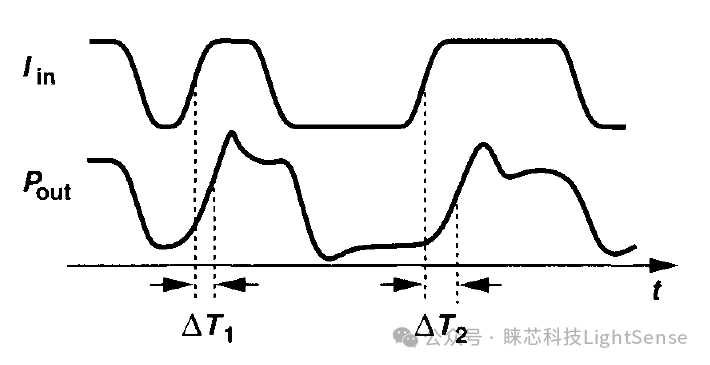
圓片級封裝(WLP)�����,也稱為晶圓級封裝�����,是一種直接在晶圓上完成大部分或全部封裝測試程序����,再進行切割制....

計量學是推動當前及未來幾代半導體器件開發與制造的重要基石����。隨著技術節點不斷縮小至100納米�����,甚至更小....
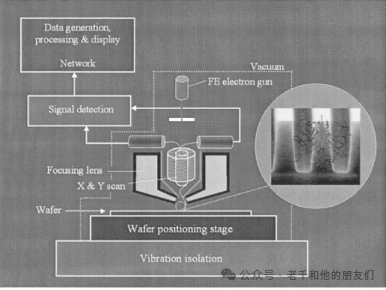
晶圓制備是材料科學����、熱力學與精密控制的綜合體現��,每一環節均凝聚著工程技術的極致追求��。而晶圓清洗本質是....

在半導體存儲器測試中,測試圖形(Test Pattern)是檢測故障����、驗證可靠性的核心工具����。根據測試....

本文介紹了在芯片銅互連工藝中需要阻擋層的原因以及關鍵工藝流程����。
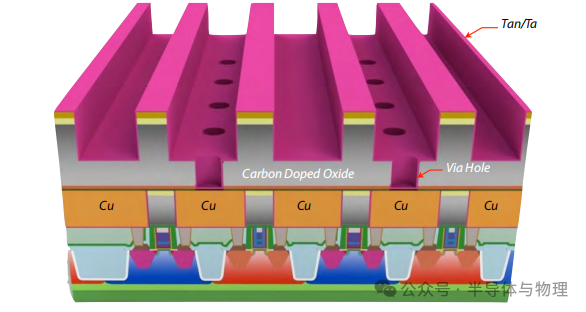
選擇性外延生長(SEG)是當今關鍵的前端工藝(FEOL)技術之一,已在CMOS器件制造中使用了20年....

在半導體制造流程中,晶圓揀選測試(Wafer Sort)堪稱芯片從“原材料”到“成品”的關鍵質控節點....

本文系統梳理了直寫式�����、多電子束與投影式EBL的關鍵技術路徑��,涵蓋掃描策略�����、束流整形、鄰近效應校正與系....
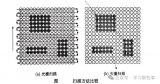
本文總結了FPGA選型的核心原則和流程,旨在為設計人員提供決策依據,確保項目成功�����。
光刻膠類型及特性光刻膠(Photoresist)��,又稱光致抗蝕劑,是芯片制造中光刻工藝的核心材料�����。其....

微管是SiC晶體中極為有害的缺陷,哪怕數量極少,也會對SiC器件的性能產生毀滅性打擊。在傳統物理氣相....

本文介紹了6G技術的關鍵技術之一:通訊非地面網絡��。

本文簡單介紹了芯片離子注入后退火會引入的工藝問題:射程末端(EOR)缺陷�����、硼離子注入退火問題和磷離子....

芯片�����,是人類科技的精華,也被稱為現代工業皇冠上的明珠。芯片的基本組成是晶體管�����。晶體管的基本工作原理其....

裝片工序完成后��,芯片雖已穩固于載體(基板或框架)之上�����,但其表面預設的焊盤尚未與封裝體構建電氣連接,因....

張量處理單元(TPU����,Tensor Processing Unit)是一種專門為深度學習應用設計的硬....
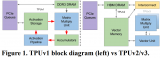
本文介紹了倒裝芯片鍵合技術的特點和實現過程以及詳細工藝等��。

文介紹了高壓CMOS技術與基礎CMOS技術的區別與其應用場景�����。
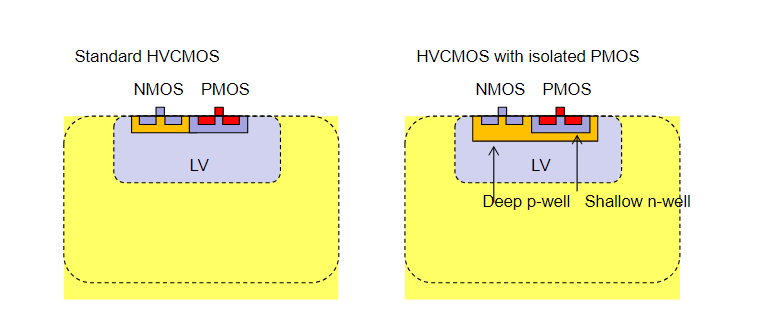
激光劃片作為新興材料加工技術����,近年來憑借非接觸式加工特性實現快速發展�����。其工作機制是將高峰值功率激光束....
本文介紹了用抗反射涂層來保證光刻精度的原理�����。
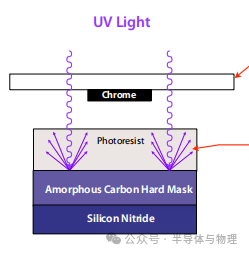
SiC的物理特性決定了其生長難度。在常壓環境下�����,SiC并無熔點����,一旦溫度攀升至2000℃以上,便會直....
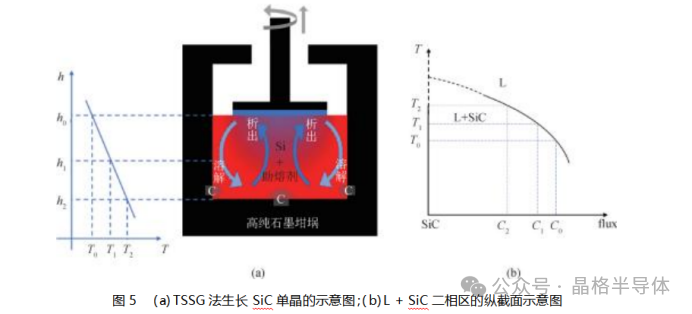
裝片(Die Bond)作為半導體封裝關鍵工序�����,指通過導電或絕緣連接方式����,將裸芯片精準固定至基板或引....