3D集成是實(shí)現(xiàn)多芯片異構(gòu)集成解決方案的關(guān)鍵技術(shù),是業(yè)界對(duì)系統(tǒng)級(jí)更高功耗、性能、面積和成本收益需求的回應(yīng)。3D 堆疊正在電子系統(tǒng)層次結(jié)構(gòu)的不同級(jí)別(從封裝級(jí)到晶體管級(jí))引入。因此,多年來(lái)已經(jīng)開發(fā)出多種
2024-02-22 09:42:29 1883
1883 
,發(fā)展情況持續(xù)向好。美能3D共聚焦顯微鏡,可通過非接觸式掃描電池表面并建立表面3D圖像,對(duì)柵線的高度與寬度、絨面上的金字塔數(shù)量進(jìn)行定量檢測(cè),以反饋其中的清洗制絨、柵線
2024-03-21 08:32:19 2498
2498 
銅引線鍵合由于在價(jià)格、電導(dǎo)率和熱導(dǎo)率等方面的優(yōu)勢(shì)有望取代傳統(tǒng)的金引線鍵合, 然而 Cu/Al 引線鍵合界面的金屬間化合物 (intermetallic compounds, IMC) 的過量生長(zhǎng)將增大接觸電阻和降低鍵合強(qiáng)度, 從而影響器件的性能和可靠性。
2025-03-01 15:00:09 1139
1139 
所謂混合鍵合(hybrid bonding),指的是將兩片以上不相同的Wafer或Die通過金屬互連的混合鍵合工藝,來(lái)實(shí)現(xiàn)三維集成,在Hybrid Bonding前,2D,2.5D及3D封裝都是采用
2025-06-03 11:35:24 561
561 
電子發(fā)燒友網(wǎng)綜合報(bào)道,據(jù)韓媒報(bào)道,三星近日與長(zhǎng)江存儲(chǔ)簽署了3D NAND混合鍵合專利許可協(xié)議,從第10代V-NAND開始,將使用長(zhǎng)江存儲(chǔ)的專利技術(shù),特別是在“混合鍵合”技術(shù)方面。 ? W2W技術(shù)是指
2025-02-27 01:56:00 686
686 
客戶對(duì)HBM的要求為增加帶寬、提高功率效率、提高集成度。混合鍵合就是可以滿足此類需求的技術(shù)。 ? 混合鍵合技術(shù)預(yù)計(jì)不僅可應(yīng)用于HBM,還可應(yīng)用于3D DRAM和NAND Flash。SK海力士副總裁姜志浩(音譯)表示,“目前的做法是分別創(chuàng)建DRAM單元區(qū)域和外圍區(qū)域,
2025-04-17 00:05:00 518
518 電子發(fā)燒友綜合報(bào)道 ?作為HBM和3D NAND的核心技術(shù)之一,混合鍵合在近期受到很多關(guān)注,相關(guān)設(shè)備廠商尤其是國(guó)產(chǎn)設(shè)備廠商的市場(chǎng)前景巨大。那么混合鍵合是什么? ? 混合鍵合是一種結(jié)合介電層鍵合和金
2025-06-03 09:02:18 1615
1615 求大神賜個(gè)全面的3D PCB封裝庫(kù)(PCB封裝附帶3D模型)!!!~
2015-08-06 19:08:43
的減輕產(chǎn)品重量呢?采用新型的塑料成型技術(shù):3D混合制造 可以到達(dá)要求,3D混合制造步驟是3D打印成型/激光LDS選擇性沉積金屬。采用這種工藝的好處是節(jié)省了制造時(shí)間和實(shí)現(xiàn)了復(fù)雜的饋源/波導(dǎo)等器件的一體化免安裝調(diào)試,且?guī)?lái)的另外好處是大幅度減輕了產(chǎn)品重量。下面舉例說(shuō)明:
2019-07-08 06:25:50
`2D工程圖紙,難以高效轉(zhuǎn)化成3D模型數(shù)據(jù)?多CAD格式混合設(shè)計(jì),難以進(jìn)行標(biāo)準(zhǔn)化?大量舊版本圖紙堆積,難以實(shí)現(xiàn)數(shù)據(jù)重用?浩辰3D制圖軟件不僅具備支持主流3D原生和通用文件的導(dǎo)入,對(duì)數(shù)據(jù)進(jìn)行直接編輯
2021-02-24 17:22:41
電子發(fā)燒友網(wǎng)訊【編譯/Triquinne】:或許,有一天醫(yī)療設(shè)備公司能使用3D打印機(jī)迅速地打印出從定制植入設(shè)備到微針尖陣列微量藥物輸送執(zhí)行器等一系列的產(chǎn)品。但據(jù)專家分析,這項(xiàng)技術(shù)還未
2012-12-08 00:07:55
S800的愛司凱科技股份有限公司,就走在了行業(yè)前列。多年來(lái),愛司凱科技股份有限公司致力于開發(fā)用于工業(yè)級(jí)生產(chǎn)的大型3D打印機(jī),采用3DP的方式將工業(yè)生產(chǎn)中制摸工藝及效率大大提升,生產(chǎn)周期從幾個(gè)月縮短到
2018-08-11 11:25:58
3D打印將精準(zhǔn)的數(shù)字技術(shù)、工廠的可重復(fù)性和工匠的設(shè)計(jì)自由結(jié)合在一起,解放了人類創(chuàng)造東西的能力。本文是對(duì)當(dāng)下3D打印技術(shù)帶來(lái)便利的總結(jié),節(jié)選自中信出版社《3D打印:從想象到現(xiàn)實(shí)》一書。虎嗅會(huì)繼續(xù)摘編該書精華。
2019-07-09 07:02:03
3D顯示技術(shù)的原理是什么?3D顯示技術(shù)有哪些應(yīng)用?3D拍好了到底怎么樣傳輸?
2021-05-31 06:53:03
good,3d封裝,感謝樓主無(wú)償奉獻(xiàn)!!
2015-06-22 10:35:56
不同于以往的立體聲、環(huán)繞聲概念,所謂3D全息聲音技術(shù),就是通過音箱排列而成的陣列來(lái)對(duì)聲音進(jìn)行還原,重現(xiàn)最自然、最真實(shí)的聲場(chǎng)環(huán)境。舉個(gè)最簡(jiǎn)單的例子:在3D電影里,常常會(huì)出現(xiàn)物體從銀幕飛到觀眾眼前的鏡頭
2013-04-16 10:39:41
`新用AD軟件,需要用到一個(gè)散熱器的3D封裝,聽別人提起過AD14版本的可以制作簡(jiǎn)單的.step文件,試了一下在PCB文件中放置3D原件對(duì)話框是可以生成3D模型的,但問題是這個(gè)模型我文件另存為后再導(dǎo)入到封裝庫(kù)中沒法使用啊(坐標(biāo)無(wú)法調(diào)整),各位大神有沒有好的辦法麻煩指點(diǎn)一下。`
2017-12-10 00:10:33
`AD16的3D封裝庫(kù)問題以前采用封裝庫(kù)向?qū)傻?b class="flag-6" style="color: red">3D元件庫(kù),都有芯片管腳的,如下圖:可是現(xiàn)在什么設(shè)置都沒有改變,怎么生成的3D庫(kù)就沒有管腳了呢?請(qǐng)問是什么原因?需要怎么處理,才能和原來(lái)一樣?謝謝!沒管腳的就是下面的樣子:`
2019-09-26 21:28:33
如題,軟件版本為AD16,問題1:PCB文件是原畫好出過生產(chǎn)文件的,現(xiàn)在需要改版,修改原有鋪銅時(shí)很慢,會(huì)出現(xiàn)圖中對(duì)話框。重新鋪銅就不會(huì)出現(xiàn)這種情況。問題2:同一文件導(dǎo)出3D文件和CAD文件都比原來(lái)
2022-04-30 12:17:45
模擬這些進(jìn)程,如何有效且迅速完成實(shí)物和模型之間的模擬,不但是現(xiàn)代工業(yè)面臨的問題,也是所有行業(yè)亟待解決問題。 “模擬”在工業(yè)中的運(yùn)用 現(xiàn)階段,我們使用的模擬技術(shù)主要是3D建模技術(shù)。因?yàn)樵诂F(xiàn)代工業(yè)制造中
2017-03-17 10:21:34
給PCB添加了3D模型之后,讓封裝旋轉(zhuǎn)45度,自己填加的3D模型旋轉(zhuǎn)45度后,代表3D模型的機(jī)械層不會(huì)和PCB重合;而用封裝向?qū)М嫷哪P蜁?huì)和PCB重合。請(qǐng)問這個(gè)改怎么解決?雖然旋轉(zhuǎn)45度之后,在3D 模式下,3D圖也是旋轉(zhuǎn)了45度,但是在2D模式下的機(jī)械層看著很不舒服。
2017-07-20 22:46:11
,上下左右移動(dòng)鼠標(biāo),則3D顯示的板子會(huì)根據(jù)鼠標(biāo)的移動(dòng)沿著相應(yīng)的方向旋轉(zhuǎn);按下快捷鍵“2”,則從3D顯示狀態(tài)恢復(fù)到2D顯示狀態(tài)。按下快捷鍵“L”可以打開如下圖所示的PCB3D顯示設(shè)置對(duì)話框,可以根據(jù)板子
2019-07-05 08:00:00
。使用軟焊可以消除應(yīng)力,卻要以熱疲勞和低強(qiáng)度為代價(jià),而硬焊具有高強(qiáng)度卻無(wú)法消除應(yīng)力。瞬態(tài)液相鍵合技術(shù)要求使用一個(gè)擴(kuò)散勢(shì)壘,以防止Si3N4襯底上的銅金屬化層與用來(lái)鍵合SiC芯片的Au層之間的互擴(kuò)散
2018-09-11 16:12:04
想請(qǐng)教一下大神們,allegro如何制作3D封裝庫(kù)的
2018-05-09 08:33:17
當(dāng)3D電影已成為影院觀影的首選,當(dāng)3D打印已普及到雙耳無(wú)線藍(lán)牙耳機(jī),一種叫“3D微波”的技術(shù)也悄然而生。初次聽到“3D微波”,你可能會(huì)一臉茫然,這個(gè)3D微波是應(yīng)用在哪個(gè)場(chǎng)景?是不是用這種技術(shù)的微波爐1秒鐘就能把飯煮熟?O M G!我覺得很有必要給大家科普一下!
2019-07-02 06:30:41
`求解如圖,我在AD16導(dǎo)入step文件后,在封裝庫(kù)能看到3D元件,但是更新到PCB后卻看不到3D模型`
2019-05-10 15:42:46
AD 在3D顯示下,怎么去除3D封裝的顯示,我只看焊盤,有時(shí)候封裝會(huì)遮掩底部的焊盤
2019-09-23 00:42:42
材料沉積和去除轉(zhuǎn)移,所使用的材料種類也大幅增加。另一方面,設(shè)備結(jié)構(gòu)和制程技術(shù)也實(shí)現(xiàn)了大幅創(chuàng)新,從氮氧化硅(SiON)到28/32nm高K值金屬柵極(HKMG),再到16/14nm 3D FinFET
2014-07-12 17:17:04
我用ALTIUM10 畫PCB封裝 從網(wǎng)上下載的3D模型怎么導(dǎo)入的時(shí)候顯示不了,前幾天還可以顯示 現(xiàn)在一個(gè)都顯示不了, 是不是弄錯(cuò)了, 手動(dòng)畫3D 又能顯示方塊模型 導(dǎo)入的時(shí)候就一點(diǎn)效果都沒有像沒有導(dǎo)入3D模型一樣, 求大師指點(diǎn)。
2016-07-12 22:48:20
芯片封裝鍵合技術(shù)各種微互連方式簡(jiǎn)介微互連技術(shù)簡(jiǎn)介定義:將芯片凸點(diǎn)電極與載帶的引線連接,經(jīng)過切斷、沖壓等工藝封裝而成。載帶:即帶狀載體,是指帶狀絕緣薄膜上載有由覆 銅箔經(jīng)蝕刻而形成的引線框架,而且芯片
2012-01-13 14:58:34
。另外,格芯還表示,因?yàn)楫?dāng)前的12納米工藝成熟穩(wěn)定,因此目前在3D空間上開發(fā)芯片更加容易,而不必?fù)?dān)心新一代 7 納米工藝所可能帶來(lái)的問題。從數(shù)據(jù)來(lái)看,據(jù)相關(guān)資料顯示,與傳統(tǒng)封裝相比,使用3D技術(shù)可縮短
2020-03-19 14:04:57
請(qǐng)問怎么將AD中的3D封裝庫(kù)轉(zhuǎn)換為2D的封裝庫(kù)
2019-06-05 00:35:07
放置鋪銅的快捷鍵是什么?
2019-08-22 01:32:23
三維(3D)掃描是一種功能強(qiáng)大的工具,可以獲取各種用于計(jì)量設(shè)備、檢測(cè)設(shè)備、探測(cè)設(shè)備和3D成像設(shè)備的體積數(shù)據(jù)。當(dāng)設(shè)計(jì)人員需要進(jìn)行毫米到微米分辨率的快速高精度掃描時(shí),經(jīng)常選擇基于TI DLP?技術(shù)的結(jié)構(gòu)光系統(tǒng)。
2019-08-06 08:09:48
無(wú)癢銅桿。鍍錫銅絞線(TJRX)采用電鍍錫工藝,具有耐腐蝕、耐熱及焊著性佳、避免氧化等。銅絞線采用高速籠絞機(jī)退扭絞合,絞合過程中采用工藝,絞合后的成品硬銅絞線圓整
2022-03-22 20:53:51
SuperViewW系列光學(xué)3d輪廓儀是一款用于對(duì)各種精密器件及材料表面進(jìn)行亞納米級(jí)測(cè)量的檢測(cè)儀器。可測(cè)各類從超光滑到粗糙、低反射率到高反射率的物體表面,從納米到微米級(jí)別工件的粗糙度、平整度、微觀
2022-04-19 17:53:02
中圖儀器3d輪廓儀品牌可測(cè)從納米到微米級(jí)別工件的粗糙度、平整度、微觀幾何輪廓、曲率等,以及各類從超光滑到粗糙、低反射率到高反射率的物體表面,提供依據(jù)ISO/ASME/EUR/GBT四大國(guó)內(nèi)外標(biāo)準(zhǔn)共計(jì)
2022-05-11 14:34:54
中圖儀器W系列3D表面輪廓光學(xué)檢測(cè)儀器基于白光干涉技術(shù)原理,結(jié)合精密Z向掃描模塊、3D 建模算法等,能對(duì)各種精密器件及材料表面進(jìn)行亞納米級(jí)測(cè)量,可測(cè)各類從超光滑到粗糙、低反射率到高反射率的物體
2023-09-27 11:37:06
SuperViewW1白光干涉技術(shù)3D測(cè)量輪廓儀是以白光干涉技術(shù)為原理,以3D非接觸方式,測(cè)量分析樣品表面形貌的關(guān)鍵參數(shù)和尺寸。可測(cè)各類從超光滑到粗糙、低反射率到高反射率的物體表面,從納米到微米級(jí)別
2024-05-16 14:36:05
中圖儀器SuperViewW微納米超精密3D光學(xué)形貌輪廓儀是一款用于對(duì)各種精密器件及材料表面進(jìn)行亞納米級(jí)測(cè)量的檢測(cè)儀器。可廣泛應(yīng)用于半導(dǎo)體制造及封裝工藝檢測(cè)、3C電子玻璃屏及其精密配件、光學(xué)加工、微
2024-08-05 16:04:54
高反射率的物體表面,從納米到微米級(jí)別工件的粗糙度、平整度、微觀幾何輪廓、曲率等。SuperViewW廣東3d光學(xué)非接觸式輪廓儀可廣泛應(yīng)用于半導(dǎo)體制造及封裝工藝檢測(cè)
2024-09-05 10:33:43
中圖儀器SuperViewW納米級(jí)白光3d表面輪廓檢測(cè)儀用于對(duì)各種精密器件及材料表面進(jìn)行亞納米級(jí)測(cè)量。它在半導(dǎo)體制造及封裝工藝檢測(cè)、3C電子玻璃屏及其精密配件、光學(xué)加工、微納材料及制造、汽車零部件
2024-10-21 14:25:00
對(duì)3D封裝技術(shù)結(jié)構(gòu)特點(diǎn)、主流多層基板技術(shù)分類及其常見鍵合技術(shù)的發(fā)展作了論述,對(duì)過去幾年國(guó)際上硅通孔( TSV)技術(shù)發(fā)展動(dòng)態(tài)給與了重點(diǎn)的關(guān)注。尤其就硅通孔關(guān)鍵工藝技術(shù)如硅片減薄
2011-12-07 11:00:52 152
152 3D元件封裝庫(kù)3D元件封裝庫(kù)3D元件封裝庫(kù)3D元件封裝庫(kù)
2016-03-21 17:16:57 0
0 實(shí)銅和網(wǎng)銅的區(qū)別。
2016-05-20 11:47:38 0
0 本通知的目的是宣布汽車“xa”spartan?-3/-3e/-3a/-3a DSP和spartan?6 FPGA產(chǎn)品從金(Au)線過渡到銅(Cu)線的所有線鍵合封裝類型。此更改不會(huì)影響包的適合性、形式、功能或MSL等級(jí)。
2019-02-14 16:19:00 4
4 應(yīng)用,新的TSV技術(shù)將于2019年上市,即來(lái)自英特爾(Intel)的Foveros(基于“有源”TSV中介層和3D SoC技術(shù),具有混合鍵合和TSV互連(可能)技術(shù))。Foveros的出現(xiàn)表明,雖然“TSV”受到了來(lái)自“無(wú)TSV”技術(shù)的挑戰(zhàn),但廠商仍然對(duì)它很有信心。
2019-02-15 10:42:19 7236
7236 
EV集團(tuán)將在SEMICON CHINA展出用于3D-IC封裝的突破性晶圓鍵合技術(shù) 較之上一代對(duì)準(zhǔn)系統(tǒng),GEMINI FB XT 熔融鍵合機(jī)上的全新 SmartView NT3 對(duì)準(zhǔn)系統(tǒng)可提升2-3
2019-03-05 14:21:36 2376
2376 新的BONDSCALE系統(tǒng)大大提升了晶圓鍵合的生產(chǎn)率;解決了IRDS路線圖中描述的晶體管邏輯電路擴(kuò)展和3D集成的問題 奧地利,圣弗洛里安,2019年3月12日面向MEMS、納米技術(shù)和半導(dǎo)體市場(chǎng)的晶圓
2019-03-12 14:24:45 2381
2381 從低密度的后通孔TSV 硅3D集成技術(shù),到高密度的引線混合鍵合或3D VSLI CoolCubeTM解決方案,研究人員發(fā)現(xiàn)許多開發(fā)新產(chǎn)品的機(jī)會(huì)。本文概述了當(dāng)前新興的硅3D集成技術(shù),討論了圖像傳感器
2020-01-16 09:53:00 1231
1231 據(jù)外媒報(bào)道,近日智利一家公司利用銅離子的殺菌特性生產(chǎn)出了一款銅口罩,抗菌性能比一般口罩更好。
2020-04-16 22:26:53 4118
4118 美國(guó)的復(fù)合材料和金屬3D打印機(jī)品牌Markforged發(fā)布了純銅3D打印耗材,將適配Metal X 金屬3D打印機(jī)。
2020-04-28 15:35:39 3153
3153 波蘭華沙大學(xué)的研究人員利用激光直接書寫(DLW)3D打印技術(shù)設(shè)計(jì)出了微米大小的鏡片。這種3D打印的透鏡可以在各種材料上制作,包括易碎的石墨烯類材料。
2020-05-18 23:36:59 4233
4233 有別于傳統(tǒng)的封裝技術(shù),TSMC-SoIC是以關(guān)鍵的銅到銅接合結(jié)構(gòu),搭配直通矽晶穿孔(TSV)以實(shí)現(xiàn)最先進(jìn)的3D IC技術(shù)。目前臺(tái)積電已完成TSMC-SoIC制程認(rèn)證,開發(fā)出微米級(jí)接合間距(bonding pitch)制程
2020-09-02 14:16:32 2116
2116 代工廠、設(shè)備供應(yīng)商、研發(fā)機(jī)構(gòu)等都在研發(fā)一種稱之為銅混合鍵合(Hybrid bonding)工藝,這項(xiàng)技術(shù)正在推動(dòng)下一代2.5D和3D封裝技術(shù)。
2020-10-10 15:24:32 7598
7598 
周南嘉團(tuán)隊(duì)將3D多材料打印技術(shù)引入芯片級(jí)高端制造領(lǐng)域,利用3D打印技術(shù)進(jìn)行三維高精度光電封裝、制造高頻無(wú)源器件,例如可將天線尺寸縮小到十微米至百微米級(jí)別。
2020-11-18 15:18:04 2908
2908 近日,西安紫光國(guó)芯半導(dǎo)體有限公司(以下簡(jiǎn)稱“紫光國(guó)芯”)在第63屆國(guó)際電子器件大會(huì)(IEDM 2020)上公開發(fā)表了技術(shù)論文——《采用3D混合鍵合技術(shù)具有34GB/s/1Gb帶寬和0.88pJ/b能
2021-01-26 16:00:14 6819
6819 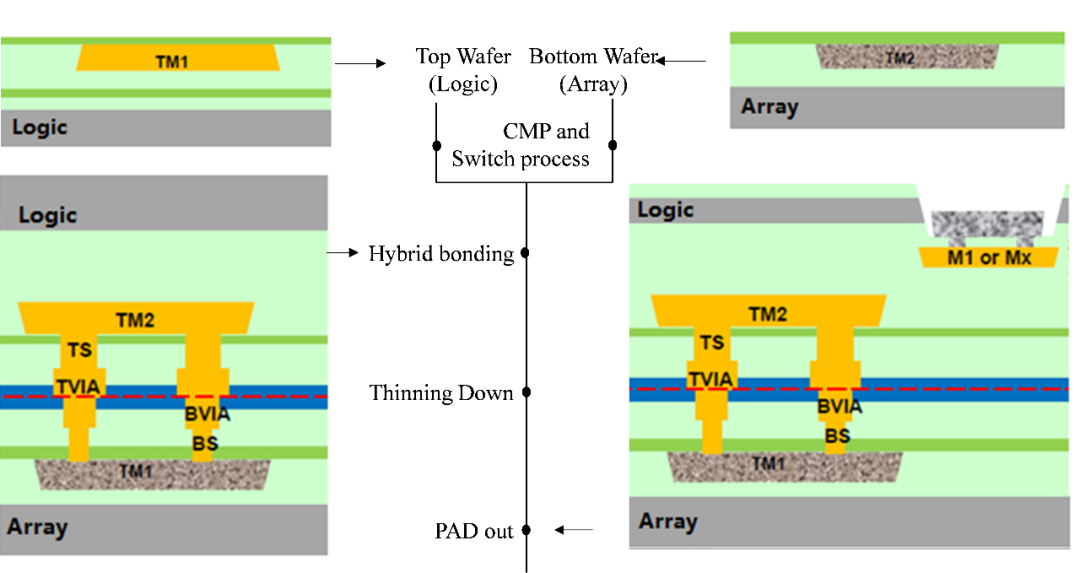
2021年2月27日,南極熊獲悉,工業(yè)3D打印機(jī)制造商Digital Metal宣布推出一種新的純銅粉末DM Cu,用于粘合劑噴射3D打印技術(shù)。 DM P2500 3D打印機(jī)的用戶現(xiàn)在可以在車
2021-03-01 10:10:25 2613
2613 音圈模組3D打印幫助孩子重塑面容。3D打印技術(shù)與醫(yī)學(xué)的額配合是越來(lái)越多了,近日,山東大學(xué)醫(yī)院口腔科成功為一5歲下頜骨骨折患兒實(shí)施3D打印個(gè)性化鈦板骨折內(nèi)固定手術(shù),使鈦釘進(jìn)入下頜骨的位置避開牙胚。手術(shù)順利,患兒恢復(fù)良好。
2021-08-24 16:55:58 790
790 MicroFAB-3D雙光子聚合3D納米光刻機(jī)是一款超緊湊、超高分辨率交鑰匙型3D打印機(jī)。雙光子聚合3D納米光刻機(jī)基于雙光子聚合(TPP)激光直寫技術(shù),兼容多種高分子材料,包括生物材料。MicroFAB-3D 3D納米光刻機(jī)幫助您以百納米級(jí)的分辨率生產(chǎn)出前所未有的復(fù)雜的微部件.
2022-08-08 13:54:18 7373
7373 
.,滿足介電常數(shù)(Dk)和介質(zhì)損耗因子(Df)技術(shù)指標(biāo)要求,功耗不增加。
我們推出的銅面鍵合劑替代傳統(tǒng)PCB中的銅中粗化,增強(qiáng)防焊,干濕膜的分離,另外不咬銅,不損銅,不增加銅表面的粗糙度,適合高頻板的生產(chǎn)。與此同時(shí)還不產(chǎn)生銅的廢水,環(huán)保
2022-11-11 17:49:30 3262
3262 使用 3D 納米打印
2022-12-28 09:51:07 1159
1159 使用久經(jīng)考驗(yàn)的銅夾片技術(shù)的經(jīng)驗(yàn),開發(fā)出創(chuàng)新的CCPAK。將銅夾片封裝技術(shù)的所有公認(rèn)優(yōu)點(diǎn)應(yīng)用于650 V及更高電壓應(yīng)用。
2023-02-09 09:51:58 1870
1870 
FSL已將消費(fèi)者1工業(yè)微控制器轉(zhuǎn)換為銅線和現(xiàn)在正在啟動(dòng)汽車改裝。
-金(金)和銅(銅)線都被用來(lái)連接到多年來(lái)集成電路上的鋁(AI)鍵墊金屬間化合物(IMC)的形成提供了電線和襯墊之間的粘著性。
-最近電線鍵合(WB)技術(shù)的進(jìn)步正在擴(kuò)大使用范圍銅線。
2023-03-08 14:30:00 994
994 在Hybrid Bonding前,2D,2.5D及3D封裝都是采用焊錫球凸點(diǎn)(solder bump)或微凸點(diǎn)(Micro bump)來(lái)實(shí)現(xiàn)芯片與基板
2023-04-20 09:40:16 19244
19244 設(shè)備由MEMS領(lǐng)域應(yīng)用轉(zhuǎn)化到3D集成技術(shù)領(lǐng)域,表現(xiàn)出高對(duì)準(zhǔn)精度特點(diǎn)。大多數(shù)對(duì)準(zhǔn)、鍵合工藝都源于微機(jī)電系統(tǒng)(MEMS)制造技術(shù),但應(yīng)用于3D集成的對(duì)準(zhǔn)精度要比傳統(tǒng)MEMS對(duì)準(zhǔn)精度提高5~10倍,目前設(shè)備對(duì)準(zhǔn)精度已經(jīng)達(dá)到亞微米級(jí)。
2023-04-20 11:47:22 6270
6270 兩片晶圓面對(duì)面鍵合時(shí)是銅金屬對(duì)銅金屬、介電值對(duì)介電質(zhì),兩邊鍵合介面的形狀、位置完全相同,晶粒大小形狀也必須一樣。所以使用混合鍵合先進(jìn)封裝技術(shù)的次系統(tǒng)產(chǎn)品各成分元件必須從產(chǎn)品設(shè)計(jì)、線路設(shè)計(jì)時(shí)就開始共同協(xié)作。
2023-05-08 09:50:30 1737
1737 研究人員首先對(duì)銀納米顆粒/銅納米線進(jìn)行了合成,并對(duì)制備的銅納米線和化學(xué)沉積后負(fù)載不同尺寸銀納米顆粒的銅納米線進(jìn)行了形貌和結(jié)構(gòu)表征(圖1)。隨后,利用制備的銀納米顆粒/銅納米線材料制備獲得銀納米顆粒/銅納米線電極,用于后續(xù)無(wú)酶葡萄糖傳感性能的研究。
2023-05-12 15:19:28 1924
1924 
的優(yōu)越性,概述了納米線、納米多孔骨 架、納米顆粒初步實(shí)現(xiàn)可圖形化的 Cu-Cu 低溫鍵合基本原理. 結(jié)果表明,基于納米材料燒結(jié)連接的基本原理,繼續(xù) 開發(fā)出寬工藝冗余、窄節(jié)距圖形化、優(yōu)良互連性能的 Cu-Cu 低溫鍵合技術(shù)是未來(lái)先進(jìn)封裝的重要發(fā)展方向之一.
2023-06-20 10:58:48 3455
3455 
在本文中,我們將討論混合鍵合的趨勢(shì)、混合鍵合面臨的挑戰(zhàn)以及提供最佳解決方案的工具。
2023-07-15 16:28:08 2391
2391 
相對(duì)于傳統(tǒng)平面型的金絲鍵合焊接的MMIC應(yīng)用,三維(3D)多芯片互連封裝MMIC以其高集成度、低損耗、高可靠性等性能優(yōu)勢(shì),正逐步在先進(jìn)電路與系統(tǒng)中得到應(yīng)用。而3D封裝引入的復(fù)雜電磁耦合效應(yīng),在傳統(tǒng)
2023-08-30 10:02:07 4530
4530 
先進(jìn)半導(dǎo)體封裝的凸塊技術(shù)已取得顯著發(fā)展,以應(yīng)對(duì)縮小接觸間距和傳統(tǒng)倒裝芯片焊接相關(guān)限制帶來(lái)的挑戰(zhàn)。該領(lǐng)域的一項(xiàng)突出進(jìn)步是 3D Cu-Cu 混合鍵合技術(shù),它提供了一種變革性的解決方案。
2023-09-21 15:42:29 1923
1923 要了解混合鍵合,需要了解先進(jìn)封裝行業(yè)的簡(jiǎn)要?dú)v史。當(dāng)電子封裝行業(yè)發(fā)展到三維封裝時(shí),微凸塊通過使用芯片上的小銅凸塊作為晶圓級(jí)封裝的一種形式,在芯片之間提供垂直互連。凸塊的尺寸范圍很廣,從 40 μm 間距到最終縮小到 20 μm 或 10 μm 間距。
2023-11-22 16:57:42 5951
5951 
中得到了廣泛的應(yīng)用。隨著3D封裝技術(shù)的發(fā)展,凸點(diǎn)鍵合技術(shù)也被應(yīng)用于芯片-芯片、芯片-圓片鍵合及封裝體的3D疊層封裝。
2023-12-05 09:40:00 2407
2407 
據(jù)業(yè)界消息人士透露,為了進(jìn)一步提升其芯片代工能力,三星正全力推進(jìn)混合鍵合技術(shù)的整合工作。據(jù)悉,應(yīng)用材料公司和Besi Semiconductor已在三星的天安園區(qū)開始安裝先進(jìn)的混合鍵合設(shè)備,這些設(shè)備預(yù)計(jì)將用于三星的下一代封裝解決方案,如X-Cube和SAINT。
2024-02-18 11:13:23 958
958 來(lái)源:IMEC Cu/SiCN鍵合技術(shù)的創(chuàng)新是由邏輯存儲(chǔ)器堆疊需求驅(qū)動(dòng)的 晶圓到晶圓混合鍵合的前景 3D集成是實(shí)現(xiàn)多芯片異構(gòu)集成解決方案的關(guān)鍵技術(shù),是業(yè)界對(duì)系統(tǒng)級(jí)更高功耗、性能、面積和成本收益需求
2024-02-21 11:35:29 928
928 
值得注意的是,Meta 的原型芯片分為上下兩部分,每個(gè)部分都只有 4.1x3.7 mm,其中的下部含有四個(gè)機(jī)器學(xué)習(xí)核心和 1 MB 本地內(nèi)存,上部則集成了 3 MB 內(nèi)存。通過采用臺(tái)積電 SoIC 高級(jí)封裝技術(shù),兩片芯片可以緊密貼合地混合鍵合(即銅對(duì)銅的直接連接)。
2024-02-23 10:14:50 899
899 用于先進(jìn)封裝領(lǐng)域的 Cu-Cu 低溫鍵合技術(shù)進(jìn)行了綜述,首先從工藝流程、連接機(jī)理、性能表征等方面較系統(tǒng)地總結(jié)了熱壓工藝、混合鍵合工藝實(shí)現(xiàn) Cu-Cu 低溫鍵合的研究進(jìn)展與存在問題,進(jìn)一步地闡述了新型納米材料燒結(jié)工藝在實(shí)現(xiàn)低溫連接、降低工藝要求方面的優(yōu)
2024-03-25 08:39:56 1391
1391 
Bonding)技術(shù)應(yīng)運(yùn)而生,并迅速成為3D芯片封裝領(lǐng)域的核心驅(qū)動(dòng)力。本文將深入探討混合鍵合技術(shù)在3D芯片封裝中的關(guān)鍵作用,分析其技術(shù)原理、應(yīng)用優(yōu)勢(shì)以及未來(lái)發(fā)展
2024-08-26 10:41:54 1595
1595 
摘要:碳化硅(SiC)功率模塊在電動(dòng)汽車驅(qū)動(dòng)系統(tǒng)中起著至關(guān)重要的作用。為了提高功率模塊的性能、減小體積、提高生產(chǎn)效率,本文提出了一種基于多堆疊直接鍵合銅(DBC)單元的功率模塊封裝方法,以并行更多
2024-10-16 13:32:53 1419
1419 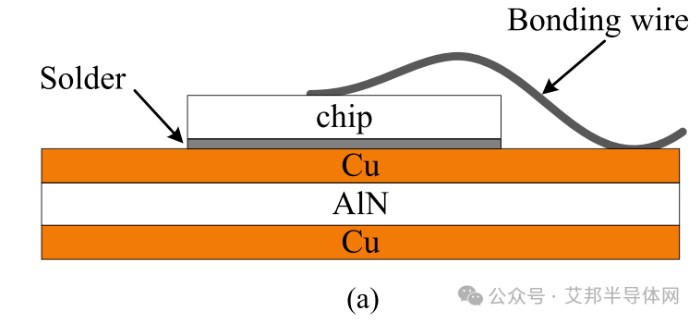
隨著摩爾定律逐漸進(jìn)入其發(fā)展軌跡的后半段,芯片產(chǎn)業(yè)越來(lái)越依賴先進(jìn)的封裝技術(shù)來(lái)推動(dòng)性能的飛躍。在封裝技術(shù)由平面走向更高維度的2.5D和3D時(shí),互聯(lián)技術(shù)成為關(guān)鍵中的關(guān)鍵。面對(duì)3D封裝日益增長(zhǎng)的復(fù)雜性和性能
2024-10-18 17:54:54 1005
1005 
混合鍵合(Hybrid Bonding)是半導(dǎo)體封裝領(lǐng)域的新興技術(shù),能夠?qū)崿F(xiàn)高密度三維集成,無(wú)需傳統(tǒng)的焊料凸點(diǎn)。本文探討混合鍵合的基本原理、相比傳統(tǒng)方法的優(yōu)勢(shì),以及該領(lǐng)域的最新發(fā)展。
2024-10-30 09:54:51 2511
2511 
半導(dǎo)體封裝已從傳統(tǒng)的 1D PCB 設(shè)計(jì)發(fā)展到晶圓級(jí)的尖端 3D 混合鍵合。這一進(jìn)步允許互連間距在個(gè)位數(shù)微米范圍內(nèi),帶寬高達(dá) 1000 GB/s,同時(shí)保持高能效。先進(jìn)半導(dǎo)體封裝技術(shù)的核心是 2.5D
2024-11-05 11:22:04 715
715 
隨著摩爾定律的放緩與面臨微縮物理極限,半導(dǎo)體巨擘越來(lái)越依賴先進(jìn)封裝技術(shù)推動(dòng)性能的提升。隨著封裝技術(shù)從2D向2.5D、3D推進(jìn),芯片堆迭的連接技術(shù)也成為各家公司差異化與競(jìng)爭(zhēng)力的展現(xiàn)。而“混合鍵合
2024-11-08 11:00:54 1252
1252 隨著半導(dǎo)體產(chǎn)業(yè)的快速發(fā)展,集成電路(IC)的小型化、高密度集成、多功能高性能集成以及低成本集成成為行業(yè)發(fā)展的必然趨勢(shì)。在這一背景下,3D集成晶圓鍵合技術(shù)應(yīng)運(yùn)而生,成為實(shí)現(xiàn)這些目標(biāo)的關(guān)鍵技術(shù)之一。本文
2024-11-12 17:36:13 1578
1578 
隨著半導(dǎo)體技術(shù)的飛速發(fā)展,芯片的性能需求不斷提升,傳統(tǒng)的二維封裝技術(shù)已難以滿足日益增長(zhǎng)的數(shù)據(jù)處理速度和功耗控制要求。在此背景下,混合鍵合(Hybrid Bonding)技術(shù)應(yīng)運(yùn)而生,并迅速成為三維
2024-11-13 13:01:32 2161
2161 
談一談先進(jìn)封裝中的互連工藝,包括凸塊、RDL、TSV、混合鍵合,有哪些新進(jìn)展?可以說(shuō),互連工藝是先進(jìn)封裝的關(guān)鍵技術(shù)之一。在市場(chǎng)需求的推動(dòng)下,傳統(tǒng)封裝不斷創(chuàng)新、演變,出現(xiàn)了各種新型的封裝結(jié)構(gòu)。 下游
2024-11-21 10:14:40 3120
3120 
摘要: 隨著半導(dǎo)體技術(shù)的發(fā)展,傳統(tǒng)倒裝焊( FC) 鍵合已難以滿足高密度、高可靠性的三維( 3D) 互連技術(shù)的需求。混合鍵合( HB) 技術(shù)是一種先進(jìn)的3D 堆疊封裝技術(shù),可以實(shí)現(xiàn)焊盤直徑≤1 μm
2024-11-22 11:14:46 2817
2817 
引言 Cu-Cu混合鍵合(Cu-Cu Hybrid Bonding) 技術(shù)正在成為先進(jìn)3D集成的重要技術(shù),可實(shí)現(xiàn)細(xì)間距互連和高密度芯片堆疊。本文概述了Cu-Cu混合鍵合的原理、工藝、主要挑戰(zhàn)和主要
2024-11-24 12:47:06 1865
1865 
、高溫服役、優(yōu)異的導(dǎo)熱和導(dǎo)電性能,以及相對(duì)較低的成本,在功率器件封裝研究領(lǐng)域備受關(guān)注。本文將綜述納米銅燒結(jié)連接技術(shù)的研究進(jìn)展,從納米銅焊膏的制備、影響燒結(jié)連接接頭
2024-12-07 09:58:55 1575
1575 
技術(shù)前沿:半導(dǎo)體先進(jìn)封裝從2D到3D的關(guān)鍵 半導(dǎo)體分類 集成電路封測(cè)技術(shù)水平及特點(diǎn)?? ? 1. 發(fā)展概述 ·自20世紀(jì)90年代以來(lái),集成電路封裝技術(shù)快速發(fā)展,推動(dòng)了電子產(chǎn)品向小型化和多功能方向邁進(jìn)
2025-01-07 09:08:19 1582
1582 
混合鍵合技術(shù)(下) 先進(jìn)封裝技術(shù)(Semiconductor Advanced Packaging) - 3 Chiplet 異構(gòu)集成(上) 先進(jìn)封裝技術(shù)(Semiconductor
2025-01-08 11:17:01 1427
1427 
整合更多功能和提高性能是推動(dòng)先進(jìn)封裝技術(shù)的驅(qū)動(dòng),如2.5D和3D封裝。 2.5D/3D封裝允許IC垂直集成。傳統(tǒng)的flip-chip要求每個(gè)IC單獨(dú)封裝,并通過傳統(tǒng)PCB技術(shù)與其他IC集成
2025-01-14 10:41:33 1450
1450 
混合鍵合3D芯片技術(shù)將拯救摩爾定律。 為了繼續(xù)縮小電路尺寸,芯片制造商正在爭(zhēng)奪每一納米的空間。但在未來(lái)5年里,一項(xiàng)涉及幾百乃至幾千納米的更大尺度的技術(shù)可能同樣重要。 這項(xiàng)技術(shù)被稱為“混合鍵合”,可以
2025-02-09 09:21:43 568
568 
在半導(dǎo)體功率模塊封裝領(lǐng)域,互連技術(shù)一直是影響模塊性能、可靠性和成本的關(guān)鍵因素。近年來(lái),隨著納米技術(shù)的快速發(fā)展,納米銀燒結(jié)和納米銅燒結(jié)技術(shù)作為兩種新興的互連技術(shù),備受業(yè)界關(guān)注。然而,在眾多應(yīng)用場(chǎng)景中
2025-02-24 11:17:06 882
882 
3D封裝與系統(tǒng)級(jí)封裝概述 一、引言:先進(jìn)封裝技術(shù)的演進(jìn)背景 隨著摩爾定律逐漸逼近物理極限,半導(dǎo)體行業(yè)開始從單純依賴制程微縮轉(zhuǎn)向封裝技術(shù)創(chuàng)新。3D封裝和系統(tǒng)級(jí)封裝(SiP)作為突破傳統(tǒng)2D平面集成限制
2025-03-22 09:42:56 830
830 
 電子發(fā)燒友App
電子發(fā)燒友App



















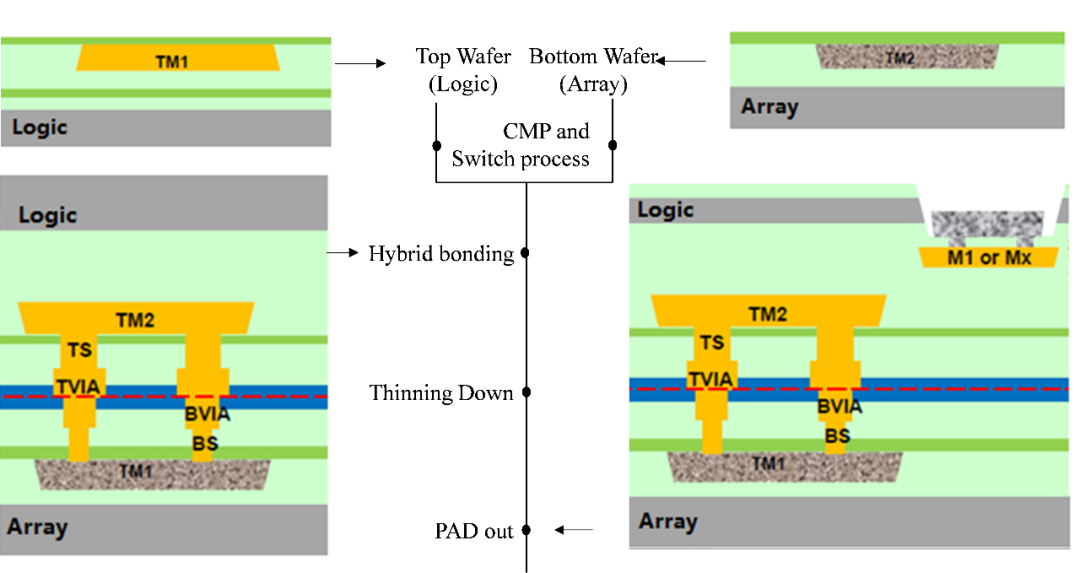











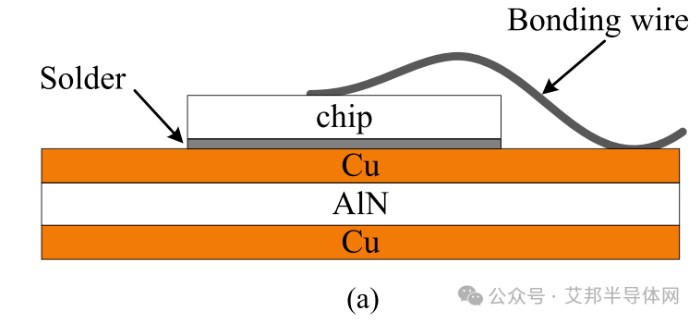

























評(píng)論